ųeż“ĖĮż’żĘż─ż─żóżļä▌╣±ż╬DXĪ¦ŗī3ŗAPCż╚Industry 4.0 (5) TELż╬VM
APCź½ź¾źšźĪźņź¾ź╣żŪØi└ŅĢ■ż╬░§ō■ż╦╗─ż├ż┐TEL Americaż╬Ben RathsackĖF╗╬ż╬╣ų▒ķż“Šę▓ż╣żļĪŻ╚ŠŲ│öü×æļ]ż╦ż¬ż▒żļVMĪ╩źąĪ╝ź┴źŃźļźßź╚źĒźĒźĖĪ╝Ī╦ż╚żĮż╬ĖÕż╬AIż“╗╚ż├ż┐═Įē¶╩▌µ£ż╩ż╔ż╬║Ū┐ĘČ\ĮčżŪź”ź¦Ī╝źŽ╩Ōé╬ż▐żĻż“æųż▓Īó╚∙║┘▓Įż¼┐╩ż¾żŪżŌźąźķź─źŁż“žōżķż╗żļż│ż╚ż“╝┬Š┌żĘżŲżŁż┐ż╚żżż”ĪŻ(ź╗ź▀ź│ź¾ź▌Ī╝ź┐źļįćĮĖ╝╝)
├°ŪvĪ¦AEC/APC Symposium JapanĪĪØi└Ņ╣╠╗╩
ØiövżŽĪóDXČ\Įčż╦żĶżļ┘J┘Tż╬╚ŠŲ│öüÖ┌ŠÅźķźżź¾ż╬ź╣ź▐Ī╝ź╚▓Įż¼┐╩╣įżĘżŲżżżļ══ż“ĪóOTŖõż╬ź▐ź═Ī╝źĖźßź¾ź╚ż╬£å┼└żŪĖ½żŲżŁż┐ĪŻż│ż╬╩č▓ĮżŽĪó¼śż½ż╦┐╩╣įżĘżŲżżżļĪŻ▓“└ŽŪvż╬╗┼Ą£ż╬żõżĻöĄżŌĪó¼śż½ż╦ĪóżĘż½żĘż╩ż¼żķ═Į┤³żĘż┐żĶżĻ┴ßż»╩č▓ĮżĘżŲżżżļĪŻ║ŻövżŽĪóTEL╝ęż╚żżż”äóÅøźėźĖź═ź╣ż“źĻĪ╝ź╔ż╣żļĪóäóÅøźßĪ╝ź½Ī╝ż½żķż╬£å┼└ż“Šę▓żĘż┐żżż╚╗ūż”ĪŻDXČ\Įčż“Ņ~╗╚żĘż┐äóÅøėX▌åż╬▓“└ŽĪó┤Ų£åźĄĪ╝źėź╣ż“żŌźėźĖź═ź╣ż╚żĘżŲ£å╠Ņż╦Ų■żņżŲżżżļĪŻäóÅøŠÅČ╚ż╚żĘżŲż╬Īó┐ʿʿżźėźĖź═ź╣źŌźŪźļż╬┴ŽĮążŪżóżļĪŻ
3-4. TEL äóÅøźßĪ╝ź½Ī╝ż╚żĘżŲż╬£å└■ĪĮ DXż“╗╚ż├ż┐ź╣ź▐Ī╝ź╚źšźĪźų▓Įż╚ź»źķź”ź╔źĄĪ╝źėź╣
TEL America (Tokyo Electron America) ż╬Vice President żŪżóżļBen RathsackĖF╗╬żŽĪóØi╣®µćäóÅøż“├µ┐┤ż╦ĪóĪ╚Smart tool : Intelligent Control in Semiconductor ManufacturingĪ╔ ż╚¼öżĘżŲäóÅøźßĪ╝ź½Ī╝ż╬ćĶ┼└żŪż╬╚ŠŲ│öüż╬ź╣ź▐Ī╝ź╚źšźĪźų▓Įż“Įęż┘ż┐ĪŻ
SEMATECHż╬╝ń╬«żŽĪó╚ŠŲ│öüäóÅøźßĪ╝ź½Ī╝żŪżóż├ż┐ż╚żżż”Ė½▓“ż“żĘżążĘżą╩╣żżż┐ż│ż╚ż¼żóż├ż┐ĪŻäóÅøźßĪ╝ź½Ī╝ż╚żĘżŲĪóĖĮ║▀ż½żķŖZżżĮø═Ķż“ż╔ż╬żĶż”ż╦ż▀żŲżżżļż½ĪóČĮ╠Żż¼żóż├ż┐ĪŻ
3-1żŪżŌĮęż┘ż┐żĶż”ż╦Īó2015ŃQ░╩æTżŽĪóVMĪ╩Virtual MetrologyĪ╦╝┬├ō▓Įż╬żóżµż▀ż¼▓├Å]żĘżŲżŁż┐ĪŻ║ŻŲ³ĪóźŪźŻĪ╝źūźķĪ╝ź╦ź¾ź░żõĄĪ│Ż│žØ{ż╚Ė└ż’żņżļ╣Ō┼┘ż╩AIĪ󿬿Ķżė╣Ō┼┘ż╩źóźļź┤źĻź║źÓż“╗╚ż├ż┐═Į▒RźŌźŪźļż¼Ī󟔟¦Ī╝źŽż╬źąĪ╝ź┴źŃźļ┼¬ż╩µ£┐¶ĖĪØhż“▓─ē”ż╦żĘżŲżżżļĪŻŖZŃQż╬┐Ę▒į╚ŠŲ│öüØi╣®µćźšźĪźųżŽĪóż│ż╬żĶż”ż╩═ū┴ŪČ\Įčż“┴╚ż▀╣■ż¾ż└ź═ź├ź╚ź’Ī╝ź»źĘź╣źŲźÓż“╣Į├█żĘżŲżżżļĪŻ×æļ]äóÅøżŽĪóż│ż╬╣Į├█żĄżņż┐ź═ź├ź╚ź’Ī╝ź»ż╦└▄¶öż╣żļż┐żßż╬║YØŹ▓ĮżĄżņż┐źżź¾ź┐Ī╝źšź¦źżź╣ż“Ęeż├żŲżżżļĪŻ
żĮżņżŪżŽż╩ż╝Īóż│ż╬żĶż”ż╩╣Ō┼┘żŪ╣Ō▓┴ż╩╗┼┴╚ż▀ż¼ĖĮżņżŲżŁż┐ż╬ż└żĒż”ż½Ī®▓┐ż¼źŌź┴ź┘Ī╝źĘźńź¾żŪżóż├ż┐ż╬ż└żĒż”ż½Ī®
╚∙║┘▓ĮżŽĪó╚ŠŲ│öüźŪźąźżź╣ż╬└Łē”ż╬ų`│ąż▐żĘżżĖ■æųż╚ż╚żŌż╦Īóź▐ź╣ź»┐¶ż╬╗\▓├ż“żŌż┐żķżĘż┐ĪŻżĮżņż╦żĶżļźūźĒź╗ź╣ź╣źŲź├źūż╬╗\▓├żŽĪ󟔟¦Ī╝źŽź│ź╣ź╚ż╬æųĖéż“żŌż┐żķżĘżŲżżżļĪŻSoCż╬└ż─cżŪżŽ45nm╗■┬Õż╦╚µż┘Īó║ŻŲ³ż╬└Ķ├╝Č\Įčż╬ź”ź¦Ī╝źŽż╬×æļ]ź│ź╣ź╚żŽĪó5Ū▄░╩æųż╦ż╩ż├żŲżżżļĪŻ3D▓ĮżĘż┐źßźŌźĻżŌŲ▒żĖ▒┐╠┐ż╦żóżļĪŻ┐▐3-16żŽĪóż│ż╬┤ųż╬╩č▓Įż“į~Ęķż╦رĖņżļĪŻż│ż”żĘżŲĪó×æļ]╣®µćżŪ╝║ż’żņżļź”ź¦Ī╝źŽż“Š»żĘżŪżŌŠ»ż╩ż»ż╣żļźŌź┴ź┘Ī╝źĘźńź¾żŽ│╩├╩ż╦╣Ōż▐ż├ż┐ĪŻ
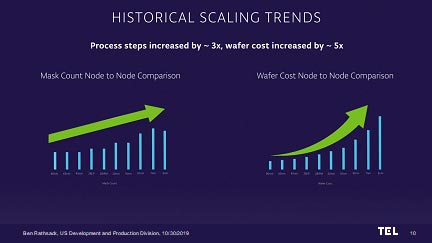
┐▐3-16ĪĪ╗\ż©¶öż▒żļź”ź¦Ī╝źŽź│ź╣ź╚ĪĪĮąųZĪ¦Intelligent Control in Semiconductor ManufacturingĪóDr. Ben Rathsack, TEL
ģsżŁŲDżĻĖĪØhż╬ĖÕĪó╝╬żŲżķżņżļź”ź¦Ī╝źŽż╬ź│ź╣ź╚żŌźąź½ż╦ż╩żķż╩żżż╬ż└ĪŻźßź╚źĒźĒźĖĪ╝ĖĪØhż“źąĪ╝ź┴źŃźļ┼¬ż╦╣įżżĪó╝╬żŲżļź”ź¦Ī╝źŽ╬╠ż“Š»ż╩ż»żĘż┐żżż╚żżż”Ų░ĄĪżŽĪóŠåÅ]ż╦╣Ōż▐ż├żŲżŁżŲżżżļĪŻżĄżķż╦ĪóPM (Preventive Maintenance, ═Įē¶╩▌µ£)ż“║Ū┼¼▓ĮżĘżŲĪóāįŠĻż╩╩Ōé╬ż▐żĻźĒź╣ż“╦╔ż«ż─ż─ĪóäóÅø╔nŲ»ż“╔nż░ż╚żżż”Ų░ĄĪżŌ╣Ōż»ż╩ż├ż┐ĪŻ2010ŃQ░╩æTĪóIMA-APCżõĪóAEC/APC JapanżŪżŽĪóFDCĪ╩Ė╬ŠŃĖĪĮąż╚╩¼╬ÓĪ╦ĪóYMSĪ╩╩Ōé╬ż▐żĻ┤╔═²źĘź╣źŲźÓĪ╦ż╬═ū┴ŪČ\Įčż╦┤žż╣żļ╚»╔Įż¼╗\▓├żĘżŲżżżļĪŻżĮż╬ĖÕż╦ĖĮżņżŲż»żļż╬ż¼ĪóFDCĪóYMSż½żķż╬═Į▒RźŌźŪźļż╬║Ņ└«ż└ĪŻFDCźŪĪ╝ź┐ż½żķ×æēä╩Ōé╬ż▐żĻĪó×æēä└Łē”ż“═Į▒Rż╣żļż╚żżż”Īóżżż’żµżļVM (Virtual Metrology, źąĪ╝ź┴źŃźļźßź╚źĒźĒźĖĪ╝)żŪżóżļĪŻ┐▐3-17ż╦żóżļżĶż”ż╦Īó“£═Ķż╬źßź╚źĒźĒźĖĪ╝ĖĪØhżŽĪóźĒź├ź╚╦Ķż╬ź”ź¦Ī╝źŽģsżŁż╚żĻĖĪØhżŪżóż├ż┐ĪŻVMż╬└ż─cżŪżŽĪóźąĪ╝ź┴źŃźļżŪż╬µ£ź”ź¦Ī╝źŽż╬ĖĪØhż╦ż╩żļĪŻVMż╬║ŪĮķż╬Ų░ĄĪżŽĪó╝╬żŲżļź”ź¦Ī╝źŽż“žōżķż╣ż┐żßż╬Ī╚┤ų░·żŁĖĪØhĪ╔ż╚żŪżżż”żŌż╬żŪżóż├ż┐ż╚╔«ŪvżŽŪ¦╝▒żĘżŲżżżļĪŻ
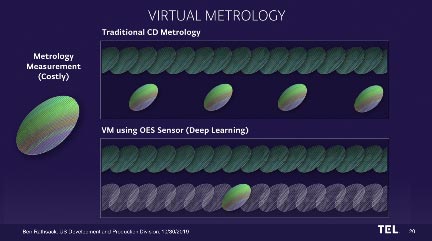
┐▐3-17ĪĪVMż╦żĶżļµ£┐¶ĖĪØhĪĪĮąųZĪ¦Intelligent Control in Semiconductor ManufacturingĪóDr. Ben Rathsack, TEL
╗@Õ╠ż╩═Į▒RźŌźŪźļżŪż╬VMż╦żĶżļĪ󟔟¦Ī╝źŽż╬źąĪ╝ź┴źŃźļ┼¬ż╩µ£┐¶ĖĪØhż¼▓─ē”ż╚ż╩żļż╚ĪóĪĪPM (Preventive Maintenance)ż╬║Ū┼¼▓ĮżŌ▓─ē”żŪżóżļĪŻ┐▐3-18żŽż│ż╬╠Ž══ż“╔ĮżĘżŲż¬żĻĪóĪĪVMż╦żĶżļPMż╬║Ū┼¼▓ĮżŽĪó╚ŠŲ│öüØi╣®µćżŪżŽĪó╝┬├ōż╬ōļ░Ķż╦Ų■ż├żŲżŁżŲżżżļĪŻ
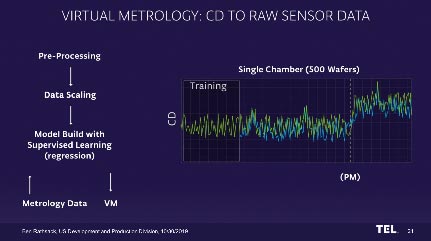
┐▐3-18ĪĪVMż╬źŪĪ╝ź┐ż╚╝┬▒RźŪĪ╝ź┐ĪĪĮąųZĪ¦Intelligent Control in Semiconductor ManufacturingĪóDr. Ben Rathsack, TEL
2015ŃQ║óż╦żŽĪóFDCĪóYMSĪóVMĪóźėź├ź░źŪĪ╝ź┐╝²ĮĖźĘź╣źŲźÓż╚żżż”ĪóĖ─Ī╣ż╬═ū┴ŪČ\Įčż¼ż█ż▄Įą═Ķæųż¼ż├żŲżŁżŲżżżļĪŻż│żņ░╩æTż╬┐Ę▒į╚ŠŲ│öü╣®Šņż╦żŽĪóż│ż╬żĶż”ż╩╗┼┴╚ż▀ż¼Įķżßż½żķŪ╝Ų■żĄżņżŲż¬żĻĪó╩Ōé╬ż▐żĻĪó×æēäźąźķź─źŁź│ź¾ź╚źĒĪ╝źļż╬══╗ęż¼░╩Øiż╚░█ż╩ż├żŲżŁżŲżżżļĪŻ×æēäż╬╩Ōé╬ż▐żĻżążķż─żŁżõĪó└Łē”żążķż─żŁżŽĪóźŲź»ź╬źĒźĖź╬Ī╝ź╔ż¼ĮjżŁżżż█ż╔Ī╩└╬ż╬źŲź»ź╬źĒźĖź╬Ī╝ź╔ż█ż╔Īó╚∙║┘▓Įż¼┐╩ż¾żŪżżż╩żżż█ż╔Ī╦Š«żĄż»ż╩żļż╬ż¼═²Č■żŪżóżļĪŻż╚ż│żĒż¼║ŻŲ³Īó28nm░╩æTż╬└Ķ├╝Č\ĮčźšźĪźųżŪÖ┌żĖżļ×æēäżążķż─żŁżŽĪó65nmżõĪó90nmż╚żżż”źŲź»ź╬źĒźĖź╬Ī╝ź╔ż╬źšźĪźųżŪż╬×æēäżążķż─żŁżĶżĻŠ«żĄżżĪŻĖĮ╝┬żŽĪó═²Č■ż╚żŽ╚┐×┤ż╦ż╩ż├żŲżżżļż╬ż└ĪŻż│ż╬┤ųż╬ĪóäóÅøż¬żĶżėźūźĒź╗ź╣ź│ź¾ź╚źĒĪ╝źļČ\Įčż╬└ż─cż╦ÅŚż│ż├ż┐ĪóĖ▓├°ż╩Č\Įč│ū┐Ęż“ż▀żļĪŻ
║ŪĖÕż╦ĪóBen RathsackĖF╗╬żŽĪóäóÅøźßĪ╝ź½Ī╝ż½żķż╬£å┼└ż╚żĘżŲĪó┐Ęż┐ż╩żļźĄĪ╝źėź╣źėźĖź═ź╣ż╦Ė└Ą┌żĘżŲżżżļĪ╩┐▐3-19Ī╦ĪŻ ż╣ż╩ż’ż┴ĪóĖ▄ĄężŪżóżļźšźĪźųż╬ź═ź├ź╚ź’Ī╝ź»źĘź╣źŲźÓżžż╬źĻźŌĪ╝ź╚źóź»ź╗ź╣ż“╗╚ż├ż┐ź»źķź”ź╔ź│ź¾źįźÕĪ╝źŲźŻź¾ź░ż╦żĶżļĪóźŪĪ╝ź┐▓“└ŽĪóäóÅø┤Ų£åźĄĪ╝źėź╣żŪżóżļĪŻäóÅøźßĪ╝ź½Ī╝ż╚żĘżŲĪó┐Ęż┐ż╩żļźėźĖź═ź╣źŌźŪźļżŪżóżļĪŻ

┐▐3-19ĪĪźĻźŌĪ╝ź╚źóź»ź╗ź╣ż╬╣═ż©öĄĪĪĮąųZĪ¦Intelligent Control in Semiconductor ManufacturingĪóDr. Ben Rathsack, TEL
║ŻövżŽĪóäóÅøźßĪ╝ź½Ī╝ż½żķż╬£å┼└ż“Šę▓żĘż┐ĪŻDXČ\Įčż“Ņ~╗╚żĘż┐äóÅøėX▌åż╬▓“└ŽĪó┤Ų£åźĄĪ╝źėź╣ż“żŌźėźĖź═ź╣ż╚żĘżŲ£å╠Ņż╦Ų■żņżļĪóäóÅøŠÅČ╚ż╚żĘżŲż╬Īó┐ʿʿżźėźĖź═ź╣źŌźŪźļż╬┴ŽĮążŪżóżļĪŻ
╝ĪövżŽĪó╚ŠŲ│öüźūźĒź╗ź╣ź│ź¾ź╚źĒĪ╝źļż╦┤žż╣żļĄ─ébż“┐╝żßżŲżŁż┐ź¬źįź╦ź¬ź¾źĻĪ╝ź└Ī╝ż┐ż┴ż╬Ė½▓“ż“Šę▓żĘż┐żżĪŻDXČ\Įčż“╗╚ż├ż┐ź╣ź▐Ī╝ź╚źšźĪźų▓Įż╬║ŻĖÕż╬┐╩·tż“ż╔ż╬żĶż”ż╦┬¬ż©żŲżżżļż╬ż½Īó▓┐ż¼ØŁ═ūż╚żĄżņżŲż»żļż╬ż└żĒż”ż½Ī®


