EIDECĪóź░źĒĪ╝źąźļČ©╬üżŪ10nm±śż╬▓├╣®ż╦EUVŲ│Ų■ų`╗žż╣Ī╩2Ī╦Ī┴ź▐ź╣ź»ĖĪØh
EUVżŽØ±ä®ż“Ų®āįżĘżõż╣żżX└■ż╬▐k¹|żŪżóżļż┐żßĪóĖ„│žÅUż╦żŽźņź¾ź║żŪżŽż╩ż»╚┐╝ołż“ŠW├ōż╣żļĪŻ╚┐╝oĖ„│žÅUż╬ź▐ź╣ź»źųźķź¾ź»ź╣żŽĪóW/Moż╬Ę½żĻ╩ųżĘ└č┴ž╣Įļ]ż“║╬ż├żŲżżżļĪŻż│ż│ż╦’L┤┘ż¼Ų■żļż╚źčź┐Ī╝ź¾ż¼Ž─ż¾żŪżĘż▐ż”ż┐żßĪó╠Ą’L┤┘ż╦żĘż┐żżĪŻź▐ź╣ź»ĖĪØhżŽ╔į▓─’LżŪżóżļĪŻ
ź▐ź╣ź»źųźķź¾ź»ź╣ż╦EUVĖ„ż“┼÷żŲżŲ’L┤┘ż“Ė½żļABIĪ╩Actinic Blanks defect InspectionĪ╦ĖĪØhäóÅøż“EIDECźūźĒźĖź¦ź»ź╚ż¼╗Žż▐żļØiż╬MIRAIźūźĒźĖź¦ź»ź╚żŪ╗Ņ║ŅżĘĪó’L┤┘ż╬╝Ŗ▒RČ\Įčż“SeleteźūźĒźĖź¦ź»ź╚żŪ│╬╬®żĘż┐ĪŻEIDECżŪżŽ╬╠ŠÅ╗Ņ║ŅĄĪż╬×æļ]ż╦┼ž╬üżĘżŲżŁż┐ĪŻ
EIDECżŪżŽĪóź▐ź╣ź»’L┤┘ĖĪØhäóÅøż╬źņĪ╝źČĪ╝źŲź├ź»╝ęż╚Č”Ų▒żŪĪóABIż╬╬╠ŠÅ╗Ņ║ŅĄĪż“║ŅżĻæųż▓ż┐(┐▐4)ĪŻż│ż╬╬╠ŠÅ╗Ņ║ŅäóÅøżŪżŽĪó╣ŌżĄ1.6nmĪó╔²250nmż╬’L┤┘ż½żķĪó╣ŌżĄ1.0nmĪó╔²33nmż╬’L┤┘ż▐żŪ’L┤┘ż“100%ĖĪĮążŪżŁżŲżżżļĪŻ╣ŌżĄ1.0nmĪó╔²33nmżŽźŽĪ╝źšźįź├ź┴(hp)16nmź╬Ī╝ź╔ż╦┴Ļ┼÷ż╣żļż╚żżż”ĪŻEUVŽ¬Ė„źĘź╣źŲźÓżŪżŽ4Ū▄ż╬Į╠Š«┼Ļ▒Ųż“Ū░Ų¼ż╦Ų■żņżŲżżżļż┐żßżŪżóżļĪŻ
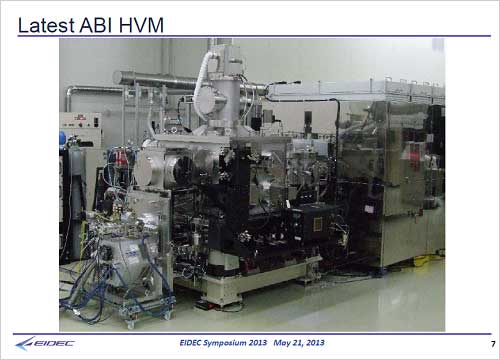
┐▐4ĪĪABI╬╠ŠÅ╗Ņ║ŅäóÅøĪĪĮąųZĪ¦EIDEC
ż▐ż┐Īóź▐ź╣ź»źųźķź¾ź»ź╣ż╦’L┤┘ż¼Ė½ż─ż½ż├ż┐Šņ╣ńżŪżŌĪóżĮż╬æųż╦ķWż»źčź┐Ī╝ź¾ż╦żĶż├żŲżŽ’L┤┘ż╬▒Ųūxż“Ž┬żķż▓żļż┐żßż╬Č\Įčż╦ż─żżżŲżŌĮęż┘żŲżżżļĪ╩┐▐5Ī╦ĪŻż│żņżŽĪóX└■ż╬Ą█╝²öüźčź┐Ī╝ź¾ż╬æųż╦’L┤┘ż“Ęeż├żŲż»żļżĶż”ż╦Īóźčź┐Ī╝ź¾ż╬░╠Åøż“ż║żķż╣Č\Įčż└ĪŻż┐ż└żĘĪóżĮż╬░╠Åøż“┘ć│╬ż╦▒R─ĻżŪżŁżļČ\ĮčżŌØŁ═ūż╚ż╩żļĪŻ

┐▐5ĪĪź▐ź╣ź»źųźķź¾ź»ź╣ż╬’L┤┘ż╬▒Ųūxż“Ę┌žōż╣żļĪĪĮąųZĪ¦EIDEC
źčź┐Ī╝ź¾ż╬¤²żżż┐ź▐ź╣ź»żŪżŽĪóżĮż╬│░ćĶĖĪØhäóÅøż“┐ćĖČ×æ║ŅĮĻż╚Č”Ų▒żŪ│½╚»żĘż┐ĪŻż│żņżŽźūźĒźĖź¦ź»źĘźńź¾Ę┐ż╬┼┼╗ęźėĪ╝źÓż“ŠW├ōżĘż┐ĖĪØhäóÅøPEMĪ╩Projection Electron MicroscopeĪ╦żŪżóżļĪŻŠ╚£½├ōż╬┼┼╗ęźėĪ╝źÓż“źčź┐Ī╝ź¾¤²żŁż╬ź▐ź╣ź»ż╦Š╚╝ożĘĪó2╝Ī┼┼╗ęż“TDIĪ╩time delay integrationĪ╦ź╗ź¾źĄż╬CCDź½źßźķżŪĖĪĮąż╣żļĪŻźūźĒźĖź¦ź»źĘźńź¾źņź¾ź║ż“╣Į└«żĘĪó┼┼╗ęĖ▓╚∙¬Üż╚żĘżŲ楿“Ė½żŲżżżļż│ż╚ż╦ż╩żļĪŻ
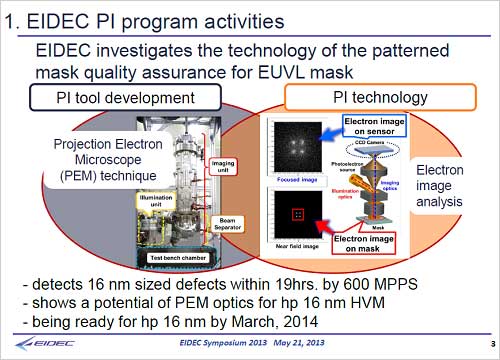
┐▐6ĪĪPIĪ╩Patterned mask InspectionĪ╦äóÅøż╬▄ć═ūĪĪĮąųZĪ¦EIDEC
EUVź▐ź╣ź»ż“┼┼╗ęĖ▓╚∙¬ÜżŪĖĪØhżŪżŁżļźßźĻź├ź╚ż╬▐kż─ż╦Īóź┴źŃĪ╝źĖźóź├źūż¼ż╩żżż│ż╚ż¼żóżļĪŻArFż╩ż╔Ė„źĻźĮż╬Šņ╣ńż╦╗╚ż├żŲżŁż┐ź¼źķź╣ź▐ź╣ź»ż╩ż╔żŽ└õ▒’öüżŪżóżļż┐żßĪóź┴źŃĪ╝źĖźóź├źūż╣żļż│ż╚żŪ楿¼ż▄ż▒żļż¼ĪóEUVź▐ź╣ź»żŽW/Moż╬┴ž╣Įļ]ż╩ż╬żŪź┴źŃĪ╝źĖźóź├źūż╗ż║Īó┼┼╬«ż╬öUĖ┬żŽż╩żżĪŻ
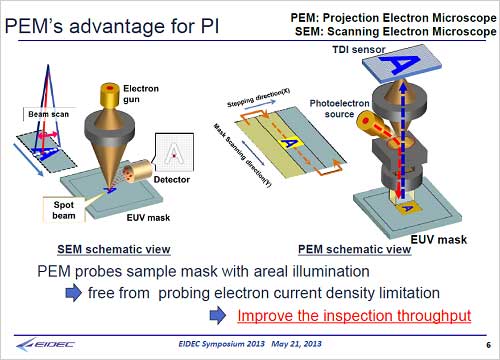
┐▐7ĪĪ┼┼╗ęźėĪ╝źÓżŪź╣źŁźŃź¾ż╣żļĪĪĮąųZĪ¦EIDEC
ż│ż╬PEMĖĪØhäóÅøżŪżŽĪ╩┐▐7Ī╦Īóź╣źŲź├źūźóź¾ź╔źĻźįĪ╝ź╚öĄ╝░żŪźčź┐Ī╝ź¾ż“ź╣źŁźŃź¾żĘżŲżżż»ż┐żßĪóź╣źļĪ╝źūź├ź╚ż¼╣Ōż»Īó16nmźĄźżź║ż╬’L┤┘ż“19╗■┤ų░╩ŲŌż╦├Ąż╣ż╚żżż”ų`║Yż“└▀─ĻżĘżŲżżżļĪŻ║Żż╬ż╚ż│żĒĪóhp64nmż¬żĶżė44nmż╬L/Sźčź┐Ī╝ź¾ćĄż“┬¬ż©żļż│ż╚ż╦└«Ė∙żĘżŲżżżļĪŻ║ŻĖÕżŽĪóhp16nmż╬’L┤┘ćĶ▒Rż╦─®└’ż╣żļż¼ĪóĖ½ż─ż▒żķżņżļ▓─ē”└Łż¼ĮążŲżŁż┐ż╚żĘżŲżżżļĪŻ
(¶öż»)
╗▓╣═½@╬┴
1. EUV╗■┬Õż¼Ė½ż©żŲżŁż┐ż½ĪóIntelż¼ASMLż╚╩Ō─┤ż“╣ńż’ż╗10nmż╦Š╚ØŹ (2013/05/22)
2. EIDECĪóź░źĒĪ╝źąźļČ©╬üżŪ10nm±śż╬▓├╣®ż╦EUVŲ│Ų■ų`╗žż╣Ī╩1Ī╦Ī┴▄ć═ū (2013/05/31)
3. EIDECĪóź░źĒĪ╝źąźļČ©╬üżŪ10nm±śż╬▓├╣®ż╦EUVŲ│Ų■ų`╗žż╣Ī╩3Ī╦Ī┴źņźĖź╣ź╚ (2013/05/31)


