LEAPĪóFPGA├ōź╣źżź├ź┴ĪóSTT-MRAMĪóTRAMż“VLSI SympożŪ╚»╔Į
ä▌╣±╗■┤ų6ĘŅ10Ų³ż½żķźŽź’źżżŪ│½ż½żņżļ2014 Symposia on VLSI Technology and CircuitsżŪLEAPĪ╩«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ńĪ╦ż¼3¹|╬Óż╬źßźŌźĻż“╚»╔Įż╣żļĪŻFPGAż╬ź╣źżź├ź┴ż╚żĘżŲ╗╚ż”ĪųĖČ╗ęöĪŲ░Ę┐ź╣źżź├ź┴źŪźąźżź╣Īūż╚STT-MRAMż╬▐k¹|Īų╝¦└Ł╩č▓ĮźŪźąźżź╣ĪūĪóPCRAMż╬▐k¹|Īų┴Ļ╩č▓ĮźŪźąźżź╣ĪūżŪżóżļĪŻ
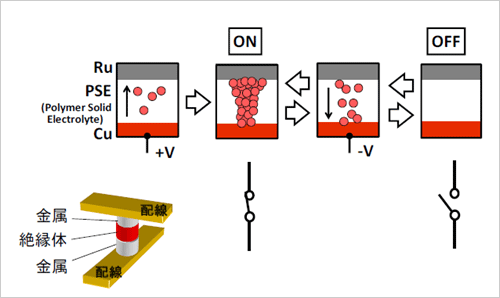
┐▐1ĪĪĖČ╗ęöĪŲ░Ę┐ź╣źżź├ź┴ż╬╠Ž╝░┐▐ĪĪĮąųZĪ¦LEAP
Į±╣■ż▀╗■┤ų10nsż╬ĖČ╗ęöĪŲ░ź╣źżź├ź┴
ĖČ╗ęöĪŲ░Ę┐ź╣źżź├ź┴żŪżŽ10nsż╬╣ŌÅ]Ų░║Ņż“1Mźėź├ź╚ż╬źßźŌźĻźóźņźżż“├ōżżżŲ│╬Ū¦żĘż┐ĪŻż│ż╬ź╣źżź├ź┴żŽĪó╔wöü┼┼▓“䮿“Cuż╚Ruż╬┼┼Č╦żŪČ┤ż¾ż└╣Įļ]ż“Ęeż┴ĪóCuźżź¬ź¾ż╬öĪŲ░ż╦żĶż├żŲ╬Š┼┼Č╦ż¼└▄¶öżĄżņżŲżżżļĪ󿥿ņżŲżżż╩żżż½ż╚żżż”ėX▌åż“╝┬ĖĮż╣żļ(┐▐1)ĪŻCu┼┼Č╦ż╦źūźķź╣┼┼░Ąż“ż½ż▒żļż╚Cuźżź¬ź¾ż¼┼┼Č╦ż½żķöĪŲ░żĘRu┼┼Č╦ż╚ż─ż╩ż¼żļż╚ź¬ź¾ż╦ż╩żĻĪóCu┼┼Č╦ż╦ź▐źżź╩ź╣┼┼░Ąż“ż½ż▒żļż╚Cuźżź¬ź¾ż¼ĖĄż╬┼┼Č╦ż╦╠ßżĻź¬źšż╦ż╩żļĪŻ╔wöü┼┼▓“䮿╬Ė³żĄżŽ4~5nmż╚Ū÷żżĪŻ
ź¬ź¾/ź¬źš╗■┤ųżŽ10nsµć┼┘ż╚“£═Ķż╬ĖČ╗ęź╣źżź├ź┴żĶżĻżŌ2ĘÕÅ]żżż┐żßĪó10▓»(1G)Ė─ż╬ź╣źżź├ź┴ż“źĘźĻźóźļż╦└┌żĻü÷ż©żŲżŌ10╔├µć┼┘żŪźūźĒź░źķźÓż¼Į¬ż’żļĪŻż│ż╬źßźŌźĻź╣źżź├ź┴żŽ╔įĦ╚»└ŁżŪżóżļż┐żßĪó┬įĄĪ╗■żŽ┼┼Ė╗ż“ź¬źšż╣żļż│ż╚ż¼żŪżŁżļĪŻż╣ż╩ż’ż┴┬įĄĪ┼┼╬üżŽź╝źĒżŪżóżļĪŻ
LEAPż¼ż│żņż▐żŪ│½╚»żĘżŲżŁż┐ź╣źżź├ź┴źŪźąźżź╣żŪżŽĪóCu╔ĮĀCż¼¤©▓ĮżĄżņCuźżź¬ź¾ż¼Ø▓╩¼ż╦╚»Ö┌żĘż╩ż»ż╩żļż┐żßĪ󟬟šż½żķź¬ź¾ėX▌åż╦╔ÅöĪż╣żļż╬ż╦ź╣źżź├ź┴1Ė─żŪ1µsż╬╗■┤ųż¼ż½ż½ż├żŲżżż┐ĪŻ10▓»Ė─ż╬ź╣źżź├ź┴ż└ż╚1000╔├Īóż╣ż╩ż’ż┴16.6╩¼żŌż½ż½żļż│ż╚ż╦ż╩żļĪŻ║ŻövżŽĪóCu┼┼Č╦╔ĮĀCż“TiAl╣ńČŌżŪä┘żżĪóCu╔ĮĀCż╬¤©▓Įż“╦╔żżż└ĪŻź╣źżź├ź┴żĄż╗żļż┐żßż╬┼┼░ĄżŽ2.1Vµć┼┘ż▐żŪ▓╝ż¼ż├ż┐ĪŻŲ╔ż▀ĮążĘ┼┼░ĄżŽżŌż├ż╚─Ńż»żŲ║čżÓĪŻ
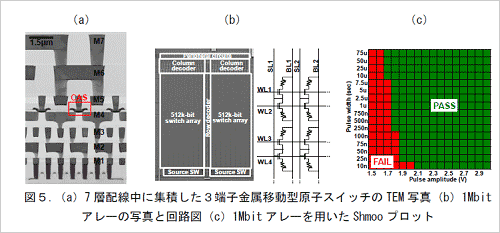
┐▐2ĪĪ1Mźėź├ź╚ż╬ź╗źļźóźņźżż╚ShmooźūźĒź├ź╚ĪĪĮąųZĪ¦LEAP
ż│ż╬ź╣źżź├ź┴ż╬Į±żŁ┤╣ż©öv┐¶ż¼1000övµć┼┘ż╩ż╬żŪĪóLEAPżŽFPGAż╬övŽ®└┌żĻü÷ż©ź╣źżź├ź┴├ō²ŗż“„[─ĻżĘżŲżżżļĪŻ║ŻövżŽ1Mźėź├ź╚ż╬źßźŌźĻźóźņźżż“╗Ņ║ŅżĘĪóShmooźūźĒź├ź╚żŪ2.1V░╩æųżŪżóżņżąµ£źėź├ź╚ż╬ź╣źżź├ź┴ż¼Ų░║ŅżŪżŁż┐ż│ż╚ż“│╬Ū¦żĘż┐(┐▐2)ĪŻĖĮ║▀Īó1źųźĒź├ź»ź╗źļż╦2Ė─ż╬LUTĪ╩źļź├ź»źóź├źūźŲĪ╝źųźļĪ╦ż“ĮĖ└čżĘż┐64Ī▀64ź╗źļż╬źĒźĖź├ź»źóźņźżż“╗Ņ║Ņ├µż└ż╚żĘżŲżżżļĪŻ
Į±żŁ┤╣ż©┼┼╬«ż“1/3ż╦║’žōżĘż┐STT-MRAM
╝¦└Łź╚ź¾ź═źļ└▄╣ńż“├ōżżż┐STT-MRAMĪ╩Spin Transfer Torque Magnetic Random Access memoryĪ╦żŪżŽĪóLEAPżŽ╣ŌĮĖ└č▓Įż╚─ŃŠ├õJ┼┼╬ü▓Įż“╝{ĄßżĘżŲżżżļĪŻČ”ż╦ĪóźßźŌźĻż╬ź╗źļĀC└čż“Š«żĄż»ż╣żļż│ż╚żŪ├Ż└«żŪżŁżļĪŻżĘż½żĘĪóźĻźĮź░źķźšźŻżŪź▐ź╣ź»źčź┐Ī╝ź¾ż“▓├╣®ż╣żļż└ż▒żŪżŽ╚∙║┘▓Įż╚Č”ż╦└■╔²ż╬źąźķż─żŁżŽĮjżŁż»ż╩żļĪŻLEAPż╬╝┬┘xżŪżŽĪó╬Ńż©żąź▐ź╣ź»źčź┐Ī╝ź¾╔²ż“70nmż½żķ60nmĪó50nmżžż╚╚∙║┘▓Įż╣żļż╚ĪóżĮż╬źąźķż─żŁ3”꿎Įńż╦3.9nmż½żķ4.7nmĪó6.2nmżžż╚╣Łż¼ż├żŲżżżļĪŻ
żĮż│żŪ╚∙║┘▓ĮżĘżŲżŌźąźķż─żŁż“│╚ĮjżĄż╗ż╩żżČ\Įčż“LEAPżŽ│½╚»żĘż┐ĪŻż│żņżŽź╗źļż╬MTJĪ╩╝¦└Łź╚ź¾ź═źļ└▄╣ńĪ╦ŗ╩¼ż“¤©▓ĮżĄż╗żļż│ż╚żŪź╗źļźšźóźķźżź¾źßź¾ź╚┼¬ż╦╚∙║┘ż╦żĘżĶż”ż╚ż╣żļČ\Įč(┐▐3)ĪŻ“£═ĶżŽĪóMTJż╚żĮż╬æųż╬źßź┐źļźŽĪ╝ź╔ź▐ź╣ź»ż“Ę┴└«żĘż┐ĖÕĪóź╗źļµ£öüż“źĘźĻź│ź¾├Ō▓Į╦ņżŪä┘ż├żŲżżż┐ĪŻ║ŻövżŽMTJż╬╝■░Žż“¤©▓ĮżĄż╗ż┐ĖÕĪóź╗źļµ£öüż“żĄżķż╦¤©▓Į╦ņżŪä┘żżĪó║ŪĮ¬┼¬ż╦├Ō▓Į╦ņżŪä┘ż├ż┐Ę┴ż╦ż╩żļĪŻźĻźĮź░źķźšźŻżŪż╬źßźŌźĻź╗źļż╬─ŠĘ┬żŽ35nmżŪżóżĻĪóMTJż╬¤©▓Į╦ņżŽ15nmż╬Ė³żĄżŪżóżļż½żķĪóżĮż╬║╣20nmż¼źßźŌźĻź╗źļż╬─ŠĘ┬ż╚ż╩ż├ż┐ĪŻ
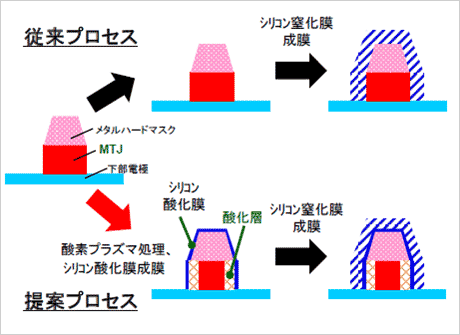
┐▐3ĪĪź╗źļ╝■░Žż“¤©▓ĮżĘź╗źļźšźóźķźżź¾źßź¾ź╚żŪź╗źļż“╚∙║┘▓Įż╣żļĪĪĮąųZĪ¦LEAP
16Kźėź├ź╚ż╬ź╗źļźóźņźżż“╗Ņ║ŅĪóMTJż╬°BŃ^├═ż╬ź’źżźųźļ╩¼╔█ż“ż╚ż├ż┐ż╚ż│żĒĪó“£═ĶźūźĒź╗ź╣ż╦żĶżļźóźņźżż╚µ£ż»Ų▒żĖ’łżŁż“┐āżĘĪóźąźķż─żŁżŽ╩čż’żķż╩żżż│ż╚ż“│╬Ū¦żĘż┐ĪŻż│ż╬±T▓╠ĪóĮ±żŁ┤╣ż©┼┼╬«żŽ16Kź╗źļż╬├µ▒¹├═żŪ15µAż╚“£═Ķż╬1/3ż╦▓╝ż¼ż├ż┐ĪŻ╝¦Ąż°BŃ^ż╬ź¬ź¾/ź¬źš╚µżŽ├µ▒¹├═żŪ“£═ĶźūźĒź╗ź╣ż╬73%ż½żķ86%żžż╚æųż¼żĻĪóĪų1ĪūĪóĪų0Īūź▐Ī╝źĖź¾ż¼╣Łż¼żļ╬╔╣źż╩öĄĖ■ż╦ż╩ż├ż┐ĪŻż┐ż└żĘĪó┐▐4żŪżŽ╝¦Ążź╣źįź¾ż╬Ė■żŁż¼╩┐╣įĪ╩PĪ╦ż½żķ╚┐╩┐╣įĪ╩APĪ╦ĪóżóżļżżżŽżĮż╬Ąšż╬ź’źżźųźļ╩¼╔█ż“┐āżĘżŲżżżļż¼Īóżõżõź▐Ī╝źĖź¾ż¼Č╣ż»ż╩ż├żŲżżżļĪŻż│żņż╦ż─żżżŲLEAPżŽĪóź©ź├ź┴ź¾ź░Ę┴ėXż╦żĶżļźąźķż─żŁż└żĒż”ż╚Ė½żŲżżżļĪŻ
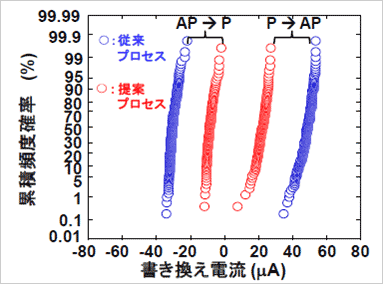
┐▐4ĪĪSTT-MRAMż╬Į±żŁ┤╣ż©┼┼╬«ż¼▓╝ż¼żļĪĪĮąųZĪ¦LEAP
LEAPżŽSTT-MRAMż“ź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓż╬źŁźŃź├źĘźÕźßźŌźĻż╦╗╚ż”ż│ż╚ż“„[─ĻżĘżŲżżżļż¼ĪóżĮż╬źóź»ź╗ź╣Å]┼┘ż╬20nsµć┼┘żŽįużķżņżŲżżżļż╚żĘżŲżżżļĪŻ“£═Ķż╬SRAMż└ż╚źŁźŃź├źĘźÕźßźŌźĻż╬ĀC└čż¼ĮjżŁż»źßźŌźĻ═Ų╬╠ż“╗\żõż╗ż╩żżż¼ĪóSTT-MRAMżŽź╗źļĀC└čż¼Š«żĄżżĪŻż│ż╬ż┐żßĪó╣ŌĮĖ└č▓Įż¼▓─ē”żŪźęź├ź╚╬©ż¼╣Ōżßżķżņżļż╚Ė½żŲżżżļĪŻ
ź╣ź╚źņĪ╝źĖżóżļżżżŽĪóDRAMż╚ź╣ź╚źņĪ╝źĖż“ż─ż╩ż░ź╣ź╚źņĪ╝źĖź»źķź╣źßźŌźĻżžż╬▒■├ōż“ų`╗žż╣┐ʿʿż┴Ļ╩č▓ĮźßźŌźĻTĪ╩Topological-switchingĪ╦RAMżŪżŽĪóĮ±żŁ┤╣ż©┼┼░Ąż““£═ĶPRAMż╬5.1Vż½żķ2.0Vżž─ŃžōżĘż┐ĪŻż╣żŪż╦1ĘŅ▓╝Į▄ż╬LEAP╩¾╣▓±żŪĪó╚»╔ĮżĘżŲżżżļ(╗▓╣═½@╬┴1)ż¼ĪóĮ±żŁ┤╣ż©öv┐¶żŽ100╦³öv░╩æųżóżĻĪóĮ±żŁ┤╣ż©╗■┤ųżŌ100ns░╩▓╝ż╚ø]żżĪŻMźėź├ź╚ź»źķź╣ż╬źßźŌźĻźóźņźżż╬╗Ņ║Ņż“┐╩żßżŲżżżļĪŻż┐ż└Īóź╣ź╚źņĪ╝źĖż╚żĘżŲ╗╚ż”ż┐żßż╦żŽźßźŌźĻź╗źļż╬ź╣źżź├ź┴ź¾ź░ż“ź╚źķź¾źĖź╣ź┐żŪżŽż╩ż»ź└źżź¬Ī╝ź╔żŪ╣įż”öĄ╝░ż╬öĄż¼╣ŌĮĖ└č▓Įż╦Ń~ŠWż└ż╚Ė½żŲżżżļĪŻ
LEAPżŽ╩┐└«26ŃQ┼┘ż▐żŪż╬5ŃQ┤ųż╦┼ŽżļźūźĒźĖź¦ź»ź╚żŪżóżĻĪó2015ŃQ3ĘŅĪ╩╩┐└«26ŃQ┼┘¼ŹĪ╦ż▐żŪż╦Īóż│żņżķż╬źŪźąźżź╣ż╬╝┬├ō▓Įż╬źßź╔ż“╬®żŲżļØŁ═ūż¼żóżļĪŻ
╗▓╣═½@╬┴
1. ┐ĘĘ┐┴Ļ╩č▓ĮźßźŌźĻż“TRAMż╚LEAPż¼╠┐ć@ (2014/02/18)


