nmź╣ź▒Ī╝źļż╦ż╩ż├żŲżŁż┐║Żż│żĮĪóź│źķź▄ż╬╗■┬ÕĪ▌ź╗ź▐źŲź├ź»ż╬Ō}żėż½ż▒
ä▌╣±ż“Ą“┼└ż╚ż╣żļź╗ź▐źŲź├ź»Ī╩SEMATECHĪ╦żŽĪóČ”Ų▒│½╚»ż╬ź│ź¾źĮĪ╝źĘźóźÓż└ż¼Īóź╩ź╬źßĪ╝ź┐ź╣ź▒Ī╝źļż╬║Żż│żĮĪóżĮż╬ØŁ═ū└Łż“└ŌżżżŲżżżļĪŻäóÅøĪ”ŗ║ÓźßĪ╝ź½Ī╝ż╦ż╚ż├żŲĖ”ē|│½╚»┼Ļ½@ż¼żóż▐żĻż╦żŌ╗\Įj(lu©░)żĘż┐ż½żķż└ĪŻź╗ź▀ź│ź¾źĖźŃźčź¾ĮķŲ³ż╬┤─┤╣ų▒ķżŪżŌźżź¾źŲźļźĖźŃźčź¾ż╬Ą╚┼─Ž┬┘ć╝ę─╣żŽ1╝ężŪ│½╚»ż╣żļż╬żŪżŽż╩ż»ż▀ż¾ż╩żŪź│źķź▄ż╣żļ╗■┬Õż╦ż╩ż├ż┐ż╚Įęż┘ż┐ĪŻ

┐▐1ĪĪSEMATECHźĘź╦źóźŪźŻźņź»ź┐ż╬Michael LercelĢ■
ź╗ź▀ź│ź¾źĖźŃźčź¾║ŪĮ¬Ų³ż╦żŽ╚ŠŲ│öüĖ”ē|│½╚»ź│ź¾źĮĪ╝źĘźóźÓĪóź╗ź▐źŲź├ź»ż╬źĘź╦źóźŪźŻźņź»ź┐żŪżóżļMichael LercelĢ■(┐▐1)ż¼×æļ]äóÅøĪ”║Ó╬┴żŌź╩ź╬źßĪ╝ź┐╗■┬Õż╦żŽź│źķź▄ż¼’Lż½ż╗ż╩ż»ż╩żļĪóż╚Įęż┘ż┐ĪŻż│ż╬ź│źķź▄źņĪ╝źĘźńź¾┴╚“Eż“ŠW(w©Żng)├ōż╣żņżą1╝ę┼÷ż┐żĻż╬│½╚»╔ķ├┤żŽĘ┌žōżĄżņżļżŽż║ż└ĪŻźūźĒź╗ź╣│½╚»żõ─Ńź│ź╣ź╚Č\Įčż╬│½╚»ż╚żżż├ż┐źŲĪ╝ź▐żŪź│źķź▄źņĪ╝źĘźńź¾ż“┐╩żßżŲżŁż┐ź╗ź▐źŲź├ź»ż└ż¼Īó║ŻżŪżŽŽó╦«Ž×ĮBż½żķż╬½@ČŌżŽ1ź╗ź¾ź╚żŌŲ■ż├żŲżżż╩żżĪŻ┤ļČ╚ż¼½@ČŌż“ĮążĘ╣ńżż│½╚»╔ķ├┤ż“źĘź¦źóż╣żļżĶż”ż╦ż╩żĻĪóź│źķź▄źņĪ╝źĘźńź¾ż╬źėźĖź═ź╣ż╚żĘżŲ┘M¶öżŪżŁżļżĶż”ż╦ż╩ż├żŲżżżļĪŻ
╚ŠŲ│öüŠÅČ╚żŽ─╣┤³┼¬ż╦żŽ└«─╣ŠÅČ╚żŪżóżļż│ż╚żŽ╩čż’żĻż╩żżżŌż╬ż╬Īó1╝ę┼÷ż┐żĻż╬Ė”ē|│½╚»õJż¼ØÖŠ’ż╦╗\ż©żŲżŁżŲżżżļĪŻ×æļ]äóÅøźßĪ╝ź½Ī╝ż╬ŪõżĻæųż▓żŽźĻĪ╝ź▐ź¾źĘźńź├ź»żŪ═Ņż┴╣■ż¾ż└ż¼Īó╚Óżķż╬Ė”ē|│½╚»┼Ļ½@żŽżõżõ═Ņż┴ż┐µć┼┘ż╦ż╚ż╔ż▐ż├ż┐(┐▐2)ĪŻż╚żżż”ż╬żŽĪóäóÅø▌xŠņżŽ▓╔žé▓Įż╬öĄ(sh©┤)Ė■ż╦Ė■ż½ż├żŲż¬żĻĪóĮj(lu©░)Š}ż╬źūźņĪ╝źõĪ╝ż¼╗─ż├żŲżżżļż½żķż└ĪŻ▐köĄ(sh©┤)ĪóäóÅøĖ■ż▒ż╬źĄźūźķźżź┴ź¦Ī╝ź¾ż╬├µż╦żóżļŗ║ÓźßĪ╝ź½Ī╝ż╦ż╚ż├żŲżŽäóÅø▌xŠņż╬╩čŲ░ż¼Įj(lu©░)żŁż╣ż«żļż╚Ų▒╗■ż╦ĪóĖ”ē|│½╚»┼Ļ½@żŌ╗\żõż╗ż╩żżėXČĘż╦ż╩ż├żŲżżżļĪ╩┐▐2Ī╦ĪŻ
![┐▐2ĪĪ×æļ]äóÅøźßĪ╝ź½Ī╝ż╬R&Dź│ź╣ź╚(æų)żŽ╩čż’żķż╩żżż¼ŗ║ÓźßĪ╝ź½Ī╝ż╬żĮżņ(▓╝)żŽĘ╩Ążż╦║ĖīÜżĄżņżļ](/archive/editorial/industry/img/INC121214-01b.gif)
┐▐2ĪĪ×æļ]äóÅøźßĪ╝ź½Ī╝ż╬R&Dź│ź╣ź╚(æų)żŽ╩čż’żķż╩żżż¼ŗ║ÓźßĪ╝ź½Ī╝ż╬żĮżņ(▓╝)żŽĘ╩Ążż╦║ĖīÜżĄżņżļ
żĮż│żŪź╗ź▐źŲź├ź»żŽĪóŗ║ÓźßĪ╝ź½Ī╝ż“╝ńż╩×┤ō■(j©┤)ż╚żĘżŲĪóź│źķź▄źņĪ╝źĘźńź¾ż╦żĶż├żŲĖ”ē|│½╚»õJ╔ķ├┤żõźĻź╣ź»ż“Ę┌žōżĘżĶż”ż╚Ō}żėż½ż▒żŲżżżļĪŻ║ŪżŌ½@ČŌż╬ż½ż½żļźŲĪ╝ź▐ż╚żĘżŲEUVż¼żóżļĪŻEUVż╬╝┬├ō▓Įż╦żŽäóÅøżĮż╬żŌż╬ż╬Ė„Ė╗ż╬╠õ¼öżŽżŌż┴żĒż¾żóżļż¼ĪóżĮżņ░╩│░ż╦żŌź▐ź╣ź»żõź▐ź╣ź»źųźķź¾ź»ź╣ĪóźņźĖź╣ź╚│½╚»Īóź╩ź╬ź╣ź▒Ī╝źļż╬’L┤┘ĖĪĮąż╩ż╔ż╬╠õ¼öżŌæč└čżĘżŲżżżļĪŻ
EUVź▐ź╣ź»ĖĪØhäóÅøż╬▌xŠņżĮż╬żŌż╬żŽżĄż█ż╔Įj(lu©░)żŁż»ż╩żżĪŻżĘż½żĘEUVźĻźĮź░źķźšźŻČ\Įčż“╝┬├ō▓Įż╣żļż┐żßż╦żŽż│ż╬äóÅø│½╚»żŽ’Lż½ż╗ż╩żżĪŻĖĪØhäóÅøż╬│½╚»ż╦żŽĄĮj(lu©░)ż╩┼Ļ½@ż¼ØŁ═ūż╚ż╩żļĪŻ1╝ężŪżŽ║żžMżŪżóżĒż”ĪŻźņźĖź╣ź╚żŌŲ▒══ĪóEUV├ōż╬źņźĖź╣ź╚│½╚»ż“1╝ężŪ╣įż├żŲżżżŲżŽ┼Ļ½@ż╬öv╝²żŽžMżĘżżĪŻź▐ź╣ź»ĖĪØhżŌ20nmźņź┘źļż╬’L┤┘ĖĪĮąż╦żŽ│½╚»┼Ļ½@±YżŽĄĮj(lu©░)ż╦ż╩żļĪŻ
ź▐ź╣ź»┤žĘĖżŪżŽĪóź╗ź▐źŲź├ź»ż╦żŽEMIĪ╩EUV Mask InfrastructureĪ╦Initiativeż╚żżż”źūźĒź░źķźÓż¼żóżļĪŻ╬╠ŠÅĖ■ż▒ż╬EUVź▐ź╣ź»ĖĪØhäóÅøż“┬ō(li©ón)żė│½╚»ż╣żļż┐żßżŪżóżļĪŻ’L┤┘ż╬ĖĪØhżõT┘ćĪó║Ųź┴ź¦ź├ź»ż¼ÅR╬ü╩¼╠ŅżŪżóżļĪŻż│ż╬źūźĒź░źķźÓż╬ź½ź«żŽ4ż─żóżļĪŻ┤łĖĪØhĪóźųźķź¾ź»ź╣ĖĪØhĪóźčź┐Ī╝ź¾ĖĪØhĪóżĮżĘżŲEUV AIMSźūźĒźĖź¦ź»ź╚żŪżóżļĪŻ4╚ųų`ż╬ź╗ź▐źŲź├ź»-ź─źĪźżź╣ż╬EUV AIMSČ”Ų▒źūźĒźĖź¦ź»ź╚żŽ║“ŃQ╗Žż▐żĻ(┐▐3)Īó4╝ęż╬▓±µ^┤ļČ╚ż¼╗▓▓├żĘżŲżżżļĪŻ

┐▐3ĪĪź╗ź▐źŲź├ź»ż╚ź─źĪźżź╣ż╬EUV AIMSČ”Ų▒źūźĒźĖź¦ź»ź╚ĪĪĮąųZĪ¦SEMATECH
źņźĖź╣ź╚│½╚»żŪżŽĪóźĻźĮź░źķźšźŻäóÅøż¼’Lż½ż╗ż╩żżż¼ĪóźņźĖź╣ź╚źßĪ╝ź½Ī╝ż¼╣Ō▓┴ż╩EUVäóÅøż“ĻP(gu©Īn)Ų■ż╣żļż╬żŽžMżĘżżĪŻ2003ŃQż╦żŽź╣źŁźŃź╩Ī╝Ī╩źĻźĮź░źķźšźŻäóÅøż╬1¹|Ī╦ż╬╩┐Čč▓┴│╩ż╬60Ū▄ż╚żżż”źņźĖź╣ź╚▌xŠņż└ż├ż┐ż¼Īó2011ŃQż╦żŽEUVź╣źŁźŃź╩Ī╝ż╬15Ū▄ż█ż╔ż╦Īóź╣źŁźŃź╩Ī╝1±śż╬▓┴│╩ż╚źņźĖź╣ź╚µ£öüż╬▌xŠņż╚ż╬║╣ż¼Ą═ż▐ż├żŲżżżļ(┐▐4)ĪŻżĮż│żŪĪóź╗ź▐źŲź├ź»ŲŌż╦└▀╬®żĘż┐RMDCĪ╩Resist and Materials Development CenterĪ╦ż╦ż¬żżżŲ24╗■┤ųĪóźņźĖź╣ź╚│½╚»ż╦ŲDżĻ┴╚żßżļżĶż”ż╦ż╩ż├żŲżżżļĪŻ2008ŃQ░╩═ĶŲDżĻ░Ęż├żŲżŁż┐║Ó╬┴ż╬╩Å╝ŖżŽ1╦³3000¹|╬Óż╦żŌĄ┌żųĪŻź”ź¦Ī╝źŽ┐¶żŽ2╦³6000ĮŚż╦ż╩żļĪŻżĮżņżŪżŌźņźĖź╣ź╚źßĪ╝ź½Ī╝ż½żķäh▓┴═ūĄßżĄżņżŲżżżļźņźĖź╣ź╚║Ó╬┴ż╬¹|╬ÓżŽ¾Hż»ĪóżĮż╬═ūĄßż╚ČĪĄļż╚ż╬ź«źŃź├źūżŽ░═─śż╚żĘżŲĮj(lu©░)żŁżżĪŻ
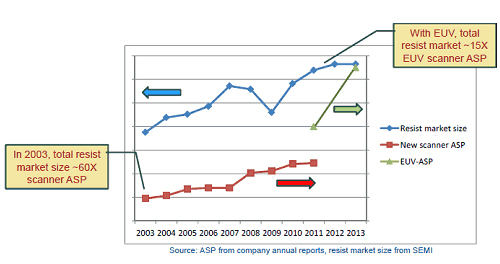
┐▐4ĪĪźņźĖź╣ź╚▌xŠņµ£öüżŽEUVź╣źŁźŃź╩Ī╝▓┐±ś╩¼Ī®
ź╗ź▐źŲź├ź»ż╬ź¬źļźąź╦Ī╝żŪżŽĪóż│żņż▐żŪNA0.3ż╬źņź¾ź║(╚┐╝oÅU)ż“╗╚żżĪó16nmż╬źżźßĪ╝źĖź¾ź░ż“╣įż├żŲżŁżŲż¬żĻĪóŽ¬Ė„żĘż┐ź”ź¦Ī╝źŽż╬┐¶żŽŃQ┤ų6000ĮŚż╦Ą┌żųĪŻ2013ŃQż╦żŽNA0.5ż╬źņź¾ź║żŪ12nm░╩▓╝ż╬źčź┐Ī╝ź╦ź¾ź░ż“╣įż”╝Ŗ▓ĶżŪżóżĻĪóŃQ┤ųż╬ĮĶ═²╬╠żŌ6000ĮŚż“«Ćż©żļ╝Ŗ▓Ķż╦żĘżŲżżżļĪŻźņźĖź╣ź╚ż╬źóź”ź╚ź¼ź╣ż╦ż─żżżŲżŌĖ”ē|żĘżŲż¬żĻĪóASMLż╬EUVäóÅøNXE3100ż“╗╚├ōżĘżŲźņźĖź╣ź╚║Ó╬┴ż“äh▓┴żĘżŲżżżļĪŻ

┐▐5ĪĪź╗ź▐źŲź├ź»ż╬RMDCżŽ2013ŃQż╦12nm░╩▓╝ż╬źņźĖź╣ź╚źčź┐Ī╝ź¾ż╦─®└’ĪĪĮąųZĪ¦SEMATECH
20nm░╩▓╝ż╬’L┤┘ĖĪĮążŽ─_═ūż╩Č\Įčż╬▐kż─żŪżóżĻĪó║ŻĖÕEUVź▐ź╣ź»źųźķź¾ź»ź╣ż╦ż¬żżżŲ’L┤┘ż╬Ų▒─ĻżŽź½ź«ż╚ż╩żļĪŻ’L┤┘Ų▒─ĻĪ”ĖĪĮąĖĪØhż╦ż½ż½żļź│ź╣ź╚żŽż│żņż▐żŪż╬50nmµć┼┘ż╬’L┤┘żŪ┐¶100╦³ź╔źļæä╠Žż└ż├ż┐ż¼Īó20nm░╩▓╝żŪżŽ3000╦³ź╔źļæä╠Žż╦ż╩żļż╚Ė½└čżŌż├żŲżżżļĪŻź╗ź▐źŲź├ź»ż╦żŽ1▓»ź╔źļ┴Ļ┼÷ż╬└▀×óż“×óż©ż┐MBDCż¼żóżļ(┐▐6)ż┐żßĪó│½╚»┼Ļ½@ż╦½@ČŌż“┼ĻŲ■żŪżŁż╩żż║Ó╬┴źßĪ╝ź½Ī╝ż╦ż╚ż├żŲżŽ╣Ō▓┴ż╩└▀×óż¼╗╚ż©żļż╚żżż”źßźĻź├ź╚ż¼żóżļĪŻ

┐▐6ĪĪź╗ź▐źŲź├ź»żŪżŽEUVźņźĖź╣ź╚│½╚»ż╦ØŁ═ūż╩äóÅøż“╗╚ż©żļĪĪĮąųZĪ¦SEMATECH
ØŖż╦ĪóEUVżŽāS─╣ż¼13.5nmż╚ŲX└■ż╦ŖZżżż┐żßĪóŲ®āįźņź¾ź║żŪżŽż╩ż»╚┐╝oÅUźņź¾ź║ż“╗╚ż”ØŁ═ūż¼żóżļĪŻź▐ź╣ź»źųźķź¾ź»ź╣żŪżŽź¼źķź╣┤łæųż╦SiŪ÷╦ņ4nmĪóMoŪ÷╦ņ3nmż“Ę½żĻ╩ųżĘ▓┐┴žż╦żŌ└č┴žżĘżŲżżż»ĪŻČ╦żßżŲ╩Ż╗©ż╩╣Įļ]ż╦ż╩ż├żŲż¬żĻĪóĀażõ’L┤┘ż╬Ų■żļ═Š├Žż¼Įj(lu©░)żŁżżż┐żßĪ󟻟ĻĪ╝ź¾ż╩ź▐ź╣ź»ż“║ŅżĻ┤╔═²ż╣żļż│ż╚ż¼žMżĘżżĪŻEUVż╬▓▌¼öżŽ¾HżżĪŻ


