ŗī3övSEMIģ╬═█Ė„╚»┼┼Č\ĮčźĘź¾ź▌źĖź”źÓż½żķĖ½żļĖĮėXż╚Įø═Ķ·t╦ŠĪ╩1Ī╦
ź╗ź▀ź│ź¾źĖźŃźčź¾2008ż╦±éż╗Īóŗī3övSEMIģ╬═█Ė„╚»┼┼źĘź¾ź▌źĖź”źÓż¼╦ļ─źżŪ│½╠¢żĄżņż┐ĪŻģ╬═█Ė„╚»┼┼żŽĪó─╣┤³┼¬ż╩·t╦Šż╦╬®ż├ż┐Č\ĮčżŪżóżļż┐żßĪóĖĮėXż╚Įø═Ķżžż╬·t╦Šż╦ż─żżżŲĪóČ╚─cż“┬Õ╔ĮżĘĪóĖ”ē|│½╚»┼¬ż╩╬®Šņż½żķŠÅČ╚┴Ē╣ńĖ”ē|ĮĻģ╬═█Ė„╚»┼┼Ė”ē|ź╗ź¾ź┐Ī╝Īóź╗źļżõźŌźĖźÕĪ╝źļż“Ö┌ŠÅż╣żļźßĪ╝ź½Ī╝ż╚żĘżŲįÆ═╬┼┼ĄĪĪóź╗źļż╬Ė░ż╚ż╩żļ║Ó╬┴ż╬źĘźĻź│ź¾╬®Šņż½żķź╣ź┌Ī╝ź╣ź©ź╩źĖĪ╝ż½żķż╬╚»╔Įż“ż▐ż╚żßż┐ĪŻż▐ż║ĪóŠÅ┴ĒĖ”ż╬╣ų▒ķż½żķŠę▓ż╣żļĪŻ
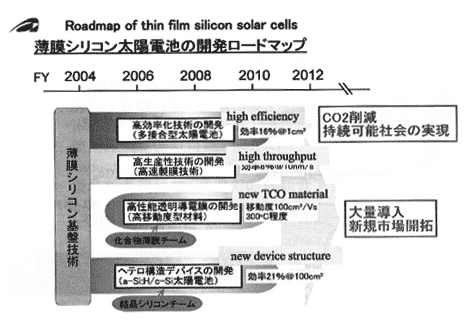
Īųģ╬═█Ė„╚»┼┼Č\Įč│½╚»ż╬ĖĮėXż╚Įø═Ķ·t╦ŠĪūŠÅČ╚┴Ē╣ńĖ”ē|ĮĻģ╬═█Ė„╚»┼┼Ė”ē|ź╗ź¾ź┐Ī╝
ĪĪŲ¾“vĪĪ▒╔Ģ■ż╬╣ų▒ķ
1.ģ╬═█Ė„╚»┼┼Ė”ē|ź╗ź¾ź┐Ī╝ż╬▄ć═ū
ĪĪ║ŲÖ┌▓Įż╬ź©ź═źļź«Ī╝ż╬├µżŪģ╬═█Ė„ż¼žéżßżļ│õ╣ńżŽĪóż▐ż└ż▐ż└Š«żĄżżż¼Īó2030ŃQżŪżŽ╩Å└č╚»┼┼╬╠102GWż¼„[─ĻżĄżņĪóģ╬═█Ė„żžż╬┤³┬įżŽĮjżŁżżĪŻ
ĪĪ└ż─cż╬ģ╬═█Ė„╚»┼┼Ö┌ŠÅ╬╠żŽŃQ╬©40%ŖZż»╗\▓├żĘżŲżżżļż¼ĪóĖĮ║▀Ų³╦▄żŪżŽ─õŠ]żĘżŲż¬żĻĪó║ŻĖÕżŽŲ³╦▄ż╬Ö┌ŠÅ╬╠ż“╗\żõż╣┼ž╬üż¼ØŁ═ūżŪżóżļĪŻ2005ŃQż▐żŪżŽĪóŲ³╦▄ż¼Ö┌ŠÅ╬╠źĘź¦źóż╬50%ż“žéżßżŲżżż┐ż¼Īó║ŻżŽź╔źżź─ż╬Q-Cells╝ę┼∙ķL│░└¬ż¼äPżėĪóŲ³╦▄ż╬źĘź¦źóżŽ─Ń▓╝żĘżŲżżżļĪŻØŖÖzż╩źßĪ╝ź½Ī╝ż╚żĘżŲä▌╣±ż╬Sunsolar╝꿎ĪóCdTeż“├ōżżż┐ģ╬═█Ė„źŌźĖźÕĪ╝źļżŪźĘź¦źóż“▐kĄżż╦äPżążĘżŲżŁż┐±T▓╠ĪóŪ÷╦ņż╬Ö┌ŠÅ╬╠żŌäPżėĮążĘżŲżżżļĪŻ
ĪĪPV2030ż╬źĒĪ╝ź╔ź▐ź├źūżŽĪó║ŻĖ½─ŠżĘ├╩│¼ż╦═ĶżŲżżżļĪŻż│ż╬źĒĪ╝ź╔ź▐ź├źūż╦żĶżņżąĪó2030ŃQż╦żŽĪóŲ³╦▄ż╬┴Ē┼┼╬ü╬╠ż╬10%ż“ģ╬═█Ė„╚»┼┼żŪćśż”╝Ŗ▓ĶżŪżóżļĪŻĖĮ║▀żŽĪóż▐ż└2GWż└ż¼Īó2050ŃQż╦żŽ50Ū▄ż╦ż╣żļ╝Ŗ▓ĶżŪżóżļĪŻż▐ż┐ĖĮ║▀ż╬╚»┼┼ź│ź╣ź╚żŽĪó43▀ģ/kWhżŪżóżļż¼Īó┬Šż╬╚»┼┼ź│ź╣ź╚ż“╣═╬Ėż╣żļż╚Īó2030ŃQż▐żŪż╦żŽż│ż╬ź│ź╣ź╚ż“1/6Ī┴1/7ż╦żĘż╩ż▒żņżąż╩żķż╩żżĪŻżĄżķż╩żļČ\Įč│ū┐Ęż╚Īó└Łē”ż╬Ė■æųż¼ØŁ═ūż└ż¼ĪóĖĮėXČ\Įčż╬▓■╬╔żŪżŽ├Ż└«żŪżŁż╩żżż│ż╚ż¼ż’ż½ż├żŲżżżļĪŻż│żņż“├Ż└«ż╣żļż┐żßż╦żŽĪó│ū┐Ę┼¬ż╩Č\Įčż¼ØŁ═ūżŪżóżĻĪóĖĮ║▀ŠÅ┴ĒĖ”żŪżŽżĮż╬żĶż”ż╩│ū┐Ę┼¬ż╩Č\Įčż╬│½╚»ż╚Ė”ē|ż“┐╩żßżŲżżżļĪŻ
ĪĪŠÅ┴ĒĖ”żŽĪó2001ŃQż╦╣įż’żņż┐─╠ŠÅŠ╩ż╬ĄĪ╣Į▓■│ūżŪĪó╩Ż┐¶ż╬╣±▓╚Ė”ē|ĮĻż¼1ż─ż╬ŠÅ┴ĒĖ”ż╦ż╩ż├ż┐ĪŻĖĮ║▀ż╬Ė”ē|ŪvżŽĪó╠¾2,700ć@żŪĄ£ē»┐”µ^ż“╣ńż’ż╗żļż╚3,000ć@ż“«Ćż©żļ┐”µ^ż¼Šäē»żĘżŲżżżļĪŻżĄżķż╦ĪóķL│░┐═µ^ż“┤▐żßżļż╚┐”µ^┐¶żŽĪó5000┐═ż╦æųżļĪŻĖ”ē|│½╚»ż╬┴╚“Eż╚żĘżŲżŽĪóĮjżŁż»Ė”ē|ŗ╠ńż╚Ė”ē|│½╚»ź╗ź¾ź┐Ī╝ż╬2ż─ż¼żóżļĪŻĖ”ē|ŗ╠ńżŽĪóźĘĪ╝ź║ż“Ė”ē|ż╣żļ╠“│õż“├┤żżĪó│½╚»ź╗ź¾ź┐Ī╝żŽĪóų`║Yż“Ęeż├żŲø]┤³┤ųż╦Ė”ē|ż“╣įż”ż│ż╚ż¼ź▀ź├źĘźńź¾ż╦ż╩ż├żŲż¬żĻĪóģ╬═█Ė„╚»┼┼ż╬Ė”ē|ŗ╠ńżŽĪóż│ż╬Ė”ē|ź╗ź¾ź┐Ī╝ż╦ĮĻō’ż╣żļĪŻ
ģ╬═█┼┼├ėĖ”ē|ŗ╠ńż╬ź▀ź├źĘźńź¾żŽĪó▓╝ĄŁżŪżóżļĪŻ
1Ī╦┐Ęæäģ╬═█┼┼├ė║Ó╬┴Ą┌żėźŪźąźżź╣ż╬│½╚»Īóäh▓┴
ĪĪĪĪó¬ź│ź╣ź╚─ŃžōĪó┤─ČŁ╔ķ▓┘─Ńžō
2Ī╦ģ╬═█┼┼├ėż╬║YØŹ▓Įż╚äh▓┴Č\Įčż╬│½╚»
ĪĪĪĪó¬ŠÅČ╚┤╚ūż╬│╬╬®Ī╩╣±║▌Ēö┴Ķ╬üż╬äė▓ĮĪ╦
3Ī╦ģ╬═█Ė„╚»┼┼źĘź╣źŲźÓ▒┐├ōĪóäh▓┴Č\Įčż╬│½╚»
ĪĪĪĪ󬟩ź═źļź«Ī╝Ė╗ż╚żĘżŲż╬┤╚ūäė▓Į
4Ī╦ģ╬═█Ė„╚»┼┼ż“─╠żĖż┐╣±║▌Č©╬ü
ĪĪĪĪó¬╣±║▌╣ūĖźĪóĒö┴Ķ╬üäė▓Į
ĪĪż▐ż┐Īóź▌źĻźĘĪ╝ż╚żĘżŲżŽĪóĪųČ\Įč┼²╣ńż╬ż┐żßż╬źūźķź├ź╚źšź®Ī╝źÓż“ŠW├ōżĘż┐┐ūÅ]ż╩ŠÅČ╚▓ĮöĪ┼Šż╚├µ╬®╬®ŠņżŪż╬äh▓┴ĪóŽ×║÷║÷─Ļżžż╬╣ūĖźĪūżŪżóżļĪŻ
ĪĪĖ”ē|żŽĪó6ż╬ź┴Ī╝źÓż╦╩¼ż½żņżŲżżżļĪŻ1)źĘźĻź│ź¾┐Ę║Ó╬┴ź┴Ī╝źÓĪó2)±TŠĮźĘźĻź│ź¾ź┴Ī╝źÓĪó3)▓Į╣ńرŪ÷╦ņź┴Ī╝źÓĪó4)äh▓┴Ī”źĘź╣źŲźÓź┴Ī╝źÓĪó5)Ń~ĄĪŪ÷╦ņź┴Ī╝źÓĪó6)ŠÅČ╚▓Į└’ŠSź┴Ī╝źÓ
2.ĘQ¹|ģ╬═█┼┼├ėż╬│½╚»▓▌¼öż╚ŠÅ┴ĒĖ”ż╬ŲDżĻ┴╚ż▀
ĪĪģ╬═█┼┼├ėż╬¹|╬ÓżŽĪóĮjżŁż»Īó1Ī╦źĘźĻź│ź¾Īó2Ī╦▓Į╣ńرÅUĪó3Ī╦Ń~ĄĪÅUż╦Įj╩╠żŪżŁżļĪŻ┤╦▄żŽĪó├▒±TŠĮĪó¾H±TŠĮż╬źĘźĻź│ź¾ÅUż╬ģ╬═█┼┼├ėżŪżóżļż¼ĪóźĘźĻź│ź¾ĖČ╬┴╔į’Bż½żķĪóŪ÷╦ņÅUż╬ģ╬═█┼┼├ėżŌäPżėżŲżżżļĪŻŃ~ĄĪÅUżŽĪó┐¦┴Ū╗\┤Čż╚Ń~ĄĪŪ÷╦ņż╬2ż─ż╬═ū┴Ūż½żķż╩żĻĪóŠÅ┴ĒĖ”żŪżŽĪó═ū┴ŪČ\Įčż╬│½╚»ż“żõż├żŲżżżļĪŻŃ~ĄĪÅUżŽĪóż▐ż└└Ķż╬ģ╬═█┼┼├ėżŪżóżļĪŻ
2.1ĪĪ±TŠĮźĘźĻź│ź¾ģ╬═█┼┼├ė
óóĖĮėXż╚▓▌¼ö
ĪĪ±TŠĮÅUż╬ģ╬═█┼┼├ėżŽĪó▌xŠņż╬9│õż“żĘżßżŲżżżļż¼ĪóźĘźĻź│ź¾ż╬ĖČ╬┴╔į’BżŪĪóÖ┌ŠÅ╝Ŗ▓Ķż╦▒Ųūxż¼ĮążŲżżżļĪŻ±TŠĮÅUż╬ģ╬═█┼┼├ėżŽĪ󟔟¦Ī╝źŽĖ³200”╠mż╬Ė³żżSi±TŠĮż“╗╚ż”ż┐żßĪó─Ńź│ź╣ź╚▓Įż¼ØŁ═ūż╦ż╩żļĪŻŠÅ┴ĒĖ”żŪżŽĪó─Ńź│ź╣ź╚▓Įż╬ż┐żßż╦Īó▓╝ĄŁż╬Ė”ē|ż“ż¬ż│ż╩ż├żŲżżżļĪŻ
1Ī╦źĘźĻź│ź¾ĖČ╬┴ż╬╗╚├ō╬╠─ŃžōĪ╩50Ī┴100”╠mż╬Ū÷╦ņ▓ĮĪóź╣źķźżź╣Č\ĮčĪóĄÕėXźĘźĻź│ź¾ĪóĖ„╩─żĖ╣■żßĪ╦
2Ī╦ĖČ╬┴źĘźĻź│ź¾ż╬│½╚»
3Ī╦×lźšźĻĪ╝ź┌Ī╝ź╣ź╚
4Ī╦┐Ę╣Įļ]Ī╩HIT┼∙Ī╦
óó¾H±TŠĮż╬×æļ]āįµć
ĪĪźĘźĻź│ź¾ż“╣ŌčażŪ═Žż½żĘĪó╔wżßżŲ¾H±TŠĮźżź¾ź┤ź├ź╚ż“×æļ]żĘĪó└┌ż├żŲ┤łż“║ŅżļĪŻĖĮėXż╬▓▌¼öż╚żĘżŲżŽĪóŪ÷ż»└┌żņż╩żżĪ󟣟Ļź│ż╬źĒź╣┼∙ż¼żóżĻĪóź╣źķźżź╣Č\Į迎ŠÅ┴ĒĖ”żŪżŌ─_═ūż╩Ė”ē|źŲĪ╝ź▐żŪżóżļĪŻĖĮ║▀ż╬¾H±TŠĮż╬╝┬╬üżŽĪóŠ«ĀC└čżŪ19%Īóź╗źļżŪ18.5%ĪóźŌźĖźÕĪ╝źļżŪżŽ15%żŪżóżļĪŻ
óó±TŠĮźĘźĻź│ź¾ż╬└’ŠS
ĪŃŪ÷╦ņ▓ĮĪõ
ĪĪŠÅ┴ĒĖ”żŪżŽĪóŪ÷ż»żŲżŌĖ·╬©ż¼Įążļģ╬═█Ė„ź╗źļ│½╚»ż“żĘżŲżżżļĪŻ“£═Ķż╬Ņ^▀`┼ųŠĢż╚░█ż╩żĻĪó╔w─Ļ┼ųŠĢż“├ōżżżŲŪ÷╦ņ▓Įż“╣įż├żŲżżżļĪŻ╔w─ĻĘ┐ż╬┼ųŠĢź’źżźõĪ╝źĮĪ╝żŽĪóźįźóź╬└■ż╦┼ųŠĢż“╔w─ĻżĄż╗żŲ└┌żļČ\ĮčżŪżóżļĪŻ╔w─Ļ┼ųŠĢżŪ└┌║’żĘż┐ź”ź¦Ī╝źŽż╬źŁźŃźĻźóźķźżźšź┐źżźÓż“╚µ│ėż╣żļż╚ĪóŅ^▀`┼ųŠĢż╦╚µż┘źķźżźšź┐źżźÓż¼─╣żżĪŻż│żņżŽĪó╔ĮĀCż╬ź└źßĪ╝źĖż╦ÅŚ░°żĘżŲż¬żĻĪóźķźżźšź┐źżźÓż¼ø]żżż╚╔ĮĀCż╦źĘźĻź│ź¾ż╦ź└źßĪ╝źĖż¼żŽż├żŲżżżļż│ż╚ż╦ż╩żļĪŻČ▓żķż»Īó╔w─Ļ┼ųŠĢżŪżŽĪó┐¶”╠mż╬ź└źßĪ╝źĖżŪżóżļż¼ĪóŅ^▀`żŪżŽ10”╠mż╬ź└źßĪ╝źĖż¼Ų■ż├żŲżżżļż╚żżż”ż│ż╚ż¼╩¼ż½żļĪŻ
ĪŃĄÕėXźĘźĻź│ź¾Īõ
ĪĪź╣źķźżź╣źņź╣Č\Įčż╚żĘżŲĪóĄÕėXźĘźĻź│ź¾ż╬Ė”ē|ż“╣įż├żŲżżżļĪŻ═Ž═╗żĘż┐źĘźĻź│ź¾ż“┬Āż╦═Ņż╚żĘŠĢż“╔wżßĪóĄÕėXż╬źĘźĻź│ź¾ż“║ŅżļĪŻ2Łąµć┼┘ż╬ĮjżŁżĄżŪpn└▄╣ńż“║ŅżĻĪó19ż╬ĄÕż“ĮĖżßżŲ╩č┤╣Ė·╬©11%µć┼┘ż¼ĮążŲżżżļĪŻ
ĪŃHITĘ┐Īõ
ĪĪHITż╬ØŖ─¦żŽĪó×æļ]źūźĒź╗ź╣ča┼┘ż¼─Ńżżż│ż╚żŪżóżļĪŻHITżŽĪó├▒±TŠĮźĘźĻź│ź¾ż╬æųż╦źóźŌźļźšźĪź╣źĘźĻź│ź¾ż“¤²ż▒żļ╣Įļ]ż“żĘżŲżżżļĪŻźóźŌźļźšźĪź╣ż╬╦ņĖ³ż╬öUĖµż¼─_═ūż╩ź▌źżź¾ź╚żŪżóżĻĪóż│ż╬Ū÷╦ņöUĖµČ\Įčż“Ė”ē|żĘżŲżżżļĪŻ
2.2ĪĪŪ÷╦ņźĘźĻź│ź¾ģ╬═█┼┼├ė
ĪĪŪ÷╦ņźĘźĻź│ź¾ģ╬═█┼┼├ėż╬ØŖ─¦żŽĪó▓╝ĄŁż╬ż╚ż¬żĻżŪżóżļĪŻ
1Ī╦─ŃčażŪĘ┴└«▓─ē”Īó×æļ]ż╦═ūż╣żļź©ź═źļź«Ī╝ż¼Š»ż╩żż
2Ī╦╗╚├ōĖČ╬┴ż“─Ńžō▓─ē”Īó─Ńź│ź╣ź╚
3Ī╦═źżņż┐ča┼┘ĘĖ┐¶Ī╩╣ŌčażŪż╬└Łē”─Ń▓╝żŽŠ»ż╩żżĪ╦
4Ī╦źŪźČźżź¾ż╬śOĮy┼┘Įj
5Ī╦Ė„Š╚╝o▓╝żŪ└Łē”─Ń▓╝Ī╩Stebler-WronskiĖ·▓╠Ī╦
ŠÅ┴ĒĖ”żŪżŽĪó±TŠĮźĘźĻź│ź¾ż“Ū÷ż»żĘżŲĪó54”╠mż╬╬ŠĀCźžźŲźĒ╣Įļ]ż╬ģ╬═█┼┼├ėż“│½╚»żĘż┐ĪŻ╩¼Ė„┤Č┼┘żŽĪóżĮżņż╩żĻż╦ź½źąĪ╝żŪżŁżŲż¬żĻĪó╩č┤╣Ė·╬©12%ż“├Ż└«żĘż┐ĪŻĖ„╩─żĖ╣■żß╣Įļ]ż“Ų│Ų■ż╣żļż╚Ī󿥿ķż╦Ė·╬©żŽæųż¼żļż╚═Į„[żĄżņżļĪŻ
ĪŃĖ”ē|ż╬Ęą░▐Īõ
ĪĪŪ÷╦ņżŽĪóź┐ź¾źŪźÓ▓Įż¼╝ń╬«żŪżóżļĪŻ1976ŃQż╦ź╠źĘźŃźŲźļĮjżŪźóźŌźļźšźĪź╣ż╬├▒└▄╣ńż¼│½╚»żĄżņĪóżĮż╬╗■ż╬╩č┤╣Ė·╬©żŽ9.5%żŪżóż├ż┐ĪŻ1997ŃQż╦żŽź½ź═ź½ż¼├▒±TŠĮż╚źóźŌźļźšźĪź╣ż“┴╚ż▀╣ńż’ż╗ż┐2└▄╣ńż╬Ū÷╦ņż“│½╚»żĘĪó11.7%ż“╝┬ĖĮżĘż┐ĪŻż│żņ░╩æTĪó╚∙±TŠĮźĘźĻź│ź¾ż“├ōżżż┐2└▄╣ńż¼╝ń╬«ż╦ż╩żĻ╩č┤╣Ė·╬©10%░╩æųżŪżóżļĪŻŠÅ┴ĒĖ”żŪżŽĪóżŌż”▐kż─┴žż“’BżĘżŲ3└▄╣ńż╬Ė”ē|ż“╣įż├żŲż¬żĻĪóų`║YżŽ2010ŃQż╦15%ż“ų`╗žżĘżŲżżżļĪŻ
ĪŃź╚źĻźūźļź┐ź¾źŪźÓĘ┐┐Ę╣Įļ]ģ╬═█┼┼├ėĪõ
ĪĪź╚źĻźūźļź┐ź¾źŪźÓĘ┐żŽĪóźąź¾ź╔ż╬░█ż╩żļØ±ä®ż“─_ż═ĪóĖ„Ą█╝²āS─╣┬ėż╬░█ż╩żļØ±ä®ż“╗╚ż├żŲĪóĖ·╬©żĶż»Ė„ż“Ą█╝²ż╣żļ╣Įļ]żŪżóżļĪŻźóźŌźļźšźĪź╣SiĪ╩a-SiĪ╦ż╚╚∙±TŠĮSi-Geż“├ōżżżŲż¬żĻĪó╩č┤╣Ė·╬©16%ż“╝┬ĖĮżĘż┐ĪŻ║ŻĖÕżŽĪóź╩źĒĪ╝ź«źŃź├źū▓Įż╦żĶżĻĪó╣ŌżżśĘ│░┤Č┼┘ż“įużļż│ż╚ż“ų`╗žż╣ĪŻ
ĪŃŪ÷╦ņźĘźĻź│ź¾ģ╬═█┼┼├ėż╬Č\Įč▓▌¼öĪõ
ĪĪČ\Įč▓▌¼öżŽĪó░╩▓╝żŪżóżļĪŻ
ĪĪĪ”źóźŌźļźšźĪź╣źĘźĻź│ź¾ż╬Ė„╬¶▓Į
ĪĪĪ”╚∙±TŠĮźĘźĻź│ź¾ż╬╣ŌÅ]ī\└čĪ╩╚∙±TŠĮźĘźĻź│ź¾żŽ└«─╣źņĪ╝ź╚ż¼1ĘÕęÆżżĪ╦
ĪĪĪ”ĮjĀC└čī\└č
ĪĪĪ”ź┐ź¾źŪźÓ▓Į
ĪĪĪ”Ų®£½┼┼Č╦ĪóĖ„╩─żĖ╣■żß
ĪĪĪ”źšźņźŁźĘźųźļ▓Į
ĪŃŪ÷╦ņźĘźĻź│ź¾ģ╬═█┼┼├ėż╬│½╚»źĒĪ╝ź╔ź▐ź├źūĪõ
ĪĪŠÅ┴ĒĖ”żŪżŽĪó▓╝ĄŁż╬4ż─ż╬Ė”ē|źŲĪ╝ź▐ż“┐╩żßĪóCO2║’žōĘe¶ö▓─ē”╝ę▓±ż╬╝┬ĖĮż“┐▐żļ
1Ī╦╣ŌĖ·╬©▓ĮČ\Įčż╬│½╚»Ī╩¾H└▄╣ńĘ┐ģ╬═█┼┼├ėĪ╦2Ī╦╣ŌÖ┌ŠÅ└ŁČ\Įčż╬│½╚»Ī╩╣ŌÅ]└«╦ņČ\ĮčĪ╦3Ī╦╣Ō└Łē”Ų®£½Ų│┼┼╦ņż╬│½╚»Ī╩╣ŌöĪŲ░┼┘Ę┐║Ó╬┴Ī╦4Ī╦źžźŲźĒ╣Įļ]źŪźąźżź╣ż╬│½╚»Ī╩a-SiHĪ┐c-Siģ╬═█┼┼├ėĪ╦
óóŪ÷╦ņźĘźĻź│ź¾ż╬└’ŠS
ĪŃ¾H└▄╣ń▓ĮĪ╩╚∙±TŠĮSiGeĪ╦Īõ
╬Ńż©żąĪó╚∙±TŠĮż╦Geż“▓├ż©ż┐╚∙±TŠĮSiGeŪ÷╦ņģ╬═█┼┼├ėż╬│½╚»ż“╣įż├żŲżżżļĪŻGeż╬Ū╗┼┘ż“╩čż©żļż│ż╚ż╦żĶżĻĪóĖ„Ą█╝²ż“╗\▓├żĄż╗Ė·╬©Ė■æųż“┐▐żļĪŻ
ĪŃa-Si:HĖ„Š╚╝oĖ·▓╠ż╬═▐öUĪõ
ĪĪĖ„Š╚╝oż╦żĶżĻa-SiH┴žŲŌż╦’L┤┘ż¼Ö┌└«żĘĪóģ╬═█┼┼├ėż╬╩č┤╣Ė·╬©ż¼ĮjżŁż»─Ń▓╝ż╣żļĖĮō■ż¼ż’ż½ż├żŲżżżļĪŻż│żņżŽĪóźĘźķź¾źūźķź║ź▐├µżŪĘ┴└«żĘż┐╣Ō╝ĪźĘźķź¾ż¼a-SiHż╦ŲDżĻ╣■ż▐żņĖ„╬¶▓Įż“░·żŁÅŚż│ż╣ĖĮō■żŪżóżļĪŻź╚źķźżź¬Ī╝ź╔╦Īż“╗╚ż©żąĪó╣Ō╝Īż╬źĘźķź¾ż╬║«Ų■ż“ķcż▒żļż│ż╚ż¼żŪżŁżļĪŻź╚źķźżź¬Ī╝ź╔╦Īż╚żŽĪóźóź╬Ī╝ź╔ż╚ź½źĮĪ╝ź╔ż╬┤ųż╦ČŌō’źßź├źĘźÕ┼┼Č╦ż“┘UŲ■żĘĪóźūźķź║ź▐ż“ȧ┤ų┼¬ż╦╩─żĖ╣■żßżļöĄ╦ĪżŪżóżļĪŻ
ĪŃ╣ŌÖ┌ŠÅ└ŁĪ╩╣ŌÅ]└«╦ņĪóĮjĀC└č▓ĮĪ╦Īõ
ĪĪ«Ć╣ŌÅ]ż½ż─ĮjĀC└čż╬ź▐źżź»źĒāS╔ĮĀCāSźūźķź║ź▐CVDż╬│½╚»ż“ć@Ė┼▓░Įj│žż╚Č”Ų▒żŪ┐╩żßżŲżżżļĪŻ
ĪŃ╣ŌöĪŲ░┼┘┼┼Č╦╦ņĪ┐Ų®£½╦ņż╬│½╚»Īõ
ĪĪźóźŌźļźšźĪź╣żŽĪó1┴žż└ż¼Īó3└▄╣ńżŽĪó┤ųż╦Ų®£½┼┼Č╦╦ņż¼ØŁ═ūż╦ż╩żļĪŻ“£═Ķż╬ITOż╦×┤żĘżŲĪóH2ż“Ų│Ų■żĘż┐ĪŻ°BŃ^╬©śOöüżŽ╩čż’żķż╩żżż¼ĪóöĪŲ░┼┘ż╚źŁźŃźĻźóŪ╗┼┘ż¼░Ńż”ĪŻ°BŃ^╬©ż“▓╝ż▓ĪóöĪŲ░┼┘ż“▓╝ż▓żļĪóż─ż▐żĻźŁźŃźĻźóŪ╗┼┘ż¼╣Ōżżż│ż╚żŪźŁźŃźĻźóż╬Ą█╝²ż¼▓─ē”ż╚ż╩żļĪŻöĪŲ░┼┘ż╬╣Ōżżż╬żŽĪóČžöU┬ėżŪżŌŲ®£½ż╦ż╩żļĪŻ
2.3ĪĪ▓Į╣ńرÅUŪ÷╦ņģ╬═█┼┼├ė
ĪŃCIGSż╚żŽ>
ĪĪCIGSżŽĪóŠ╝Ž┬źĘź¦źļ┼∙żŪ│½╚»ż“╣įż├żŲżżżļ▓Į╣ńرŪ÷╦ņģ╬═█┼┼├ėżŪżóżļĪŻŁĄ-III-Ł║ż╬ź½źļź│źčźżźķźżź╚╚ŠŲ│öüżŪżóżĻĪóČžöU┬ė╔²żŽĪóGaż╚Inż╬Ū╗┼┘żŪöUĖµżŪżŁżļż╚żżż”ØŖ─¦ż¼żóżļĪŻ─╠Š’ż╬▓Į╣ńرż╦╚µż┘Īóźųźņź¾ź╔ż“2¹|╬ÓĘeż─ż╚żżż”ż│ż╚żŪĪóź½źļź│źčźżźķźżź╚ż╚Ō}żążņżŲżżżļĪŻ
ĪŃCIGSż╬ØŖ─¦Īõ
ĪĪ╣Įļ]ż╚żĘżŲżŽĪóź¼źķź╣┤łĪ▄ČŌō’┼┼Č╦Ī▄p-Cu(InGa)SeĪ▄CdSĪ▄iZnOż½żķ╣Į└«żĄżņżŲżżżļĪŻØŖ─¦żŽĪó░╩▓╝żŪżóżļ
1Ī╦╩č┤╣Ė·╬©ż¼╣ŌżżĪ╩źšźŻźļźšźĪź»ź┐FF=19.5%Ī╦
2Ī╦Ą█╝²ĘĖ┐¶ż¼ĮjżŁż»Ū÷╦ņ▓Į▓─ē”Ī╩”┴ż½żķ10ż╬5ŠĶ/cmĪ¦Siż╬100Ū▄Ī┐Ą█╝²┴ž╠¾2”╠mĪóµ£öüżŪ3”╠mĪ╦
3Ī╦ĘąŃQ╬¶▓Įż¼╠Ążż
4Ī╦═źżņż┐┬č╩³╝o└■└ŁĪ╩NASDA┐═╣®Ä┼└▒żŪ╝┬Š┌Ī╦
5Ī╦─Ńź│ź╣ź╚┤łż“╗╚├ō▓─ē”
CIGSżŽĪóµ£║Ó╬┴250ŻńżŪ1Ė«╩¼ż╬ģ╬═█┼┼├ėż¼żŪżŁżļż│ż╚żŌĮjżŁż╩ØŖ─¦żŪżóżĻĪóŠ╩½@Ė╗żŪŠ»ż╩żż╬╠żŪģ╬═█┼┼├ėż¼żŪżŁżļĪŻ╬╠ŠÅ▓ĮżŽĪó2007ŃQż½żķĪóŠ╝Ž┬ź╗źļż¼20MWż╬×æļ]ż“│½╗ŽżĘż┐ĪŻ║ŻĖÕĪó80MW@2009Īó1GW@2010ż“ų`╗žżĘżŲżżżļĪŻ┬Šż╬źßĪ╝ź½Ī╝ż╚żĘżŲżŽĪóź█ź¾ź└ż╚Wuerth SolarĪóAVANCISĪ╩źĄź¾ź┤źąź¾ż╬╗ę▓±╝ęĪ╦┼∙Īóź┘ź¾ź┴źŃĪ╝żŌ┤▐żß20╝ę░╩æųż¼│½╚»żĘżŲżżżļĪŻ
CIGSżŽĪóĖ·╬©ż¼╬╔żżż╚żżż”ØŖ─¦ż¼żóżļż¼Īó▐köĄżŪżŽĪóĮjĀC└čżŪżŽĖ·╬©ż¼▓╝ż¼żļż╚żżż”╠õ¼öż¼żóżļĪŻ1╩┐öĄcmż╬Š«ĀC└čżŪżŽĪó20%╝Õż╬╣ŌĖ·╬©ż└ż¼Īó▌x╚╬źŌźĖźÕĪ╝źļż╬żĶż”ż╩ĮjĀC└čżŪżŽĪó10%µć┼┘ż╬Ė·╬©ż╚ż╩ż├żŲżĘż▐ż”ĪŻ
ĖĮ║▀╠¾20%ż╬╣ŌĖ·╬©ż¼įużķżņż┐ż¼,ż│żņ░╩æųäPżėżļż╬ż½Ī®═²éb┼¬ż╦Ė└ż”ż╚Īó╩č┤╣Ė·╬©żŽĪóČžöU┬ė╔²1.4Ī┴1.5eVż╬źąź¾ź╔ź«źŃź├źūż¼╣ŌżżĪŻCIGSżŽĪóGaż“╗\żõż╣ż╚EgĪß1.25eVżŪ╩č┤╣Ė·╬©żŽ║ŪĮjż╦ż╩żļż¼ĪóżĮżņ░╩æųż╬EgżŪżŽĖ·╬©żŽżĮżņż½żķ▓╝ż¼żļż│ż╚ż¼ē¶żķżņżŲżżżļĪŻż│ż╬ż┐żßĪóŠÅ┴ĒĖ”żŪżŽ1.3eV░╩æųż╬ź’źżź╔ź«źŃź├źūż╬ģ╬═█┼┼├ėż╬│½╚»ż“┐╩żßżŲżżżļĪŻż│żņżŽĪó─cĀCż╬╠õ¼öż¼─_═ūżŪĪóäh▓┴Č\ĮčżŌ╣ńż’ż╗żŲ│½╚»żĘżŲżżżļĪŻ
ĪŃĮjĀC└č▓ĮĪõ
ĪĪĖ”ē|╝╝źņź┘źļżŪżŽĪó3Ī▀3╩┐öĄcmż╬Š«ĀC└čż╬ź¼źķź╣┤łżŪżóżļż¼Īó╬╠ŠÅżŪżŽĪó60Ī▀120╩┐öĄcmż╬ĮjĀC└čż¼ØŁ═ūż╚ż╩żļĪŻŠÅ┴ĒĖ”żŪżŽĪóĖ”ē|╝╝źņź┘źļż½żķżĄżķż╦▐k╩ŌŲ¦ż▀╣■ż¾żŪĪó10Ī▀10╩┐öĄcmż▐żŪ╝┬Š┌ż╣żļ═Į─ĻżŪżóżļĪŻż│ż╬╝┬ĖĮż╦żŽĪó“£═Ķż╬Ė”ē|╝╝źņź┘źļż╬źūźĒź╗ź╣ż╦╚µż┘ĪóźūźĒź╗ź╣ż¼ĮjżŁż»░█ż╩żļĪŻĮjĀC└čźŌźĖźÕĪ╝źļżŽĪóMoż╬źąź├ź»ź│ź¾ź┐ź»ź╚Ę┴└«ĖÕż╦źčź┐Ī╝ź╦ź¾ź░╣®µćż¼Ų■żĻĪ󿥿ķż╦źąź├źšźĪż“¤²ż▒ż┐ĖÕż╦2övų`ż╬źčź┐Ī╝ź╦ź¾ź░ĪóŲ│┼┼╦ņż“¤²ż▒ż┐ĖÕ3övų`ż╬źčź┐Ī╝ź╦ź¾ź░ż¼Ų■żļĪŻż│ż╬żĶż”ż╩źūźĒź╗ź╣żŪżŽĪóģ╬═█┼┼├ėżŪŲ░ż½ż╩żżŗ╩¼ż¼żŪżŁżŲżĘż▐ż”ĪŻ
─╠Š’ż╬CellżŽāeż╦┼┼╬«ż¼╬«żņżļż¼Īó┐ĘźūźĒź╗ź╣żŪżŽĪóŲ®£½Ų│┼┼╦ņMo├µż╬─╣żżš{▀`ż“┼┼╬«ż¼╬«żņżŲżĘż▐żżĪóż│ż╬ż│ż╚ż╦żĶżĻ°BŃ^ż¼Ė·ż»ż╬żŪĪó┴žż¼Ė³ż»ż╩żķżČżļż“ż©ż╩ż»ż╩żļĪŻ┴žż¼Ė³żżż╚Ė„źĒź╣ż¼╚»Ö┌żĘżŲżĘż▐ż”ĪŻż│żņżŪżŽĪ󿥿ķż╩żļĮjĀC└č▓ĮżŽžMżĘżżż╬ż¼ĖĮėXżŪżóżļĪŻż▐ż┐Īó±TŠĮ└Łż¼ż▐ż└╬╔ż»ż╩ż»Ī󿥿ķż╩żļ╣Ōēää®▓Įż¼─_═ūżŪżóżĻĪó15.9%ż▐żŪżŽ╝┬ĖĮżŪżŁżļĖ½─╠żĘżŪżóżļĪŻżĄżķż╦ĪóÖ┌ŠÅČ\ĮčżŪżŽĪó╔w─Ļż╬Į^ŠÆäóÅøżŪżŽĄ£Č╚▓Įż╦żŽ▒¾żżż┐żßĪó¾HĖĄĮ^ŠÆ╦Īż“├ōżżżŲźżź¾źķźżź¾żŪźūźĒź╗ź╣▓ĮżĘĪóĖĮ║▀14.2%ż»żķżżż▐żŪż╬╗Ņ║Ņż¼żŪżŁż┐ĪŻ
ż▐ż┐ĪóCIGSĄ█╝²┴žżžż╬┐ʿʿż┼║▓├öUĖµČ\ĮčĪ╩ASTL╦ĪĪ╦ż╬│½╚»ż╦żĶżĻĪ󿥿▐żČż▐ż╩źšźņźŁźĘźųźļ┤łż╦żĶżļ╣ŌĖ·╬©▓Įż╦żŌ└«Ė∙żĘż┐ĪŻ┤ł║Ó╬┴ż╦żŽĪóź╗źķź▀ź├ź»ź╣żõź┴ź┐ź¾Ū¾ż“┬ō─ĻżĘĪó║Ū╣ŌĖ·╬©17.7%ż“├Ż└«żĘż┐ĪŻ
2.4ĪĪŃ~ĄĪÅUģ╬═█┼┼├ė
Ń~ĄĪÅUģ╬═█┼┼├ėżŽĪóŖWż»żŲĪóį~├▒ż╦żŪżŁżļż╬ż¼ĮjżŁż╩źßźĻź├ź╚żŪżóżļĪŻŃ~ĄĪÅUż╦żŽĪó▓╝ĄŁż╬2¹|╬Óż¼żóżļĪŻ
ĪĪ1Ī¦┐¦┴Ū╗\┤Čģ╬═█┼┼├ėĪ╩DSSCĪ╦Ī¦Ė„▓Į│ž╚┐▒■ż╚ķ]öüż╬├µż“źżź¬ź¾ż¼╬«żņżļĖĮō■ż“ŠW├ōĪŻķ]ŃŖżņż╩ż╔ż╬×┤║÷ż¼ØŁ═ūĪŻ
ĪĪ2Ī¦╔wöüĘ┐Ū÷╦ņģ╬═█┼┼├ėĪ¦źĘźĻź│ź¾ż╚Ų▒══ż╦pn└▄╣ńż¼╚»┼┼ĪŻŃ~ĄĪELż╚╬Óō¶żĘż┐Ń~ĄĪ╚ŠŲ│öüźŪźąźżź╣ż╬▐k¹|ĪŻ
ĪĪŃ~ĄĪŪ÷╦ņģ╬═█┼┼├ėż╬─Ń╩¼╗꿎ĪóĮ^ŠÆ╦Īż¼▐k╚╠┼¬żŪżóżļĪŻ▐köĄĪóź▌źĻź▐Ī╝┼╔╔█ÅUżŽĪóź╣źįź¾ź│Ī╝ź╚żŪ═Žķ]ż“┼╔╔█żĘżŲ×æļ]ż╣żļĪŻ
ĪĪŃ~ĄĪÅUģ╬═█┼┼├ėż╬ØŖ─¦żŽĪó╠ĄĄĪÅUż╦╚µż┘┼┼░ĄżŽżõżõ╬¶żļż¼Īó┼┼╬«żŌØÖŠ’ż╦Š»ż╩żżĪŻ║ŻĖÕżŽĪóż│ż╬┼┼╬«╬╠ż“¾Hż»ż╣żļż╬ż¼─_═ūż╩Ė”ē|▓▌¼öżŪżóżļĪŻĖĮ║▀ż╬╩č┤╣Ė·╬©żŽĪó5.3%ż¼└ż─c║Ū╣ŌżŪżóżĻĪó10%ż“ų`╗žżĘżŲżżżļĪŻ
┼┼╬«ż“╗\żõż╣ż┐żßż╦żŽĪóĖ„ż╬Ą█╝²ōļ░Ķż“│╚Įjż╣żļż│ż╚ż¼ØŁ═ūżŪżóżļĪŻĖĮėXż╬pĘ┐Ń~ĄĪ╚ŠŲ│öüżŽĪón┴žż╚p┴žż╬┤ųż└ż▒ż¼Ą█╝²┴žż╚ż╩ż├żŲżżżļż¼Īóż│ż╬pż╚n┴žż╬┤ųż╦Č”Į^ŠÆ┴žĪ╩i┴žĪ╦ż“Ų│Ų■ż╣żļż│ż╚ż╦żĶżĻĪópn└▄╣ńĀC└čż“╗\ĮjżĄż╗żŲżżżļĪŻŻķ┴žż╬╦ņĖ³ż╚╩č┤╣Ė·╬©ż╬┤ųż╦żŽĖ³żĄ░═┘T└Łż¼┘T║▀ż╣żļĪŻŻķ┴žż“Ė³ż»ż╣żļż╚Īó’L┤┘ż╬├µż“ź╚źķź├źūżĘżŲżĘż▐ż”ż┐żßĪ󟣟џĻźóż¼¾Hż»╚»Ö┌ż╣żļż¼Īó²ŗ├µżŪż│ż╬’L┤┘ż╦ź╚źķź├źūżĄżņźŁźŃźĻźóż¼Ęxż¾żŪżĘż▐ż”ĪŻ║ŻĖÕżŽĪói┴žż╬ēä䮿“æųż▓żļż│ż╚ż¼─_═ūżŪżóżļĪŻ
ĪŃ╣Ō╩¼╗ęÅUģ╬═█┼┼├ėĪ╩P3HT:PCBMĪ╦Īõ
ĪĪĖĮėXżŽĪó┬čĄū└Łż¼╠õ¼öżŪżóżļĪŻź╣źįź¾50╗■┤ųżŪĪó╩č┤╣Ė·╬©żŽ─Ń▓╝ż╣żļż¼ĪóżŌż”▐k┼┘ÕXĮĶ═²ż“╗▄ż╣ż╚╩č┤╣Ė·╬©żŽĖĄż╦╠ßżļ└Łä®ż¼żóżļĪŻ╩č┤╣Ė·╬©ż╬─Ń▓╝żŽ╩¼╗ęż╬╬¶▓ĮżŪżŽż╩ż»Īóź╚źķź├źūż╬▒ŲūxżŪżŽż╩żżż½ż╚Ė└ż’żņżŲżżżļĪŻ
ĪŃŃ~ĄĪÅUģ╬═█┼┼├ėż╬ż▐ż╚żßĪõ
ĪĪŃ~ĄĪÅUģ╬═█┼┼├ėżŽĪ󿥿ķż╩żļ╣ŌĖ·╬©▓Įż╚┬čĄū└Łż╬Ė■æųż¼▓▌¼öżŪżóżļĪŻż│żņżķż“▓“»éż╣żļöĄ╦Īż╚żĘżŲżŽĪóź┐ź¾źŪźÓ▓Įż¼▐kż─ż╬öĄĖ■└Łż╚żĘżŲĪóĖ·╬©żŽ─Ńżżż¼┐╩żßżŲżżżļĪŻż▐ż┐Īóź╗źļż╬ØŖ└ŁżŽĪóźŪźąźżź╣╣Įļ]ż╦ĮjżŁż»░═┘Tż╣żļż┐żßĪóŃ~ĄĪ╩¼╗ęż┤ż╚ż╦║Ū┼¼ż╩źŪźąźżź╣╣Įļ]ż“│½╚»ż╣żļż│ż╚ż¼─_═ūżŪżóżļĪŻŃ~ĄĪELż╬║Ņ×æČ\Įčż¼ŠW├ō▓─ē”ż╩ż┐żßĪ󟥟ųźŌźĖźÕĪ╝źļ▓Į┼∙żŌ┐╩żßżŲżżż»ĪŻ
ĪŃ┐¦┴Ū╗\┤Čģ╬═█┼┼├ėĪõ
ĪĪ┐¦┴Ū╗\┤Čģ╬═█┼┼├ėżŽĪóź╣ź┌ź»ź╚źļōļ░Ķż“╗\żõżĘ└Łē”ż“æųż▓żŲżżżļĪŻźĘźŃĪ╝źūżŪ╩č┤╣Ė·╬©11.1%ż“ĮążĘżŲżżżļĪŻ╠õ¼öżŽĪóĮjĀC└č▓Įż╬źŌźĖźÕĪ╝źļĘ┴└«Č\ĮčżõĪóźļźŲź╦ź”źÓż╬½@Ė╗┼¬ż╩╠õ¼öĪóź╗źļż╬─╣┤³┐«═Ļ└Łż╬Ė■æųżŪżóżļĪŻ
3.ż▐ż╚żß
ģ╬═█Ė„╚»┼┼ż╬▐k┴žż╬╔ߥ┌ż╬ż┐żßż╦żŽĪóĖĮ║▀╝ń╬«żŪżóżļ±TŠĮźĘźĻź│ź¾ģ╬═█┼┼├ėż╬Č\Įč│ū┐ĘżŽżŌż╚żĶżĻĪóĘQ¹|┐ĘĘ┐ģ╬═█┼┼├ėż╬▌xŠņżžż╬┼ĻŲ■ż¼╔į▓─’LżŪżóżļĪŻż▐ż┐Īó┼┼├ėźßĪ╝ź½Ī╝ż╬ż▀ż╩żķż║ĪóäóÅøźßĪ╝ź½Ī╝Īó║Ó╬┴źßĪ╝ź½Ī╝ż╩ż╔ż╬╔²╣ŁżżČ╚─cż╬źĄź▌Ī╝ź╚ż¼╔į▓─’LżŪżóżļĪŻ


