AMDĪó3D-ICźßźŌźĻż“źżź¾ź┐ź▌Ī╝źČż╦┼ļ║▄żĘż┐2.5DźŌźĖźÕĪ╝źļż“│½╚»
źßźŌźĻźßĪ╝ź½Ī╝ż╬Micron Technologyż¼DRAMż“3╝ĪĖĄ┼¬ż╦TSVżŪ└č┴žż╣żļHMCĪ╩Hybrid Memory CubeĪ╦ż╦ż─żżżŲĪóSPIźšź®Ī╝źķźÓĪų3╝ĪĖĄ╝┬äóżžż╬╠OĪūżŪŠę▓żĘż┐ż¼ĪóAMDżŽź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓż“╣ŌÅ]Ų░║ŅżĄż╗żļż┐żßż╬TSVż╦żĶżļĪó┐ʿʿż2.5D ICČ\Įčż“£½żķż½ż╦żĘż┐ĪŻ
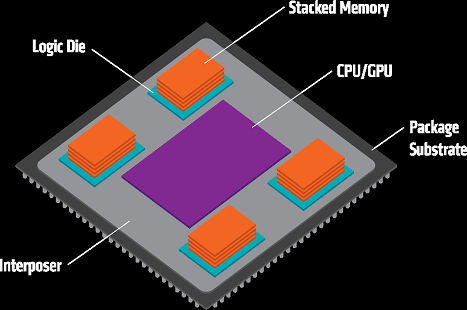
┐▐1ĪĪAMDż¼│½╚»żĘż┐HBMźßźŌźĻŠW├ōż╬2.5D-ICĪĪĮąųZĪ¦AMD
AMDżŽĪóHBMĪ╩High Bandwidth MemoryĪ╦ż╚Ō}żų└čż▀─_ż═żļDRAMż“TSVĪ╩Through Silicon ViaĪ╦żŪż─ż╩żżż└ICż╚ĪóCPU/GPUż╩ż╔ż“ĮĖ└čżĘż┐SoCż“Īóźżź¾ź┐ź▌Ī╝źČż“▓żĘżŲ└▄¶öż╣żļ2.5╝ĪĖĄČ\Įčż“╚»╔ĮżĘż┐ĪŻCPUżõGPUż╦Įj═Ų╬╠DRAMż“1ź┴ź├źūĮĖ└čż╣żļż│ż╚żŽĘą║č┼¬ż╦┴T╠Żż¼ż╩żżĪŻż▐ż┐DRAMż“▒¾ż»▀`żĘżŲŪ█Åøż╣żļż╚ĪóŪ█└■╔ķ▓┘ż¼─_ż»ż╩żĻÅ]┼┘żŽæųż¼żķż║ĪóŠ├õJ┼┼╬üżŌ╗\ż╣ĪŻ╬Ńż©żąĪóź░źķźšźŻź├ź»ź╣ķW▓Ķ║ŅČ╚ż“╣įż”Šņ╣ńĪóż│żņż▐żŪżŽGDDR5ż¼╗╚ż’żņżŲżŁż┐ż¼ĪóGDDR5ż╬źąź¾ź╔╔²ż“╣Łż▓Gbpsż╚╣ŌÅ]ż╦ż╩żļż╚ĪóŠ├õJ┼┼╬üżŽß×═ŲżŪżŁż╩żżż█ż╔╗\ĮjżĘżŲżĘż▐ż”ż╚żżż”ĪŻż│ż╬ż┐żßHBMĪ╩╣Łżżźąź¾ź╔╔²ż╬DRAMĪ╦ż“CPU/GPUż╬ŖZż»ż╦Ū█ÅøżĘżŲ╣Łżżźąź╣żŪż─ż╩ż░ż│ż╚ż¼╣Ō└Łē”ź│ź¾źįźÕĪ╝źŲźŻź¾ź░ż╬║Ū┼¼▓“ż╚ż╩żļĪŻØŖż╦Īóź╣ź┐ź├ź»żĘż┐źßźŌźĻż“ĖµCPU/GPUż“ŖZż┼ż▒żŲŪ█Åøż╣żļ(┐▐1)ż╚Īó1W┼÷ż┐żĻż╬źŽź¾ź╔╔²ż“ĮjżŁż»żŪżŁżļĪŻż╣ż╩ż’ż┴┼┼╬üĖ·╬©ż“╣ŌżßżķżņżļĪŻ
AMDżŽĪóźżź¾ź┐ź▌Ī╝źČż“ŠW├ōż╣żļ2.5Dż╬╬╠ŠÅźĘź╣źŲźÓż“±śŽčż╬ASEż╚▄f╣±ż╬AmkorĪ󱜎čż╬UMCż╚Č”Ų▒żŪ│½╚»żĘż┐ĪŻHBMź┴ź├źūżŽTSVżŪźĘźĻź│ź¾ż“Å──╠żĄż╗Īó╬óĀCż╦żŽź▐źżź»źĒźąź¾źūżŪ╝Īż╬HBMź┴ź├źūż“ż─ż╩ż░(┐▐2)ĪŻż│ż╬╣Įļ]żŽĪó╣Ōźąź¾ź╔╔²ż╬HBMż╚CPU/GPUż“└▄¶öż╣żļż┐żßż╬źżź¾ź┐źšź¦Ī╝ź╣ż“źĒźĖź├ź»övŽ®żŪ╣Į└«żĘĪóżĮż╬źĒźĖź├ź»ź┴ź├źūż“HBMźßźŌźĻż╬▓╝ż╦Ū█Åøż╣żļĪŻHBMżŽźżź¾ź┐ź▌Ī╝źČż“─╠żĖżŲĪóCPU/GPUż“└▄¶öż╣żļĪŻAMDżŽĪóHBMż╬║ŪĮķż╬┤░└«żĘż┐╗┼══ż╚╗Ņ║Ņēäż“▄f╣±ż╬SK Hynixż╚Č”Ų▒żŪ─Ļ▒IżĘ│½╚»żĘż┐ĪŻ
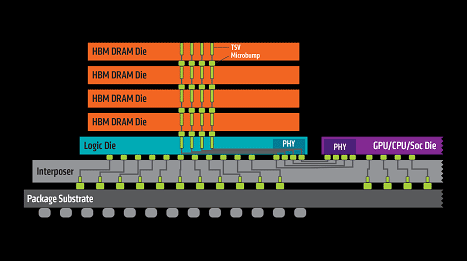
┐▐2ĪĪHBMźßźŌźĻż╚źĒźĖź├ź»ż“TSVż╚ź▐źżź»źĒźąź¾źūżŪ3╝ĪĖĄ▓ĮĪóźżź¾ź┐ź▌Ī╝źČżŪ2.5D-ICźĘź╣źŲźÓż“╣Į├█ĪĪĮąųZĪ¦AMD
HBMż╬║ŪĮjż╬źßźĻź├ź╚ż╚ż╩żļźąź¾ź╔╔²żŽĪó1024źėź├ź╚ż╚ĮjżŁż»ĪóGDDR5ż╬32źėź├ź╚ż╚╚µż┘32Ū▄żŌ╣ŁżżĪŻż▐ż┐Ī󟻟Ēź├ź»╝■āS┐¶żŽĪóGDDR5ż¼║ŪĮj1750MHzĪ╩7GbpsĪ╦ż╚ĮjżŁżżż¼ĪóHBMż╬żĮżņżŽ500MHzĪ╩1GbpsĪ╦ż╚▓╝ż▓ĪóŠ├õJ┼┼╬üż“═▐ż©żŲżżżļĪŻż│ż╬±T▓╠ĪóGDDR5żŪżŽź┴ź├źū┼÷ż┐żĻż╬źąź¾ź╔╔²żŽ28GB/sż└ż¼ĪóHBMź╣ź┐ź├ź»┼÷ż┐żĻ100GB/s░╩æųż╚ż╩żļĪŻź’ź├ź╚┼÷ż┐żĻż╬GB/sżŽĪóGDDR5ż¼10.66GB/sż╦×┤żĘżŲĪóHBMź╣ź┐ź├ź»żŪżŽ35GB/sż╦ż╩żĻ3Ū▄░╩æų┼┼╬üĖ·╬©ż¼╣Ōż▐żļĪŻ
ż▐ż┐Īóź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓż╬Š«Ę┐▓Įż╦żŌż╩żļĪŻHBMżŪżŽ4ź┴ź├źūż╬DRAMż“ź╣ź┐ź├ź»ż╣żļż╚5mmĪ▀7mmż╚Š«żĄżżż¼ĪóŲ▒żĖ1GBż╬═Ų╬╠ż““£═Ķż╬GDDR5żŪŪ█Åøż╣żļż╚Īó24mmĪ▀28mmż╚ĀC└čż“94%žōŠ»żŪżŁżļĪŻCPU/GPUź┴ź├źūż╚źßźŌźĻż“┼ļ║▄żĘż┐źūźĻź¾ź╚övŽ®┤łżŪ╚µ│ėż╣żļż╚ĪóźŌźĖźÕĪ╝źļĀC└迎╚Š╩¼░╩▓╝ż╦ż╩żļ(┐▐3)ĪŻ
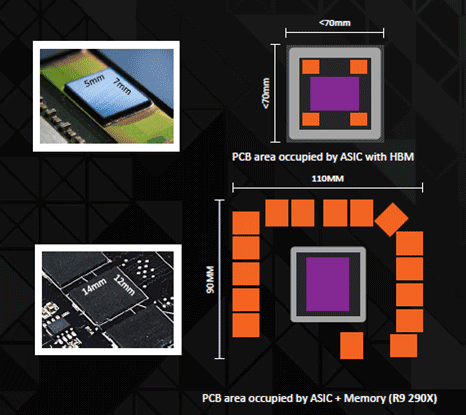
┐▐3ĪĪ┼┼╬üĖ·╬©ż╬╣Ōżż2.5DźĘź╣źŲźÓżŽŠ«Ę┐ż╦żŌż╩żļĪĪĮąųZĪ¦AMD


