3D-ICż¼źčźĮź│ź¾źņź┘źļż╦żõż├żŲżŁż┐
TSVĪ╩Through Silicon ViaĪ╦ż“╗╚żżĪóźĘźĻź│ź¾ź┴ź├źūż“└čż▀─_ż═żŲŪ█└■┼┼Č╦ż“Å──╠żĄż╗żļ3╝ĪĖĄICżŽĪóTSV╣®µćż╬ź│ź╣ź╚╣Ōż¼╠õ¼öżŪż╩ż½ż╩ż½╔ߥ┌żĘż╩ż½ż├ż┐ĪŻż│żņż▐żŪDRAMź╗źļźóźņźżź┴ź├źūż“└čż▀─_ż═ż┐3╝ĪĖĄICżŪżóżļHBMĪ╩High Bandwidth MemoryĪ╦żŽĪ󟎟żź©ź¾ź╔ż╬HPCĪ╩High Performance ComputingĪ╦╩¼╠ŅżŪżĘż½╗╚ż’żņż╩ż½ż├ż┐ĪŻżĮżņż¼źčźĮź│ź¾źņź┘źļż╦æTżĻżŲżŁż┐ĪŻ
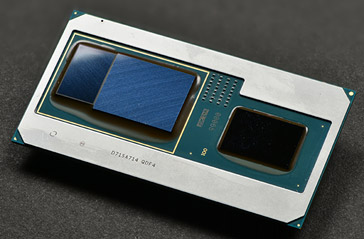
┐▐1ĪĪIntelż╬Core źūźĒź╗ź├źĄĪ╩īÜĪ╦ż╚ĪóAMDż╬GPU RadeonĪ╩├µ▒¹Ī╦Īó└č┴žżĘż┐DRAMż╬HMB 2Ī╩║ĖĪ╦ż“ĮĖ└čżĘż┐źūźĒź╗ź├źĄź▄Ī╝ź╔ĪĪĮąųZĪ¦Intel
ż│żņżŽĪóIntelż¼ĪóźčźĮź│ź¾Ė■ż▒ż╬źūźĒź╗ź├źĄżŪ║Ū┐Ęż╬ŗī8└ż┬ÕCoreźĘźĻĪ╝ź║ż╚ĪóAMDż╬ź░źķźšźŻź├ź»ź╣ź┴ź├źūĪ╩GPUĪ╦ż╬Radeon RX Vega M Graphicsż╚ĪóHBM2ż“Ų▒▐kźčź├ź▒Ī╝źĖ┤łż╦┼ļ║▄żĘż┐źūźĒź╗ź├źĄż“╚»╔ĮżĘż┐żŌż╬ĪŻIntelż¼ż½ż─żŲ╦Ī─Ņéb┴Ķż▐żŪĘ½żĻ╣Łż▓ż┐Īóż½ż─żŲż╬źķźżźąźļAMDż╬GPUż“┼ļ║▄żĘż┐ż╚żżż”ż│ż╚żŌĀCŪ“żżĪŻAMDżŽ2006ŃQż╦ź½ź╩ź└ż╬ź░źķźšźŻź├ź»ź╣╚ŠŲ│öüźßĪ╝ź½Ī╝ż╬ATI╝ęż“āA╝²żĘż┐ż│ż╚żŪGPUż“Š}ż╦Ų■żņż┐ĪŻIntelż╬źūźĒź╗ź├źĄźčź├ź▒Ī╝źĖżŽĪóDellż╚HPż╬źŌźąźżźļźčźĮź│ź¾żõŪ÷Ę┐Ę┌╬╠ż╬2-in-1źčźĮź│ź¾Ī󿥿ķż╦Intel NUCĪ╩Next Unit of ComputingĪ¦4Ī▀4źżź¾ź┴źĄźżź║ż╬Š«Ę┐PCĪ╦ż╦┼ļ║▄żĄżņżŲżżżļĪŻ
ż│ż╬źūźĒź╗ź├źĄźčź├ź▒Ī╝źĖż╦┼ļ║▄żĄżņżļHBMż╬═Ų╬╠żŽ4Gźąźżź╚Ī╩32Gźėź├ź╚Ī╦ĪŻż│żņżķ3ż─ż╬╝ń═ūź┴ź├źūż“┼ļ║▄ż╣żļźūźĻź¾ź╚övŽ®┤łżŽĪóIntelż¼EMIBĪ╩Embedded Multi-die Interconnect BridgeĪ╦ż╚Ō}żųźĘźĻź│ź¾ź┴ź├źūŲŌē┼┤łżŪżóżļĪ╩┐▐2Ī╦ĪŻż│żņżŽĪó┤łæųż╦Ū█ÅøżĘż┐GPUż╚HBMż“ŖZż┼ż▒żŲ┼ļ║▄żŪżŁżļżĶż”ż╦ż╣żļż┐żßĪóźĘźĻź│ź¾ż╬źżź¾ź┐Ī╝ź▌Ī╝źČżĶżĻżŌż║ż├ż╚Š«żĄż╩ź┴ź├źūż╦║ŲŪ█└■ż“╗▄żĘĪóżĮż╬ź┴ź├źūż“┤łż╦ļmżß╣■ż¾ż└2.5DČ\ĮčĪŻGPUż╚źßźŌźĻż╚ż╬┤ųżŪż╬╔č╚╦ż╩żõżĻŲDżĻż“╣įż”ż┐żßĪóż│ż╬╝┬äó╦ĪżŽGPUż╬▒ķōQÅ]┼┘ż“╣Ōżßżļż│ż╚ż¼żŪżŁżļĪŻż▐ż┐Īó“£═Ķż╬źĘźĻź│ź¾źżź¾ź┐Ī╝ź▌Ī╝źČżĶżĻżŌŠ«żĄż╩ĀC└čżŪ║čżÓż┐żßĪó─Ńź│ź╣ź╚żŪ╝┬äóżŪżŁżļĪŻ
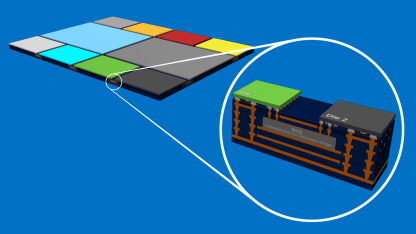
┐▐2ĪĪIntelż╬ź┴ź├źūŲŌē┼┤łEMIBČ\ĮčĪĪĮąųZĪ¦Intel
ż│żņż“źčźĮź│ź¾ż╦Ęeż├żŲżŁż┐ż╬żŽĪó“£═Ķż╩żķźŪź╣ź»ź╚ź├źūźņź┘źļżŪź▓Ī╝źÓż“│┌żĘż¾ż└żĻĪóź▓Ī╝źÓź│ź¾źŲź¾ź─ż“║Ņ└«żĘż┐żĻĪóVRĪ╩▓Š„[ĖĮ╝┬Ī╦ż╦ÕX├µżĘż┐żĻż╣żļżĶż”ż╩Īóź░źķźšźŻź├ź»ź╣ż“żšż¾ż└ż¾ż╦╗╚ż”źµĪ╝źČĪ╝ż¼ź╬Ī╝ź╚źčźĮź│ź¾żŪ│┌żĘżßżļżĶż”ż╦ż╣żļż┐żßż└ĪŻGPUżõCPUż“ĪóICźčź├ź▒Ī╝źĖżŪżŽż╩ż»▐k╚╠ż╬źūźĻź¾ź╚övŽ®┤łż╦╝┬äóżĘżŲżżż┐3ŃQż█ż╔Øiż╬źčźĮź│ź¾ż╚╚µż┘żļż╚ĪóźšźņĪ╝źÓźņĪ╝ź╚żŽ║ŪĮj3Ū▄ż╦Ė■æųżĘĪóŠ├õJ┼┼╬üżŽ╚ŠžōżĘż┐ż╚żżż”ĪŻż▐ż┐ĪóŠ«Ę┐▓Įż╦┤žżĘżŲżŽĪó║ŪĮj40%Š«żĄż»ż╩ż├ż┐ż╚żĘżŲżżżļĪŻ
╗▓╣═½@╬┴
1. New 8th Gen Intel Core Processors with Radeon RX Vega M Graphics Offer 3x Boost in Frames per Second in Devices as Thin as 17 mm (2018/01/07)


