ź└źųźļźčź┐Ī╝ź╦ź¾ź░├ōź©ź├ź┴źŃĪ╝Īó╣ŌÅ]źŲź╣ź┐Ī╝ż╩ż╔¾H══▓Įż╣żļź╗ź▀ź│ź¾JĪ╩IĪ╦
12ĘŅżŽżĖżß╦ļ─źżŪ│½ż½żņż┐ź╗ź▀ź│ź¾źĖźŃźčź¾2010żŪżŽĪóż│żņż▐żŪż╬╚∙║┘▓Į▐k╦▄²gż½żķź╣źļĪ╝źūź├ź╚ż╬▓■║¤żõ┐ĘĘ┐ź»źĻĪ╝ź¾źļĪ╝źÓż╩ż╔Īó¾H══▓Įż╣żļ╚ŠŲ│öüźūźĒź╗ź╣ż“ō■─¦ż╣żļżĶż”ż╩·t┐āēäż╦ĮjżŁż╩┤ž┐┤ż¼ĮĖż▐ż├ż┐ĪŻĮą·t╝꿎║“ŃQżĶżĻżŌžōŠ»żĘöv╔³ż¼ęÆżņżŲżŽżżżļżŌż╬ż╬Īó╚∙║┘▓ĮĪóĮjĖ²Ę┬ż╚żżż├ż┐ż│żņż▐żŪż╚ż╬░Ńżżż¼żŽż├żŁżĻĖ½ż©żļĪŻ

┐▐1ĪĪź╗ź▀ź│ź¾źĖźŃźčź¾2010▓±ŠņĪĪĮąųZĪ¦SEMI
╚ŠŲ│öü×æļ]äóÅøż╬ź╚ź├źūźßĪ╝ź½Ī╝Applied MaterialsĪ╩AMATĪ╦╝꿎Īóż│żņż▐żŪ2ŃQŽó¶ö▌xŠņźĘź¦źóż“│╚ĮjżĘżŲżŁż┐ż¼Īų2011ŃQżŽ3ŃQŽó¶ö│╚Įjż“ų`╗žż╣ĪūĪ╩źóźūźķźżź╔ź▐źŲźĻźóźļź║źĖźŃźčź¾┬Õ╔ĮŲD─∙╠“╝ę─╣ż╬┼Ž╩š┼░Ģ■Ī╦ż│ż╚żŪĪó20nm±ś╗■┬Õż╬ź└źųźļźčź┐Ī╝ź╦ź¾ź░ż╬Čč▐k└Łż“æųż▓ż┐ź©ź├ź┴źŃĪ╝żõĪóWLPĪ╩ź”ź¦Ī╝źŽźņź┘źļźčź├ź▒Ī╝źĖź¾ź░Ī╦ż╦╗╚ż”TSVż“▓├╣®ż╣żļż┐żßż╬ź©ź├ź┴źŃĪ╝ż╩ż╔Īó┐Ę×æēäż“¶öĪ╣╚»╔ĮżĘżŲżżżļĪŻż│ż╬15ź½ĘŅżŪ15¹|╬ÓżŌż╬┐ʿʿżźūźĒź╗ź╣┐Ę×æēääóÅøż“╚»╔ĮżĘżŲżŁż┐ĪŻ
żĮż╬▐kż─ĪóŪ█└■├ōż╬Ų│öüż“ź©ź├ź┴ź¾ź░ż╣żļCentris Etchż“║Żöv╚»╔ĮżĘż┐ż¼Īó┴└ż”źūźĒź╗ź╣żŽNANDźšźķź├źĘźÕżõźĒźĖź├ź»ĪóDRAMż╬▓├╣®ż╦ØŁ═ūż╩ź└źųźļźčź┐Ī╝ź╦ź¾ź░╣®µćż╬ź©ź├ź┴ź¾ź░ż“╣įż”ż│ż╚ĪŻArFźņĪ╝źČĪ╝źĻźĮź░źķźšźŻżŽĪóźĘź¾ź░źļźčź┐Ī╝ź╦ź¾ź░ż¼╗╚ż©żļż╬żŽż█ż▄40nmż»żķżżż▐żŪĪŻżĮżņ░╩▓╝ż╬╚∙║┘ż╦ż╩żļż╚║ŻżŽź└źųźļźčź┐Ī╝ź╦ź¾ź░żĘż½öĄ╦ĪżŽż╩żżĪŻEUVż╬╝┬├ō▓ĮżŽż▐ż└└ĶżŪĪó22nm░╩▓╝ż╬Øó╦Īż½żķŲ│Ų■ż¼╗Žż▐żļż╚Ė½żķżņżŲż¬żĻĪóż▐ż║żŽź│ź¾ź┐ź»ź╚ź█Ī╝źļż╬Ę┴└«ż╦╗╚ż’żņżļż╬żŪżŽż╩żżż½ż╚Ė└ż’żņżŲżżżļĪŻ
ź└źųźļźčź┐Ī╝ź╦ź¾ź░Č\Į迎╩ĖÖC─╠żĻ2öv▓├╣®żĘĪó▓├╣®ż╣żļźņźĖź╣ź╚╔²ż╚┤ų│ųż“╚ŠžōżĄż╗żļŚlż└ż½żķĪó═ūĄßżĄżņżļ▓├╣®Øó╦Ī╗@┼┘żŽČ╦żßżŲ╣Ōż»ż╩żļĪŻż│ż╬ż┐żßCDĪ╩ź»źĻźŲźŻź½źļØó╦ĪĪ╦źąźķż─żŁżŽ0.8nmżŪżóżĻĪóż│żņżŽśĘ┐pĄÕż╬1╦³╩¼ż╬1ż╬źĄźżź║ż└ż╚żżż”ĪŻżĘż½żŌĪó40nm░╩æųż╬źūźĒź╗ź╣ż╚╚µż┘żļż╚20nm±śż╬źūźĒź╗ź╣żŪżŽźčź┐Ī╝ź╦ź¾ź░├ōż╬ź©ź├ź┴ź¾ź░öv┐¶żŽDRAMżõźĒźĖź├ź»żŪżŽ10öv░╩æųĪóNANDźšźķź├źĘźÕżŪżĄż©6öv░╩æų╝{▓├żĄżņżļĪŻźąźķż─żŁż¼Ėʿʿ»ż╩żļż╚Ų▒╗■ż╦╣Ōżżź╣źļĪ╝źūź├ź╚żŌĄßżßżķżņżļĪŻ
║Żöv╚»╔ĮżĘż┐CentrisäóÅøżŽĪó“£═Ķż╬4ź┴źŃź¾źąäóÅøĪ╩3źūźĒź╗ź╣╝╝ż╚1źūźķź║ź▐ź»źĻĪ╝ź╦ź¾ź░╝╝Ī╦ż½żķ8ź┴źŃź¾źą╣Į└«Ī╩6źūźĒź╗ź╣╝╝ż╚2źūźķź║ź▐╝╝Ī╦ż╚ĮĶ═²ź┴źŃź¾źąż“╗\żõżĘź╣źļĪ╝źūź├ź╚ż“2Ū▄ż╦╗\żõżĘż┐ĪŻż│ż╬±T▓╠ĪóCOOĪ╩ź│ź╣ź╚ź¬źųź¬Ī╝ź╩Ī╝źĘź├źūĪ╦żŽ║ŪĮj30%▓╝ż¼ż├ż┐ż╚żĘżŲżżżļĪŻ
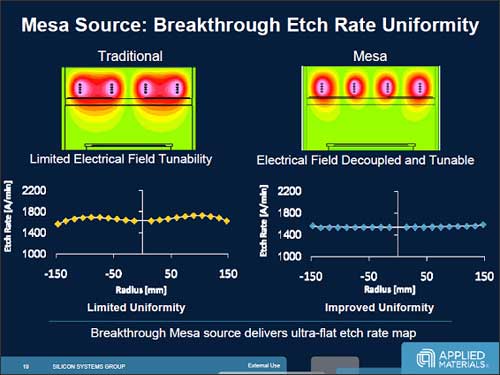
┐▐2ĪĪź”ź¦Ī╝źŽĀCŲŌż╬ź©ź├ź┴źņĪ╝ź╚żŽČč▐k(īÜ)ż└ż¼“£═Ķēä(║Ė)żŽMÖCż“ķWż»
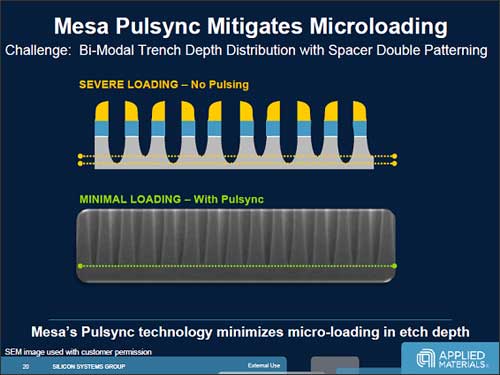
┐▐3ĪĪź▐źżź»źĒźĒĪ╝źŪźŻź¾ź░ż“žōżķż╣ż┐żßźčźļź╣żŪRFżŌźąźżźóź╣żŌŲ▒┤³żĄż╗ż┐
żĄżķż╦ĪóźūźĒź╗ź╣ź┴źŃź¾źąż╦żŽĪóŲ│└■ż“ź©ź├ź┴ź¾ź░żŪżŁżļżĶż”ż╦ż╣żļż┐żßĪ󟣟џčźĘźŲźŻźų±T╣ńżŪżŽż╩ż»Īóźżź¾ź└ź»źŲźŻźų±T╣ńż╬źūźķź║ź▐źĮĪ╝ź╣Mesaż“├ōżżż┐ĪŻż│ż╬ż▐ż▐ż└ż╚Ī󟔟¦Ī╝źŽż╬ź©ź├ź┴źņĪ╝ź╚ż¼Ų▒┐┤▀ģėXż╦MÖCż╬Ę┴ż╦żążķż─żżż┐ĪŻżĮż│żŪ║ŻövĪóźūźķź║ź▐╚»Ö┌ź│źżźļ├ō┼┼░Ąż╚Īóźżź¬ź¾ż“░·ż├─źżļż┐żßż╬źąźżźóź╣ż“źčźļź╣┼¬ż╦Ų▒┤³ż“ż╚żĻż╩ż¼żķ▓├ż©żļż│ż╚żŪź▐źżź»źĒźĒĪ╝źŪźŻź¾ź░ż╦żĶżļźąźķż─żŁż“═▐ż©Īóż█ż▄źšźķź├ź╚ż╩ź©ź├ź┴źņĪ╝ź╚ż“įużļż│ż╚ż╦└«Ė∙żĘż┐ĪŻżĄżķż╦ź¼ź╣ż╬░Ą╬üż╬źąźķż─żŁżŌ═▐ż©żļż┐żßĪóź¼ź╣░Ąż“Š’ż╦śOŲ░┼¬ż╦źŁźŃźĻźųźņĪ╝ź╚żĘż┐ĪŻż│żņż╦żĶż├żŲČč▐kż╩ź©ź├ź┴źņĪ╝ź╚ż¼╝┬ĖĮżĄżņż┐ĪŻż╣żŪż╦Īó┐Ęæäż“┤▐żÓ╣ń╝Ŗ5╝ęż╬Ė▄Ąęż“æ═įużĘż┐ż╚żżż”ĪŻ
Ö┌ź”ź¦Ī╝źŽæųż╬2nmż╬’L┤┘ż“ćĶ╗ĪżŪżŁżļäóÅø
Ö┌ż╬ź”ź¦Ī╝źŽż╬╔ĮĀCĪó╬óĀCż╚ź©ź├źĖ¤²ŖZż╬╚∙Š«ż╩’L┤┘ż“ćĶ╗ĪżŪżŁżļĖĪØhäóÅøż“Īóźšźķź¾ź╣ż╬ź┘ź¾ź┴źŃĪ╝Īóźóźļź┐źŲź├ź»ź╗ź▀ź│ź¾ź└ź»ź┐Ī╩Altatech SemiconductorĪ╦╝ęż¼│½╚»Īóź╗ź▀ź│ź¾źĖźŃźčź¾ż╦ż¬żżżŲżĮż╬Š▄║┘ż“£½żķż½ż╦żĘż┐ĪŻźčź┐Ī╝ź╦ź¾ź░żĄżņżŲżżż╩żż¬ÜĀCź”ź¦Ī╝źŽæųż╦żóżļų`ż╦Ė½ż©ż╩żż2nmµć┼┘ż╬’L┤┘ż“ĖĪĮążŪżŁżļż”ż©ż╦Īóź╣źļĪ╝źūź├ź╚żŽ100ĮŚ/╗■┤ųż╚╣ŌżżĪŻ
ż│żņż▐żŪĪó╔ĮĀCż╦źčź┐Ī╝ź¾▓├╣®żĄżņżŲżżż╩żżÖ┌ż╬ź”ź¦Ī╝źŽż“ĖĪØhż╣żļż╦żŽĪóĖ„│žĖ▓╚∙¬Üż╚┼┼╗ęĖ▓╚∙¬ÜĪ╩SEMĪ╦ż╬╬ŠöĄżŪĖ½ż╩ż▒żņżą2nmż╚żżż”╚∙║┘ż╩’L┤┘ż“ĖĪĮążŪżŁż╩ż½ż├ż┐ĪŻĖ„│žĖ▓╚∙¬ÜżŪĮj╗©Ū─ż╩ōļ░Ķż“ĖĪĮążĘĪóSEMżŪ┘ć│╬ż╦ćĶ╗Īż╣żļĪŻż│ż╬ż┐żßĪóĖĪØh╗■┤ųż¼ż½ż½ż├żŲżżż┐ĪŻ║Żövż╬öĄ╦ĪżŽ1övżŪ║čż▀żĘż½żŌź╣źļĪ╝źūź├ź╚żŽż▒ż┐░Ńżżż╦┴ßżżĪŻ
źšźķź¾ź╣ż╬STź▐źżź»źĒź©źņź»ź╚źĒź╦ź»ź╣ż╬R&Dź╗ź¾ź┐Ī╝ż╦ŖZżżź░źļź╬Ī╝źųźļ▌xż╦2004ŃQż╦└▀╬®żĄżņż┐źóźļź┐źŲź├ź»żŽĪóØŖÖzż╩źčź┐Ī╝ź¾źĖź¦ź═źņĪ╝ź┐ż“─╠żĘżŲŪ“┐¦Ė„ż“ź”ź¦Ī╝źŽż╦┼÷żŲĪó╚┐╝oĖ„ż“ĖĪĮąż╣żļĪŻ╔ĮĀCż╦ż’ż║ż½ż╩’L┤┘ż¼żóżļż╚Īóæäō¦┘ćżĘżżźčź┐Ī╝ź¾źĖź¦ź═źņĪ╝ź┐ż╬źčź┐Ī╝ź¾ż¼Ž─ż▀░╠┴Ļż¼ż║żņżļż┐żßĪó’L┤┘ż╚żĘżŲŪ¦╝▒żŪżŁżļĪŻżĮżņż“▓ĶćĄĮĶ═²żŪĪųĖ½ż©żļ▓ĮĪūż╣żļĪŻ
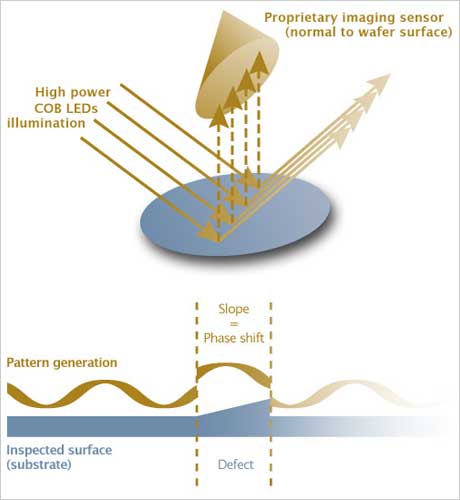
┐▐4ĪĪ╩┐┘Qż╩ĀCæųż╬’L┤┘ż“ĖĪĮąż╣żļAltaSightż╬ĖČ═²
źčź┐Ī╝ź¾źĖź¦ź═źņĪ╝ź┐ż╬źčź┐Ī╝ź¾źįź├ź┴żŽźūźĒź░źķźÓżŪżŁżļż¼ĪóĖĪĮą┤Č┼┘ż╦żŽ┤žĘĖż╗ż║ĪóżÓżĘżĒĖ„ż╬╣įŽ®ż╬─╣żĄż╦┤žĘĖż╣żļż╚ĪóŲ▒╝ę╝ę─╣ż╬źĖźŃź¾źĻźÕź├ź»Ī”źŪźļź½Ī╝źĻĪ╩Jean-Luc DelcarriĪ╦Ģ■żŽĖ└ż”ĪŻ╚┐╝oĖ„ż“ĖĪĮążĘĪóżĮżņż“┴T╠Żż╬żóżļź╚ź▌źĒźĖĪ╝ż╚żĘżŲķWż»ż┐żßż╦żŽźĮźšź╚ź”ź©źóźóźļź┤źĻź║źÓż¼ź½ź«ż╚ż╩żļĪŻ
ż│ż╬öĄ╦Īż└ż╚Ī󟔟¦Ī╝źŽ╔ĮĀCżŪżŌ╬óĀCżŪżŌ╬ŠĀCż½żķĖ„ż“┼÷żŲĖĪĮą▀_ż“╗╚ż©żąĪóŲ▒╗■ż╦ćĶ╗ĪżŪżŁżļĪŻżĘż½żŌĪóŲ®£½ż╩ź¼źķź╣ź▐ź╣ź»żõĪóźčź┐Ī╝ź╦ź¾ź░Øiż╬ź▐ź╣ź»źųźķź¾ź»ź╣ĪóSOIżõźĄźšźĪźżźõ┤łżŌĖĪØhżŪżŁżļż╚źŪźļź½Ī╝źĻĢ■żŽĖ└ż”ĪŻżĄżķż╦Ī󟔟¦Ī╝źŽŲŌŗż╦ż│ż╬µć┼┘ż╬ĮjżŁżĄż╬’L┤┘ż¼żóż├żŲżŌżĮż╬’L┤┘ż╬Ž─ż▀ż¼╔ĮĀCż╦ż▐żŪ├ŻżĘżŲżżżņżąĪóćĶ╗ĪżŪżŁżļż╚żĘżŲżżżļĪŻ


