GaN±TŠĮż½żķź”ź¦Ī╝źŽż╦ź╣źķźżź╣ż╣żļźņĪ╝źČĪ╝Č\ĮčżŪÖ┌ŠÅ└Łż“æųż▓żļ
GaNźčź’Ī╝źŪźąźżź╣ż¼ż╣żŪż╦ź╣ź▐Ī╝ź╚źšź®ź¾ż╬ŠåÅ]Į╝┼┼▀_ż╩ż╔ż╦╗╚ż’żņżŲżżżļż¼ĪóGaN±TŠĮż╬▓├╣®ż╦żŌźßź╔ż¼ż─żżż┐żĶż”ż└ĪŻSiCŲ▒══ĪóGaNźąźļź»±TŠĮżŌ╔wż»Īóźąźļź»ż╬źżź¾ź┤ź├ź╚ż½żķź”ź¦Ī╝źŽż╦ź╣źķźżź╣ż╣żļż│ż╚ż¼žMżĘż½ż├ż┐ĪŻźŪźŻź╣ź│ż¼╚µ│ė┼¬į~├▒ż╦ź╣źķźżź╣żŪżŁżļČ\Įčż“│½╚»Ī󟔟¦Ī╝źŽż╚żĘżŲ╗╚ż©żļ╝²╬╠żŌ37.5%╗\żõż╗żļż│ż╚ż¼ż’ż½ż├ż┐ĪŻ

┐▐1ĪĪźčź’Ī╝╚ŠŲ│öüźŪźąźżź╣ż╬┬č░Ąż╚ź¬ź¾°BŃ^ĪĪĮąųZĪ¦ć@Ė┼▓░Įj│ž
GaNźčź’Ī╝ź╚źķź¾źĖź╣ź┐żŽHEMTĪ╩╣Ō┼┼╗ęöĪŲ░┼┘ź╚źķź¾źĖź╣ź┐Ī╦╣Įļ]ż¼¾Hż»Īó┼┼╬«żŽź┴ź├źū╔ĮĀCż╦▐pż├żŲ▓ŻöĄĖ■ż╦╬«żņżļĪŻżĘż½żĘĪóSiC MOSFETżõSi IGBTż╬żĶż”ż╦Īóźąźļź»ż“ŠW├ōżĘżŲāeöĄĖ■ż╦┼┼╬«ż“╬«ż╣żĶż”ż╩╣Įļ]ż╦ż╣żļż╚┬č░ĄżŽ1200V░╩æųż╚żņżļæųż╦Īó┼┼╬«żŌ¾Hż»╬«ż╗żļĪŻż▐ż┐Īóźčź’Ī╝╚ŠŲ│öüż╦’Lż½ż╗ż╩żżØŖ└ŁżŪżóżļź¬ź¾°BŃ^żŽSiCżĶżĻżŌŠ«żĄż»ĪóźĒź╣ż¼Š»ż╩żżĪ╩┐▐1Ī╦ĪŻżĘż½żĘĪó±TŠĮ║ŅżĻż¼═Ų░ūżŪżŽż╩żżĪŻ’L┤┘ż¼¾Hż»ĪóżĘż½żŌ±TŠĮ└«─╣ż╦╗■┤ųż¼ż½ż½żļż½żķż└ĪŻ
GaNżŽSiC±TŠĮż╚Ų▒══ĪóĄĪ│Ż┼¬ż╦╔wżżż╚żżż”ØŖ─╣ż¼żóżĻĪó±TŠĮźųĪ╝źļĪ╩źżź¾ź┤ź├ź╚Ī╦ż½żķ╩Ż┐¶ż╬ź└źżźĘź¾ź░źĮĪ╝┐ŽżŪź”ź¦Ī╝źŽėXż╦ź╣źķźżź╣żĘżŲżżż»ż¼ĪóŪ÷ż»└┌żĻĮąż╣ż│ż╚ż¼žMżĘż½ż├ż┐ĪŻźŪźŻź╣ź│żŽĪóGaN±TŠĮźżź¾ź┤ź├ź╚ż╬╔ĮĀCż½żķŲŌŗż╦IJ┼└ż“╣ńż’ż╗ĪóźņĪ╝źČĪ╝ż“ź╣źŁźŃź¾żĘż╩ż¼żķµ£ĀCż╦Š╚╝oż╣żļöĄ╦Īż“╗╚żżĪó╔ĮĀCŗ╩¼ż“ź”ź¦Ī╝źŽż╚żĘżŲŁé▀`ż╣żļČ\Įčż“│½╚»żĘż┐Ī╩┐▐2Ī╦Ī╩╗▓╣═½@╬┴1Ī╦ĪŻŲ▒╝꿎SiC±TŠĮżŪŪ▌ż├ż┐ź”ź¦Ī╝źŽż╦└┌żĻĮąż╣KABRAż╚Ō}żųČ\ĮčĪ╩╗▓╣═½@╬┴2Ī╦ż“GaNż╦▒■├ōżĘż┐ĪŻ
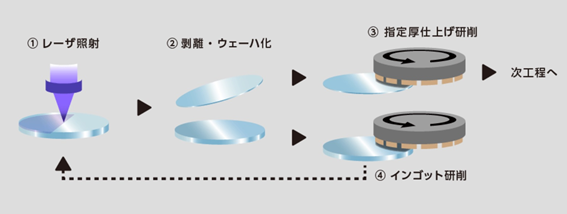
┐▐2ĪĪźŪźŻź╣ź│ż¼│½╚»żĘż┐źņĪ╝źČĪ╝Š╚╝oż╦żĶżļź”ź¦Ī╝źŽŁé▀`Č\ĮčĪĪĮąųZĪ¦źŪźŻź╣ź│
“£═Ķż╬żĶż”ż╩ź’źżźõĪ╝▓├╣®ż╦żĶżļöĄ╦ĪżŪżŽĪ󟔟¦Ī╝źŽ╔ĮĀCż╦Ė³żĄ40µmµć┼┘ż╬ż”ż═żĻż¼╚»Ö┌żĘĪóżĮżņż“Į³ĄŅż╣żļż┐żßż╦źķź├źįź¾ź░Ė”╦ßż¼ØŁ═ūż└ż├ż┐ż¼Īó║Żövż╬KABRA╦ĪżŪżŽż│ż╬źķź├źįź¾ź░Ė”╦ß╣®µćż¼żżżķż╩żżĪŻż┐ż└żĘĪóźµĪ╝źČĪ╝ż¼╗ž─Ļż╣żļĖ³żĄż╦╗┼æųż▓żļĖ”╦ßżŽØŁ═ūĪŻżĮż╬±T▓╠Īó“£═Ķż╬ź’źżźõĪ╝▓├╣®żŪżŽ8ĮŚż╬ź”ź¦Ī╝źŽżĘż½ŲDżņż╩ż½ż├ż┐źżź¾ź┤ź├ź╚ż½żķ11ĮŚŲDżņżļżĶż”ż╦ż╩żļż╚Č”ż╦Īó1╗■┤ų┼÷ż┐żĻż╬ź”ź¦Ī╝źŽÖ┌ŠÅĮŚ┐¶ż¼“£═Ķż╩żķ1ĮŚż└ż├ż┐ż╬ż¼6ĮŚ▓─ē”ż╦ż╩ż├ż┐ĪŻĖ”║’ż╦╚╝ż”║Ó╬┴ż╬Ąō╝║żŌ“£═Ķż╬100µmż½żķ60µmż╦žōż├ż┐ĪŻź”ź¦Ī╝źŽżžż╬▓├╣®╗■┤ųżŌĮj╔²ż╦žōŠ»żĘĪóź│ź╣ź╚ż“▓╝ż▓żķżņżļżĶż”ż╦ż╩żļĪŻ
ż│ż╬Č\Įčż╦┤žż╣żļØŖß׿ŽĪóĮą┤Ļ├µż“┤▐ż▀34°Pżóżļż╚ź╦źÕĪ╝ź╣źĻźĻĪ╝ź╣żŪżŽĮęż┘żŲżżżļż¼ĪóŲ▒══ż╦źņĪ╝źČĪ╝ż“├ōżżżŲGaN±TŠĮż“ź”ź¦Ī╝źŽż╦ź╣źķźżź╣ż╣żļČ\Į迎ć@Ė┼▓░Įj│ž╠ż═Ķ║Ó╬┴Ī”źĘź╣źŲźÓĖ”ē|ĮĻż╬ÜW╠Ņ╣└ČĄĶbĪó┼─├µŲžŪĘØŖŪż╣ØČĄĶbżķż╬ź░źļĪ╝źūżŪżŌ│½╚»żĘĪó2022ŃQ5ĘŅż╦╚»╔ĮżĘżŲżżżļĪ╩╗▓╣═½@╬┴3Ī╦ĪŻ
ć@Ė┼▓░Įj│žż╬ź░źļĪ╝źūżŽĪó1ĮŚż╬ź”ź¦Ī╝źŽż╦Łé▀`ż╣żļČ\Įčż╦ż─żżżŲĮęż┘żķżņżŲż¬żĻĪóźņĪ╝źČĪ╝ż“Š╚╝ożĘż┐ĖÕĪ󟔟¦Ī╝źŽż╚ż╩żļż┘żŁŗ╩¼ż╦Øaż├ż┐źŲĪ╝źūż“─╠żĘżŲܦĘe┤łżŪ╩▌ĘeżĘ░·żŁżŽż¼ż╣ż╚żżż”öĄ╦Īż“╗╚ż├żŲżżżļĪ╩┐▐3Ī╦ĪŻź”ź¦Ī╝źŽĖ³żŽ50µmµć┼┘żŪżóżļż┐żßĪ󟔟¦Ī╝źŽż╦źŪźąźżź╣ż╚ż╩żļŲ░║Ņ┴žż¼Ę┴└«żĄżņżŲżżżļŠņ╣ńżŪżŌ╗╚ż©żļĪŻ╝┬┘xżŪżŽĖ³żĄ450µmż╬ź”ź¦Ī╝źżź¾ź┤ź├ź╚ż½żķĪó50µmż╬Ė³żĄż╬ź”ź¦Ī╝źŽż╦▓├╣®żĘżŲżżżļĪŻ
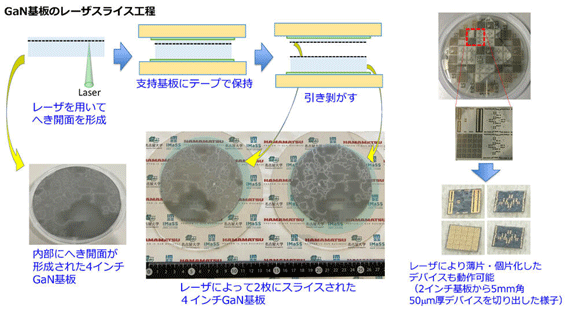
┐▐3ĪĪGaN┤łż“źņĪ╝źČĪ╝ż╦żĶż├żŲź╣źķźżź╣ż╣żļČ\ĮčĪĪĮąųZĪ¦ć@Ė┼▓░Įj│ž
╝┬żŽĪóż│ż╬Š}╦ĪżŽĪóInfineon Technologiesż¼2018ŃQ11ĘŅż╦āA╝²żĘż┐Siltectra╝ęż¼│½╚»żĘż┐Cold SplitČ\Įčż╦ō¶żŲżżżļĪ╩╗▓╣═½@╬┴4Ī╦ĪŻż│ż╬Č\Į迎ĪóĖ³żĄ350µmż╬SiCź”ź¦Ī╝źŽæųż╦źŪźąźżź╣ōļ░Ķż“║Ņż├ż┐ĖÕż╦źŪźąźżź╣ōļ░Ķ╩¼ż╬ź”ź¦Ī╝źŽż“żŽż¼ż╣Č\ĮčżŪżóżļĪŻSiCź”ź¦Ī╝źŽ╔ĮĀCæųż╦źņĪ╝źČĪ╝ż“ź╣źŁźŃź¾żĘż╩ż¼żķŠ╚╝ożĘż┐ĖÕĪ󟔟¦Ī╝źŽÜ¦Ęe├ōż╬źŲĪ╝źūż“─źżļĪŻżĮż╬ĖÕĪó╬õĄčż╣żļż╚ܦĘeźŲĪ╝źūż╦─źżĻ¤²żżż┐ŗ╩¼ż“Ī󟔟¦Ī╝źŽż╚żĘżŲ╩¼▀`żĘżŽż¼ż╣ż│ż╚ż¼żŪżŁżļĪŻź”ź¦Ī╝źŽĮŚ┐¶ż“╗\żõż╣ż│ż╚ż¼żŪżŁĪóSiCż└ż▒żŪżŽż╩ż»GaNż╦żŌ┼¼├ōżŪżŁżļż╚Įęż┘żŲżżżļĪŻ
ż│ż”żżż├ż┐Č\Į迎Ī󟔟¦Ī╝źŽż“└┌żĻĮąż╣Ė³żĄż╬┐╝żĄż╦źņĪ╝źČĪ╝ż╬IJ┼└ż“╣╩żĻĪóźņĪ╝źČĪ╝ż“ź”ź¦Ī╝źŽż╦ź╣źŁźŃź¾żĘż╩ż¼żķŠ╚╝oż╣żļż╚ĪóIJ┼└ż╬żóż├ż┐ŲŌŗż╬▓Į╣ńر╚ŠŲ│öü±TŠĮż¼ŗ╩¼┼¬ż╦╩¼▓“żĘĪ󿎿¼żņżõż╣ż»ż╩żļĪŻÄ²┼└żŽ±TŠĮŲŌŗż╦─Ļżßżļż┐żß╔ĮĀCæųż╬źŪźąźżź╣ōļ░Ķż¼Ę┴└«żĄżņżŲżżżŲżŌ╗╚ż©żļČ\ĮčżŪżóżļĪŻżŽż¼ż╣öĄ╦ĪżŽĘQ╝ęż▐ż┴ż▐ż┴ż└ż¼Īóż│ż╬Š}╦ĪżŽź”ź¦Ī╝źŽĮŚ┐¶ż“╗\żõż╗żļż┐żßĪó“£═Ķż╬öĄ╦ĪżĶżĻżŌź│ź╣ź╚ż“▓╝ż▓żļż│ż╚ż¼żŪżŁżļżĶż”ż╦ż╩żĻżĮż”ż└ĪŻ
╗▓╣═½@╬┴
1. ĪųGaNź”ź¦Ī╝źŽÖ┌ŠÅż╦║Ū┼¼ż╩KABRAźūźĒź╗ź╣ż“│½╚»ĪūĪóźŪźŻź╣ź│ (2023/07/03)
2. źŪźŻź╣ź│╝ęKABRAźūźĒź╗ź╣ż╬└Ō£½
3. ĪųźĒź╣ż╩ż»ø]╗■┤ųżŪGaN┤łźņĪ╝źČź╣źķźżź╣Č\Įčż“╚»£½ĪūĪóć@Ė┼▓░Įj│ž (2022/05/31)
4. "SILTECTRA – Innovative Splitting Technologies", Infineon


