LEAPż╬─ŃŠ├õJ┼┼╬üĪ”╔įĦ╚»└ŁźßźŌźĻżŽź╬źżź║ź▐Ī╝źĖź¾╣Łż▓Īó╣ŌĮĖ└č▓Įų`╗žż╣
Ęą║čŠÅČ╚Š╩Ī”NEDOĪ╩┐Ęź©ź═źļź«Ī╝ÄźŠÅČ╚Č\Įč┴Ē╣ń│½╚»ĄĪ╣ĮĪ╦ż¼Ü¦▐qż╣żļĪų─Ń├║┴Ū╝ę▓±ż“╝┬ĖĮż╣żļ«Ć─Ń┼┼░ĄźŪźąźżź╣źūźĒźĖź¦ź»ź╚Īūż╬└«▓╠╩¾╣▓±ż¼╣įż’żņĪó─Ń┼┼░ĄČ\Įčż╬┐╩·tż¼╚»╔ĮżĄżņż┐ĪŻĖČ╗ęźņź┘źļż╬╚∙║┘▓Įż╦ŖZż┼ż»ż╦ż─żņĪó╔įĮŃرĖČ╗ęż╬▒Ųūxż¼Ė▓├°ż╦╔ĮżņżļżĶż”ż╦ż╩ż├żŲżŁżŲżżżļĪŻŲ░║Ņ┼┼░Ąż“▓╝ż▓ĪóĖČ╗ęźņź┘źļż╦─®└’ż╣żļ╗Ņż▀ż¼ż│ż╬źūźĒźĖź¦ź»ź╚żŪżóżļĪŻIEDM2012żŪżŌ╚»╔ĮżĄżņż┐Č\ĮčżŌ┤▐żßżżż»ż─ż½Šę▓ż╣żļĪŻ
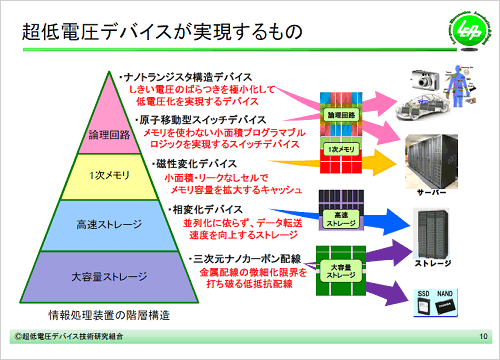
┐▐1ĪĪLEAPż¼ų`╗žż╣─ŃŠ├õJ┼┼╬üźĘź╣źŲźÓĖ■ż▒źŪźąźżź╣ĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń
╚»╔ĮżĘż┐ż╬żŽĪóż│ż╬źūźĒźĖź¦ź»ź╚ż“┐õ┐╩ż╣żļ«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ńĪó─╠Š╬LEAPżŪżóżļĪŻIEDMżŪżŽĪó╝¦└Łż“ŠW├ōż╣żļMRAMż╬Ų╔ż▀ĮążĘövŽ®ż“╣®╔ūżĘ1, 0ż╬ź▐Ī╝źĖź¾ż“╣Łż▓żļ╗Ņż▀żõĪó±TŠĮ╣Įļ]ż╬╩č▓Įż“ŠW├ōż╣żļ┴Ļ╩č▓ĮźßźŌźĻPCRAMĪóĖČ╗ęöĪŲ░ż“ŠW├ōż╣żļźūźĒź░źķź▐źųźļźŪźąźżź╣ź╗źļż╬╩▌ĘeØŖ└Łż╬▓■║¤ż╩ż╔ż╦ż─żżżŲ╚»╔ĮżĘż┐ĪŻż│ż╬žöĪóIEEE╝ń╠¢ż╬VLSI SymposiumżŪż╬└«▓╠(╗▓╣═½@╬┴1)ż½żķż╔ż╬µć┼┘┐╩▓ĮżĘż┐ż½Īóż╦IJ┼└ż“╣╩żĒż”ĪŻ
LEAPż╬Ė”ē|ż╬┴└żżżŽĪóéb═²övŽ®Īó1╝ĪźŁźŃź├źĘźÕźßźŌźĻĪó╣ŌÅ]ź╣ź╚źņĪ╝źĖĪóĮj═Ų╬╠ź╣ź╚źņĪ╝źĖż½żķ╣Į└«żĄżņżļź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓ(┐▐1)ż╦╗╚ż’żņżļ╚ŠŲ│öüźŪźąźżź╣ż╬Š├õJ┼┼╬üż“▓╝ż▓żļż│ż╚żŪżóżļĪŻź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓżŪżŽĪóŠ╩¾ż“▐k╗■┼¬ż╦°QżßżļźņźĖź╣ź┐Ī╩Ų░║ŅżŽźßźŌźĻż╚Ų▒żĖĪ╦ż¼¾H┐¶╗╚ż’żņżļż┐żßĪóLEAPżŽźßźŌźĻśO┐╚ż“╔įĦ╚»└Łż╦ż╣żļż│ż╚ż“┴└ż├żŲżżżļĪŻ╔įĦ╚»└ŁźßźŌźĻżŽ┼┼Ė╗ż“ź¬źšż╦żĘżŲżŌĄŁ▓▒ż¼╗─żļż½żķż└ĪŻżĮż╬╔įĦ╚»└ŁźßźŌźĻż╬MRAMĪó┴Ļ╩č▓ĮRAMĪóFPGAż╬└▄¶öźŪźąźżź╣ż╚ż╩żļźßźŌźĻź╗źļż╩ż╔ż╬╝┬├ō▓Įż“ų`╗žż╣ĪŻ
ż│żņżķźßźŌźĻźŪźąźżź╣ż╦Č”─╠ż╣żļż│ż╚żŽĪóźąź├ź»ź©ź¾ź╔źūźĒź╗ź╣Īóż╣ż╩ż’ż┴CMOSź╚źķź¾źĖź╣ź┐övŽ®ż“×æļ]żĘĮ¬ż©ż┐ĖÕż╬Ū█└■╣®µćż╬├µż╦źßźŌźĻźŪźąźżź╣ż“║ŅżĻ╣■żÓż│ż╚żŪżóżļĪŻ3╝ĪĖĄźßźŌźĻż╚żżż”Ę┴ż“ż╚żļż│ż╚żŪĮĖ└č┼┘ż“æųż▓żļĪŻżĘż½żŌĪóµ£żŲŠÅČ╚Č\Įč┴Ē╣ńĖ”ē|ĮĻż╦└▀ÅøżĄżņżŲżżżļ300mmź”ź¦Ī╝źŽÖ┌ŠÅźķźżź¾ż“ŠW├ōż╣żļĪŻźąź├ź»ź©ź¾ź╔źūźĒź╗ź╣ż“ŠW├ōżĘżŲ╗Ņ║ŅżĘż┐źßźŌźĻżŽ65nmCMOSźūźĒź╗ź╣ż“Į¬ż©ż┐300mmź”ź¦Ī╝źŽæųż╦Ę┴└«żĘż┐ĪŻ
MRAMżŽövŽ®ż╬╣®╔ūżŪź▐Ī╝źĖź¾│╚Įj
ż▐ż║MRAMżŪżŽĪóź╚ź¾ź═źļ└õ▒’╦ņżŪżóżļMgOż╬±TŠĮ└Łż“Ė■æųżĄż╗żļż│ż╚żŪĮ±żŁ┤╣ż©öv┐¶ż“æųż▓żļż│ż╚ż¼żŪżŁż┐ż╚6ĘŅż╦╚»╔ĮżĘż┐(╗▓╣═½@╬┴1)ĪŻżĄżķż╦MgOż╬±TŠĮ└Łż“æųż▓żļż┐żßMgO┴žż“1┴žż║ż──_ż═żŲ║ŅżļöĄ╦Īż“│½╚»żĘż┐ĪŻĮ±żŁ┤╣ż©öv┐¶żŽ0.65Vż╬źąźżźóź╣┼└żŪĪó10ż╬16ŠĶövż╚Č╦żßżŲ¾HżżĪŻż│ż╬STT-MRAMżŽMgOż“Č┤żÓäė╝¦└Łöüż╬ź╣źįź¾ż╬Ė■żŁż╦żĶż├żŲ└▄╣ńż╦Äņ─Šż╦╬«ż╣┼┼╬«├═Ī╩°BŃ^├═Ī╦ż╬ĮjżŁżĄż¼╩čż’żĻĪóżĮż╬║╣ż“1Īó0ż╚╚Į─Ļż╣żļĪŻżĘż½żĘĪó1Īó0ż╬ź▐Ī╝źĖź¾żŽČ╣żżĪŻ╬Ńż©żąĪó0ż╬°BŃ^├═ż¼1.7k”ĖżŪĪó1ż╬żĮżņż¼2.8k”Ėż╚2Ū▄µć┼┘żĘż½ż╩żżĪ╩┐▐2Ī╦ĪŻ
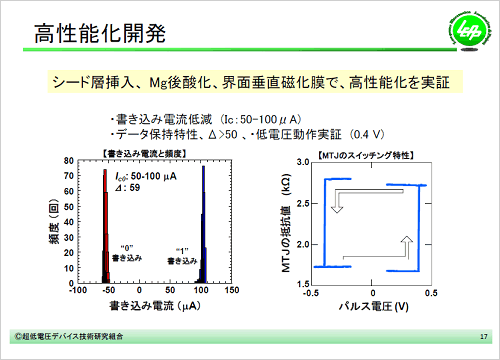
┐▐2ĪĪSTT-MRAMż╬°BŃ^├═ź▐Ī╝źĖź¾żŽŠ»ż╩żżĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń
╣ŌĮĖ└čźßźŌźĻż“ų`╗žż╣ż┐żßż╦żŽĪóż│ż╬°BŃ^├═¾HŠ»żążķż─żżżŲżŌŲ░║Ņż╣żļżĶż”ż╦1Īó0ż╬ź▐Ī╝źĖź¾ż“Ø▓╩¼ż╚żķż╩ż»żŲżŽż╩żķż╩żżĪŻżĮż│żŪźßźŌźĻź╗źļ1Ė─ż╬Ų░║Ņź▐Ī╝źĖź¾ż“╣Łż▓żļż┐żßż╦övŽ®└▀╝Ŗż“┐└Ė═Įj│žĪó╬®╠┐┤█Įj│žż╦░══ĻżĘż┐ĪŻØŖż╦ĪóŲ░║Ņź▐Ī╝źĖź¾ż“╣Łż▓żļż┐żßż╦┐└Ė═Įj│žżŽ─Ń┼┼░ĄżŪżŌŲ░║Ņż╣żļŲ╔ż▀ĮążĘövŽ®ż“│½╚»żĘż┐ĪŻż│żņżŽČ╣żż┼┼╬«├═Ī╩°BŃ^├═Ī╦ż╬║╣ż“┼┼░Ą├═ż╦╩č┤╣ż╣żļövŽ®żŪżóżļĪŻŲ╔ż▀ĮążĘövŽ®ż╦└▀ż▒ż┐pź┴źŃź¾ź═źļMOSż╬┤łźąźżźóź╣┼┼░Ąż“─┤┼Dż╣żļż│ż╚żŪ╔ķ└Ł°BŃ^övŽ®Ī╩┐▐3Ī╦ż“╣Į└«ż╣żļĪŻż│ż╬övŽ®ż╦żĶż├żŲĪóŲ╔ż▀ĮążĘ╔ķ▓┘┼┼░Ąż“1ż╬Šņ╣ńż╚0ż╬Šņ╣ńż╚żŪĮjżŁż»╣Łż▓ż┐ĪŻ╝┬┘xżŪżŽĪó┼┼╬«├═ż╬ĮjżŁż╩ėX▌åż“0.08VĪ╩║ĖŖõż╬┤▌░§Ī╦Īó┼┼╬«├═ż╬Š«żĄż╩ėX▌åż“0.38V(īÜŖõż╬┤▌░§)ż╚żĮż╬║╣ż“╣Łż▓żļż│ż╚ż¼żŪżŁż┐ĪŻ
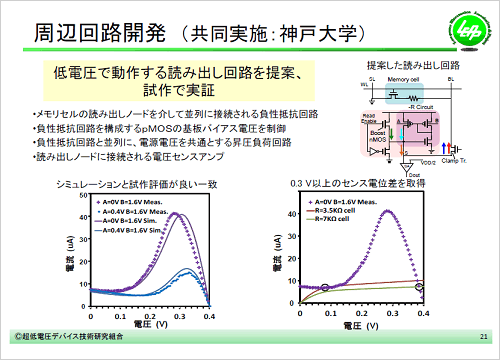
┐▐3ĪĪ°BŃ^├═ż╬Š«żĄż╩║╣ż“╔ķ└Ł°BŃ^övŽ®żŪ┼┼░Ąż╦╩č┤╣Īó│╚─źżĘż┐ĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń
ż┐ż└żĘ╠õ¼öżŽĪópMOSż╬┤łźąźżźóź╣┼┼░Ąż╬─┤┼Dż¼╚∙öéżŪĪó╔ķ▓┘ż╚ż╩żļ╔ķ└Ł°BŃ^Č╩└■ż¼┤łźąźżźóź╣ż╦żĶż├żŲĮjżŁż»╩čż’ż├żŲżĘż▐ż”ż│ż╚ż└ĪŻźßźŌźĻź╗źļ┐¶ż“╗\żõżĘż┐╗■ż╦╔ķ└Ł°BŃ^Č╩└■ż╬źąźķż─żŁż╦żĶż├żŲĪóŲ░║Ņ┼└ż¼ĮjżŁż»╩č▓Įż╣żļČ▓żņż¼żóżļĪŻż│ż╬ż┐żßź╗źļ┐¶ż“╗\żõż╣Īóż╣ż╩ż’ż┴╣ŌĮĖ└č▓Įż╣żļ╗■ż╬źąźķż─żŁż“ż╔ż╬żĶż”ż╦żĘżŲžōżķż╣ż½ĪóżóżļżżżŽżĮż╬źąźķż─żŁż“ż╔ż╬żĶż”ż╦żĘżŲĄ█╝²ż╣żļż½ĪóżĮż╬×┤║÷ż“Ė½ż─ż▒żļØŁ═ūż¼ĮążŲż»żļĪŻĖĮ║▀żŽ4Mźėź├ź╚ż╬źßźŌźĻź▐ź»źĒż“TEGż╚żĘżŲ└▀╝Ŗ├µżŪżóżļĪŻ
±TŠĮA-±TŠĮBż╬╔ÅöĪż“ŠW├ōż╣żļ┴Ļ╩č▓ĮźßźŌźĻ
┴Ļ╩č▓ĮźßźŌźĻżŽĪó“£═Ķź½źļź│ź▓ź╩źżź╔ÅUż╬GeSbTe║Ó╬┴ż“ź┘Ī╝ź╣ż╦żĘż┐│½╚»ż¼¾Hż½ż├ż┐ĪŻ±TŠĮż╚ØÖ±TŠĮż╬ėX▌åż“╔ÅöĪż╣żļż│ż╚żŪź½źļź│ź▓ź╩źżź╔°BŃ^├═ż╬╩č▓Įż“1Īó0ż╦×┤▒■żĄż╗żŲżżż┐ĪŻ║ŻövĪóLEAPżŽ±TŠĮėX▌åAó╬±TŠĮėX▌åBż╚żżż”╔ÅöĪėX▌åż“╣Ō°BŃ^Ī╩1Ī╦Īó─Ń°BŃ^Ī╩0Ī╦ż╦×┤▒■żĄż╗żļĪ╩┐▐4Ī╦ż│ż╚żŪĪó─Ń°BŃ^ż╚╣Ō°BŃ^ż╬ėX▌åż“300Ū▄żŌ╩čż©żļż│ż╚ż¼żŪżŁż┐Ī╩┐▐5Ī╦æųż╦Īóź╗ź├ź╚/źĻź╗ź├ź╚┼┼░Ąż““£═Ķż╬1.3V/1.5Vż½żķČ”ż╦1V/1Vżžż╚▓╝ż▓żļż│ż╚ż¼żŪżŁż┐ĪŻź╗ź├ź╚/źĻź╗ź├ź╚┼┼░Ąż╬źčźļź╣╔²ż“╩čż©żļż│ż╚żŪ┼┼╬«├═ż“╩čż©żļż¼Īóź╗ź├ź╚┼┼╬«żŽ“£═Ķ╚µ1/30ż╬60”╠AĪóźĻź╗ź├ź╚┼┼╬«żŽ“£═Ķż╬╚Š╩¼ż╬1mAż╚▓╝ż¼ż├ż┐ĪŻż│ż╬±T▓╠Ī󊻿╩żżź©ź═źļź«Ī╝Īóż╣ż╩ż’ż┴─ŃŠ├õJ┼┼╬üĪ”╣ŌÅ]żŪ┴Ļ╩č▓ĮżĄż╗żļż│ż╚ż¼żŪżŁż┐ĪŻ
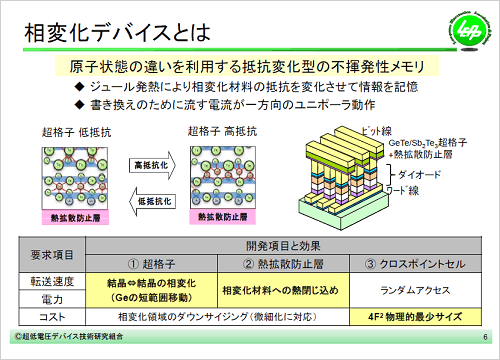
┐▐4ĪĪ«Ć│╩╗ę±TŠĮ┤ųż╬±T╣ńėX▌åż╬░ŃżżżŪ─Ń°BŃ^Ī”╣Ō°BŃ^ż“Ö┌żÓĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń

┐▐5ĪĪ1Īó0ż╬║╣ż¼300Ū▄ż╚ź▐Ī╝źĖź¾żŽ╣ŁżżĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń
Ų¾ż─ż╬±TŠĮėX▌åż“║ŅżĻĮąż╣ż┐żßż╦GeTe/Sb2Te3«Ć│╩╗ę╣Įļ]ż“Ę┴└«żĘż┐ĪŻ«Ć│╩╗ę╣Įļ]ż╬GeTe┴žż╚Sb2Te3┴žż“GeĖČ╗ęż¼╣įżŁ═Ķż╣żļż│ż╚żŪ°BŃ^├═ż“╩čż©żļż╚żżż”żŌż╬żŪĪóČ”ż╦±TŠĮżŪżóżļż┐żß╣įżŁ═Ķż╣żļź©ź═źļź«Ī╝ż¼Š»ż╩ż»żŲżŌ║čżÓĪŻ▓├ż©żŲĪ󊻿╩żż┼┼╬«żŪÖ┌żĖż┐ÕXż“Ń~Ė·ż╦╗╚ż”ż┐żßż╦ÕX│╚Üg╦╔┘V┴žżŌŲ│Ų■żĘż┐ĪŻ
żĄżķż╦ĪóźßźŌźĻź╗źļż“┬ō┘Iż╣żļźŪźąźżź╣ż╚żĘżŲpinź└źżź¬Ī╝ź╔ż“┬ō┘IżĘż┐ĪŻż│żņżŽź╗ź├ź╚/źĻź╗ź├ź╚┼┼░ĄČ”ż╦źūźķź╣ż╬źčźļź╣ż“╗╚ż”ż│ż╚ż╚Īóāeż╬Ū█└■öĄĖ■ż╦ĮĖ└čżŪżŁżļż½żķż└ĪŻźėź├ź╚└■ż╚ź’Ī╝ź╔└■ż╬ź▐ź╚źĻź»ź╣ż╬źķźżź¾ż“źóź»źŲźŻźųż╦ż╣żļż│ż╚żŪź└źżź¬Ī╝ź╔ż¬żĶżė─Šš`└▄¶öżĄżņż┐źßźŌźĻź╗źļż“┬ō┘Iż╣żļż│ż╚ż¼żŪżŁĪóźßźŌźĻź▐ź╚źĻź»ź╣övŽ®ż“į~ŠS▓ĮżŪżŁżļĪŻ
FPGAż╬źßźŌźĻŗ╩¼ż“ŖW─Ļ▓Į
FPGAźĒźĖź├ź»źŪźąźżź╣ż╦ØŁ═ūż╩éb═²└▄¶ö├ōż╬ź╣źżź├ź┴ż╚żĘżŲĪó“£═ĶżŽSRAMż“╗╚ż├żŲżżż┐ĪŻSRAMżŽ┤╦▄┼¬ż╦źšźĻź├źūźšźĒź├źū╣Įļ]ż“║╬żļż┐żßĪó╣ŌÅ]ż└ż¼ĀC└čż¼ĮjżŁżżĪŻLEAPżŽSRAMż╬┬Õż’żĻż╦ĖČ╗ęöĪŲ░ź╣źżź├ź┴ż“│½╚»żĘżŲżżżļĪŻż│żņżŽ╗▓╣═½@╬┴1żŪŠę▓żĘż┐żĶż”ż╦ĪóRu┼┼Č╦ż╚Cu┼┼Č╦żŪżŽżĄż▐żņż┐╔wöü┼┼▓“䮿╬├µż“┼┼Č╦ż½żķCuźżź¬ź¾ż“öĪŲ░żĄż╗Īó┼┼Č╦┤ųż“ż─ż╩żżżŪżĘż▐ż¬ż”ż╚żżż”╚»„[ż└ĪŻ║ŻövżŽĪóź╗ź├ź╚/źĻź╗ź├ź╚┼┼░Ąż“Čč▐kż╦öUĖµżŪżŁżļČ\Įčż“│╬╬®żĘż┐ż┐żßĪó3Ī▀3ż╬źĒźĖź├ź»ź╗źļż“╗Ņ║ŅżĘż┐ĪŻż┴ż╩ż▀ż╦ź╣źżź├ź┴ż╬żĘżŁżż┼┼░ĄżŽĪó1024Ė─ż╬ź╣źżź├ź┴ż“╗Ņ║ŅżĘĪó├µ▒¹├═1.8VżŪ║YØŹ╩ą║╣ż¼0.2Vż╚żżż”±T▓╠ż└ż├ż┐ĪŻź¬ź¾/ź¬źš╗■ż╬┼┼╬«├═żŽż█ż▄4.5ĘÕż╚żżż”Ø▓╩¼ż╩║╣ż¼żóżļĪŻ
ĖČ╗ęöĪŲ░ź╣źżź├ź┴żŽĪó1000övµć┼┘ż╬Į±żŁ┤╣ż©öv┐¶ż¼įużķżņżŲżżżļż¼ĪóźĒźĖź├ź»źŪźąźżź╣ż╚żĘżŲżŽØ▓╩¼ż╩öv┐¶żŪżóżļĪŻż┐ż└żĘĪóĄŁ▓▒żĘ¶öż▒żļ╩▌ĘeØŖ└ŁżŌ│╬╩▌żĘżŲżżż»ØŁ═ūż¼żóżļĪŻØŖż╦ź¬ź¾ėX▌åżŪCuĖČ╗ęż¼ż─ż╩ż¼ż├żŲżżżļėX▌åż¼╩°żņżŲżżż▒żą╬¶▓Įż╣żļż┐żßĪóżĮż╬×┤║÷ż╚żĘżŲCu┼┼Č╦ż╚Ru┼┼Č╦ż“Č”ż╦╣ńČŌ▓ĮżĘĪóÕX┼¬ŖW─Ļ└Łż╚Cuż╬│╚ÜgźąźĻźõż“└▀ż▒ż┐ĪŻRu┼┼Č╦żŽTaż╚╣ńČŌ▓ĮżĘż┐Ī╩┐▐6Ī╦ĪŻ
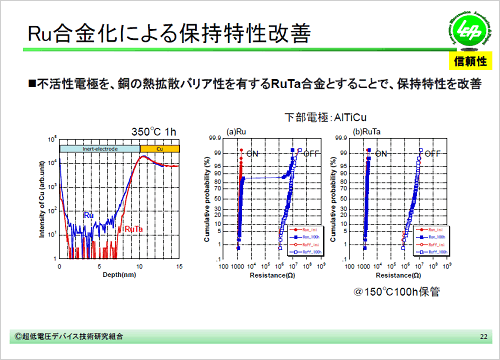
┐▐6ĪĪRu╣ńČŌ▓ĮżŪźąźķż─żŁż“─ŃžōĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń
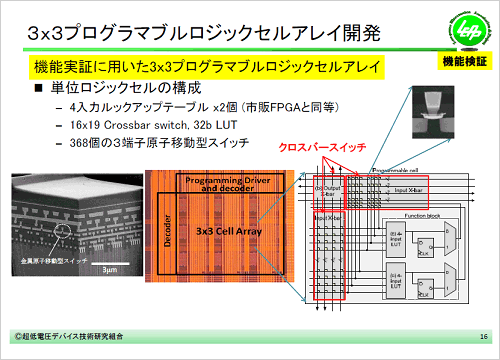
┐▐7ĪĪźļź├ź»źóź├źūźŲĪ╝źųźļż“ĮĖ└čżĘż┐źĒźĖź├ź»ź╗źļźóźņźżĪĪĮąųZĪ¦«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ń
├▒░╠źĒźĖź├ź»ź╗źļźóźņźżĪ╩┐▐7Ī╦ż╦żŽĪó4Ų■╬ü32źėź├ź╚ż╬źļź├ź»źóź├źūźŲĪ╝źųźļĪ╩LUTĪ╦ż“2Ė─Īó16Ī▀19ż╬Ų■╬üż¬żĶżėĮą╬üź»źĒź╣źąĪ╝ź╣źżź├ź┴ĪóDĘ┐źšźĻź├źūźšźĒź├źū2Ė─ż╩ż╔ż“ĮĖ└čżĘżŲż¬żĻĪóĖČ╗ęöĪŲ░ź╣źżź├ź┴żŽ368Ė─┤▐ż▐żņżŲżżżļĪŻż│ż╬├▒░╠źĒźĖź├ź»ź╗źļż“3Ī▀3ż╬ź▐ź╚źĻź»ź╣źóźņźż╣Į└«ż╦żĘĪ󿥿ķż╦ź╗źļż“źóź╔źņź╣ż╣żļż┐żßż╬źŪź│Ī╝ź└żõź╔źķźżźąż“żĮżņżŠżņXĪóYż╦Ū█ÅøżĘĪóŲ░║Ņż“ĖĪŠ┌żĘż┐ĪŻ
żĄżķż╦6Ī▀6╣Į└«ż╬źĒźĖź├ź»ź╗źļźóźņźżż╬źņźżźóź”ź╚ż“ĖĪŲżżĘżŲż¬żĻĪóTEGźņź┘źļżŪSRAMż╚╚µż┘68%ĀC└č║’žōĖ·▓╠ż“│╬Ū¦żĘżŲżżżļĪŻ║ŻĖÕżŽ╝┬║▌ż╦╗Ņ║ŅżĘĪóżĮż╬Ė·▓╠ż“ĖĪŠ┌ż╣żļĪŻ
╗▓╣═½@╬┴
1. LEAPĪóLSIŠ├õJ┼┼╬ü║’žōż╬ż┐żßMOSż╬Ł∙Vt║’žōĪó╔įĦ╚»└ŁźßźŌźĻż╦╬ü┼└ (2012/06/15)


