źżź¾źšźŻź╦ź¬ź¾Īóź½Ī╝ź©źņ├ōźčź’Ī╝╚ŠŲ│öüż╬┐Ęźčź├ź▒Ī╝źĖČ\Įčż“£½żķż½ż╦
ź½Ī╝ź©źņź»ź╚źĒź╦ź»ź╣ż╦┼ļ║▄ż╣żļźčź’Ī╝MOSFETż“źĻĪ╝ź╔źņź╣źčź├ź▒Ī╝źĖż╦╝²═ŲżĘżŲżŌ200Aż“╬«ż╣ż│ż╚ż╬żŪżŁżļ╝┬äóČ\Įčż“Īóźżź¾źšźŻź╦ź¬ź¾ż¼£½żķż½ż╦żĘż┐ĪŻż│żņż▐żŪż╬D2PAKĘ┐źčź├ź▒Ī╝źĖżŪżŽ180Aż¼║ŪĮj┼┼╬«ż└ż├ż┐ż¼Īó┐Ę│½╚»ż╬TO-LL╔ĮĀC╝┬äóĘ┐źčź├ź▒Ī╝źĖżŽ200Aż▐żŪ╬«ż╗żļż│ż╚żŪĪóźżź¾źąĪ╝ź┐ż╬Š«Ę┐▓Įż╦ż─ż╩ż¼żļĪŻ

┐▐1ĪĪInfineon╝ęPackage Concept & Definitionŗ╠ńźĘź╦źóź╣ź┐ź├źšź╣ź┌źĘźŃźĻź╣ź╚ż╬Stefan MacheinerĢ■
Īųź½Ī╝ź©źņż╬╩¼╠ŅżŪżŽĪó1ppmĪ╩100╦³╩¼ż╬▐kĪ╦ż╬╔į╬╔╬©żŪżĄż©╔įØ▓╩¼ĪŻĖ┬żĻż╩ż»ź╝źĒż╦żĘż╩ż»żŲżŽż╩żķż╩żżĪŻ╚ŠŲ│öüż╬╔į╬╔╬©ż¼1ppmżŪżŌĪ󟻟ļź▐ż╦╗╚ż’żņżŲżżżļ╚ŠŲ│öüżŽ1╦³5000Ė─Ī╩╩┐ČčĪ╦żŌżóżļż½żķĪ󟻟ļź▐ż╬╔į╬╔╬©żŽ1.5%ż╦żŌ┴Ļ┼÷ż╣żļż│ż╚ż╦ż╩żļĪŻż└ż½żķēä䮿¼ŗī▐kĪūż╚źżź¾źšźŻź╦ź¬ź¾źŲź»ź╬źĒźĖĪ╝ź║Ī╩Infineon TechnologiesĪ╦ż╬Package Concept & Definitionŗ╠ńźĘź╦źóź╣ź┐ź├źšź╣ź┌źĘźŃźĻź╣ź╚ż╬Stefan MacheinerĢ■Ī╩┐▐1Ī╦żŽĖ└ż”ĪŻź»źļź▐ż“Ė╬ŠŃż╩ż»Ų░║ŅżĄż╗żļż┐żßĪó┬čĄū└Łż╬╣Ōżżźčź├ź▒Ī╝źĖČ\Įčż¼ĄßżßżķżņżļĪŻ
ECUĪ╩┼┼╗ęöUĖµźµź╦ź├ź╚Ī╦ŲŌż╬övŽ®┤łæųż╦╝┬ä󿥿ņż┐╚ŠŲ│öü×æē俎Īó┼┼Ąż┼¬ż╦ĪóżĘż½żŌÕX┼¬ż╦żŌżŁż├ż┴żĻż╚└▄¶öżĄżņżŲżżż╩ż▒żņżąż╩żķż╩żżĪŻĖ╬ŠŃż╦╗ĻżļĖČ░°ż“ż▐ż╚żßżļż╚Īó░╩▓╝ż╬żĶż”ż╦ż╩żļĪ©
Ī”źŌĪ╝źļź╔ż╚ź┴ź├źū─cĀCż╬Łéż¼żņ
Ī”źßź┐źļż╬╩čĘ┴
Ī”ź┴ź├źūż╬ź»źķź├ź»
Ī”ź▄ź¾źŪźŻź¾ź░ź’źżźõż╬Łéż¼żņ
Ī”ź┴ź├źūż╬Łéż¼żņżõź▄źżź╔ż╩ż╔
Ī”źčź├ź▒Ī╝źĖż╬ź»źķź├ź»
Ī”źŽź¾ź└ŗż╬ź»źķź├ź»
Ī”╔įØ▓╩¼ż╩▀wżņ└Ł
Ī”ź”źŻź╣ź½Ī╝ż╬└«─╣
Ī”źŌĪ╝źļź╔ż╚ź└źżźčź├ź╔ż╚ż╬Łéż¼żņ
Ī”źčźĘź┘Ī╝źĘźńź¾╦ņż╬ź»źķź├ź»
źčź’Ī╝╚ŠŲ│öüżŪżŽĮj┼┼╬«ż“╬«ż╣ż│ż╚żŪča┼┘ż¼æųż¼żļż┐żßĪóÕXż“żżż½ż╦Ų©ż¼ż╣ż½ż╚żżż”ż│ż╚żŌĮjżŁż╩╠õ¼öż╚ż╩żļĪŻ┼┼Ąż°BŃ^ż╚ÕX°BŃ^ż“žōżķż╣ż╚Č”ż╦Īó╣Ōčaż╚─Ńčaż╬Ę½żĻ╩ųżĘż╦żŌ┬čż©żļżĶż”ż╩║Ó╬┴żõ└▄╣ńČ\ĮčżŌĄßżßżķżņżļĪŻżĘż½żŌź│ź╣ź╚ż“æųż▓ż╩żżĪŻż│ż╬ż┐żßż╦ÕX┼┴Ų│╬©ż╬╣Ōż»ĪóÕX╦──źĘĖ┐¶ż¼źĘźĻź│ź¾ż╦ŖZżż║Ó╬┴ż“╗╚ż”Īóż╚żżż├ż┐Č\Įčż¼┤╦▄ż╚ż╩żļĪŻ
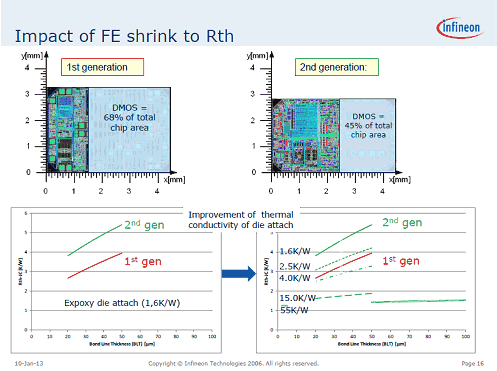
┐▐2ĪĪźčź’Ī╝ICżŪżŽźčź’Ī╝ź╚źķź¾źĖź╣ź┐ŗ╩¼ż╬ĀC└čż¼žōŠ»ż╣żļĪĪ┬Šż╬övŽ®ż╦¾Hż»ż╬ĄĪē”ż“ĮĖ└čż╣żļż┐żßż└ ĮąųZĪ¦Infineon Technologies
ØŖż╦źčź’Ī╝ICżŪżŽĪóźčź’Ī╝MOSFETżŪżóżļDMOSŗ╩¼ż╬ĀC└迎Č\Įčż╬┐╩▓Įż╚Č”ż╦ź┴ź├źūµ£öüż╦×┤ż╣żļ│õ╣ńż¼žōŠ»żĘżŲżżż»ż╚żżż”ĪŻżóżļźčź’Ī╝ICź┴ź├źūżŪżŽDMOSŗ╩¼ż¼68%ż└ż├ż┐ż¼Īóŗī2└ż┬Õż╬ź┴ź├źūżŪżŽ45%ż╦žōżļż╚żĘżŲżżżļ(┐▐2)ĪŻżŌż┴żĒż¾Īóźčź’Ī╝ź╚źķź¾źĖź╣ź┐ŗ╩¼ż╬ĀC└čż¼žōżļż╚ÕX°BŃ^ż¼æųż¼żļż│ż╚ż╦ż─ż╩ż¼żļĪŻż│ż╬ż┐żßź└źżź▄ź¾źŪźŻź¾ź░║Ó╬┴ż“Ū÷ż»żĘÕX°BŃ^ż“▓╝ż▓żļż╚Č”ż╦ĪóÕX°BŃ^ż╬─Ńżż║Ó╬┴ż╦ü÷ż©żŲżżż»ĪŻ
║Ó╬┴Ńt▌öż╬▐kż─ż╚żĘżŲĪóČõź╩ź╬ŠĢ╗ęź┌Ī╝ź╣ź╚ż¼żóżļĪŻ│╚Ügż“ŠW├ōż╣żļźŽź¾ź└żõĪóZnĪ╩░Ī×lĪ╦ź┘Ī╝ź╣ż╬źŽź¾ź└ż╩ż╔ż╬ź└źżź▄ź¾źŪźŻź¾ź░║Ó╬┴ż╚╚µż┘ĪóÕX┼┴Ų│╬©ż¼2Ū▄░╩æų╣Ōżż(┐▐3)ĪŻPb(×l)ź┘Ī╝ź╣ż╬źŽź¾ź└żŽĪó▓żä”ż╬┤─ČŁæäöUROHS╗ž╬ßż╬ż┐żßżŌżŽżõ╗╚ż©ż╩żżĪŻ“£═Ķż╬Čõź┌Ī╝ź╣ź╚żŽź©ź▌źŁźĘ█`╗ķż╦═Žż½żĘż┐żŌż╬ż└ż¼ĪóČõź╩ź╬ŠĢ╗ęź┌Ī╝ź╣ź╚żŽźßź┐źļż“─Š└▄źĘź¾ź┐źĻź¾ź░żŪ└▄╣ńżĄż╗żļČ\Įčż└ż╚żżż”ĪŻż┐ż└żĘĪóż▐ż└│½╚»├µż╬żĶż”ż└ĪŻ
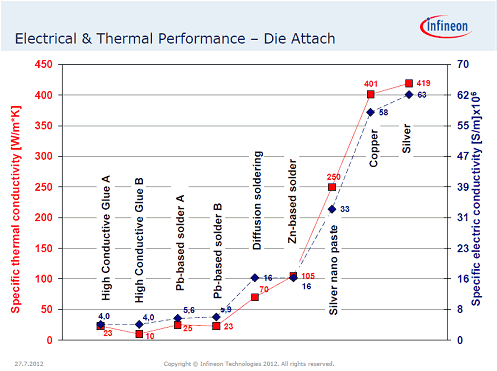
┐▐3ĪĪĘQ¹|ź└źżź▄ź¾źŪźŻź¾ź░Č\ĮčĪĪĮąųZĪ¦Infineon Technologies
│½╚»żĘż┐źčź├ź▒Ī╝źĖTO-LLĪ╩źĻĪ╝ź╔źņź╣Ī╦żŪżŽĪóź▄ź¾źŪźŻź¾ź░ź’źżźõż“└▄¶öż╣żļźĻĪ╝ź╔źšźņĪ╝źÓż╬╣ŌżĄż“ź┴ź├źū╔ĮĀCż╬╣ŌżĄż╦ŖZż┼ż▒ĪóŽčČ╩ŗż“ø]ż»żĘż┐(┐▐4)ĪŻż│żņż╦żĶżĻĪóź’źżźõżĮż╬żŌż╬ż¼ø]ż»ż╩żļż╚Č”ż╦źżź¾ź└ź»ź┐ź¾ź╣żŌžōżļż┐żßĪóżĶżĻ╣ŌÅ]ż╬Ų░║Ņż¼▓─ē”ż╦ż╩żļĪŻż▐ż┐Īó╝²═Ųż╣żļźčź’Ī╝MOSFETż╬źĮĪ╝ź╣ŗż╬ź’źżźõ┐¶ż““£═Ķż╬4╦▄ż½żķ5╦▄ż╦╗\żõżĘż┐ĪŻż│ż╬ż│ż╚żŪÕX°BŃ^ż“žōżķż╗żļż╚Č”ż╦źżź¾ź└ź»ź┐ź¾ź╣żŌžōżķż╗żļĪŻÕX°BŃ^żŽ30%žōŠ»żĘĪó─Ļ│╩┼┼╬«ż“50%╗\żõż╣ż│ż╚ż¼żŪżŁżļż╚żĘżŲżżżļĪŻ
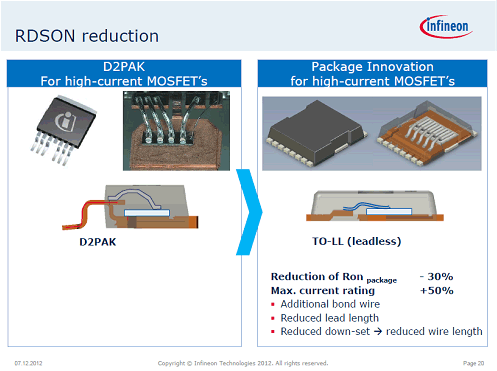
┐▐4ĪĪ│½╚»żĘż┐TO-LLźčź’Ī╝źŪźąźżź╣├ōźčź├ź▒Ī╝źĖĪĪĮąųZĪ¦Infineon Technologies
źżź¾źšźŻź╦ź¬ź¾żŽĪóż│ż╬źĻĪ╝ź╔źņź╣źčź├ź▒Ī╝źĖż“źūźĻź¾ź╚┤łż╦╝┬äóż╣żļŠņ╣ńż╬źŽź¾ź└ż╬źšźŻźņź├ź╚Ę┴└«ż╦ż─żżżŲżŌĖĪŲżżĘżŲżżżļĪŻØŖż╦▓╝├Žż╬źßź┐źļ├╝╗ęż╚źĻĪ╝ź╔źßź┐źļż╬▀wżņ└Łż“╬╔ż»ż╣żļżĶż”ż╦źŽź¾ź└ż“Ę┴└«żĘż╩ż▒żņżąĪ󟻟ķź├ź»ż¼Ų■ż├ż┐żĻŁéż¼żņż┐żĻż╣żļĪŻØŖż╦śOŲ░┘ZźßĪ╝ź½Ī╝ż½żķźŽź¾ź└ż╬▀wżņ└ŁĖĪØhż╬═ūĄßż¼äėżżĪŻźŽź¾ź└ż╬▀wżņ└Łż“ĖĪØhż╣żļöĄ╦Īż╚żĘżŲX└■ż“╗╚ż”öĄ╦ĪżŽ│╬╬®żĘżŲżżżļż¼Īóźżź¾źšźŻź╦ź¬ź¾żŽĖ„│žź½źßźķż“╗╚ż├ż┐śOŲ░ĖĪØhźĘź╣źŲźÓż“│½╚»Īó╝┬├ō▓ĮżĘ╗ŽżßżŲżżżļż╚żĘżŲżżżļĪŻ
Įø═Ķż╬SiCżõGaNż╩ż╔ż╬źčź’Ī╝╚ŠŲ│öüż╬╝┬äóöĄ╦ĪżŌĖ”ē|żĘżŲżżżļĪŻź└źżź▄ź¾źŪźŻź¾ź░╦Īżõ╬ŠĀC╬õĄčČ\ĮčĪóźßź┐źļĖ³żĄż╬║Ū┼¼▓Įż╩ż╔ż╦ż─żżżŲĖĪŲż├µż╚żĘżŲżżżļĪŻ


