┐└Ė═Įj/ASETĪó4096Ė─ż╬TSVż“▓żĘżŲ3D└č┴žIC╗Ņ║ŅĪó100GB/sż╬Å]┼┘ż“╝┬Š┌
┐└Ė═Įj│žż╚«Ć└Ķ├╝┼┼╗ęČ\Įč│½╚»ĄĪ╣ĮĪ╩ASETĪ╦żŽČ”Ų▒żŪĪó4096╦▄ż╬TSVźąź╣ż“Ęeż─źżź¾ź┐Ī╝ź▌Ī╝źČż“▓żĘżŲĪóźßźŌźĻź┴ź├źūż╚źĒźĖź├ź»ź┴ź├źūż“└č┴žżĘż┐3╝ĪĖĄICż“╗Ņ║ŅĪó100Gźąźżź╚/╔├ż╬╣ŌÅ]źŪĪ╝ź┐┼┴┴„ż“╝┬Š┌żĘż┐ĪŻż│żņż“ä▌źĄź¾źšźķź¾źĘź╣ź│żŪ│½ż½żņż┐ISSCCĪ╩International Solid-State Circuits ConferenceĪ╦żŪ╚»╔ĮżĘż┐ĪŻ
![┐▐1ĪĪ3D ICż“źĮź▒ź├ź╚ż╦Ų■żņĪó100GB/sż╬╣ŌÅ]┐«ęÄ(gu©®)ż“│╬Ū¦](/archive/editorial/technology/img/TFP130220-01a.jpg)
┐▐1ĪĪ3D ICż“źĮź▒ź├ź╚ż╦Ų■żņĪó100GB/sż╬╣ŌÅ]┐«ęÄ(gu©®)ż“│╬Ū¦
TSVĪ╩through silicon viaĪ╦żŽ╚ŠŲ│öüź┴ź├źūż“─_ż═żŲÅ──╠┼┼Č╦ż“Ę┴└«żĘż┐żŌż╬żŪżóżļż┐żßĪóŪ█└■─╣ż¼ø]ż»╣ŌÅ]Ų░║Ņż╦Ė■ż»ĪŻż│żņż▐żŪżŽźĘź▀źÕźņĪ╝źĘźńź¾żŪĪó╣ŌÅ]Ų░║Ņż“Š┌£½żĘżŲżżż┐ż¼Īó╝┬║▌ż╦4096Ė─żŌż╬I/Oźąź╣ż“╗Ņ║ŅżĘż┐övŽ®żŪ╣ŌÅ]Ų░║Ņż“╝┬Š┌żĘż┐(┐▐1)ż╬żŽż│żņż¼ĮķżßżŲĪŻ
ż│ż╬╚ŠŲ│öüźŪźąźżź╣żŽĪó527Ė─ż╬I/Oż“Ęeż─źĒźĖź├ź»ICż╬æųż╦źĘźĻź│ź¾ż╬źżź¾ź┐Ī╝ź▌Ī╝źČż“║▄ż╗Ī󿥿ķż╦800Kźąźżź╚ż╬SRAMż“3╝ĪĖĄ┼¬ż╦└č┴žżĘĪóżĮżņżŠżņż“TSVżŪ└▄¶öżĘż┐żŌż╬ĪŻ¾H┴žŪ█└■ż╬┴ž┐¶żŽźĒźĖź├ź»ĪóSRAMĪóźżź¾ź┐Ī╝ź▌Ī╝źČČ”ż╦8┴žźßź┐źļĪŻSRAMż╚źżź¾ź┐Ī╝ź▌Ī╝źČĪóźżź¾ź┐Ī╝ź▌Ī╝źČż╚źĒźĖź├ź»żŽżĮżņżŠżņ50”╠mźįź├ź┴ż╬ź▐źżź»źĒźąź¾źūżŪ└▄¶öżĘżŲżżżļ(┐▐2)ĪŻźżź¾ź┐Ī╝ź▌Ī╝źČż╬╔ĮĀCż½żķ╬óĀCż╦┼ŽżĻĪó50”╠mźįź├ź┴żŪ7,328Ė─ż╬TSVż“Ę┴└«żĘż┐ĪŻFR-5ż╬źūźĻź¾ź╚┤łż╚źĒźĖź├ź»ź┴ź├źūż╚żŽ200”╠mźįź├ź┴ż╬źąź¾źūżŪ└▄¶öżĘżŲżżżļĪŻżĮżņżŠżņż╬ź┴ź├źūżŽ╣±ŲŌźšźĪź”ź¾ź╔źĻż╬e-źĘźŃź╚źļż¼×æļ]żĘż┐ĪŻ
![┐▐2ĪĪ┐└Ė═Įj│žż╚ASETż¼╗Ņ║ŅżĘż┐3D ICż╬╣Įļ]┐▐](/archive/editorial/technology/img/TFP130220-01b.gif)
┐▐2ĪĪ┐└Ė═Įj│žż╚ASETż¼╗Ņ║ŅżĘż┐3D ICż╬╣Įļ]┐▐
źżź¾ź┐Ī╝ź▌Ī╝źČŲŌż╬Å──╠┼┼Č╦7,328Ė─ż╬ż”ż┴Īó4096Ė─ż“źßźŌźĻż╬I/Oźąź╣ż╚żĘżŲ╗╚żżĪó╗─żĻż“┼┼Ė╗├╝╗ęĪóź░źķź¾ź╔├╝╗ęĪóźŲź╣ź╚├ō├╝╗ęĪó128źėź├ź╚ż╬∙N─╣źßźŌźĻź╗źļĪóż╩ż╔ż╦╗╚ż├żŲżżżļĪŻ
┐└Ė═Įjż╚ASETżŽż│ż╬źżź¾ź┐Ī╝ź▌Ī╝źČż“źóź»źŲźŻźųźżź¾ź┐Ī╝ź▌Ī╝źČż╚Ō}ż¾żŪżżżļĪŻ8┴žŪ█└■ż╬źĘźĻź│ź¾ź┴ź├źūŲŌż╦źĒźĖź├ź»ź┴ź├źūż╚źßźŌźĻź┴ź├źūż“źŲź╣ź╚ż╣żļövŽ®ż“ĮĖ└čżĘżŲżżżļż½żķż└ĪŻźŲź╣ź╚övŽ®żŽĪóź╣źŁźŃź¾ź┴ź¦Ī╝ź¾ż╚źßźŌźĻ├ōBISTĪ╩built-in self testĪ╦ĪóJTAG┴ĻĖ▀└▄¶öźčź┐Ī╝ź¾ż╬3¹|╬Óż“ĮĖ└čżĘż┐ĪŻż│ż╬ż┐żßĪóźßźŌźĻż╚źĒźĖź├ź»ż╬źŲź╣ź╚övŽ®ż“│░ŗ├╝╗ęż½żķźóź»ź╗ź╣żŪżŁżļĪŻ
ż│żņż▐żŪ3╝ĪĖĄICż╬╠õ¼öż╬▐kż─żŽĪóźŲź╣ź╚ż¼żŪżŁż╩ż½ż├ż┐ż│ż╚ĪŻźßźŌźĻż╚źĒźĖź├ź»ĪóżĮżņżŠżņżŽź”ź¦Ī╝źŽźŲź╣ź╚żŪ╣ń│╩żĘżŲżżżŲżŌĪóTSVżŪ└▄¶öżĘż┐ĖÕż╦100%ż─ż╩ż¼ż├żŲżżżļż½ż╔ż”ż½źŲź╣ź╚żĘżŲż▀ż╩ż▒żņżąż’ż½żķż╩żżĪŻTSVĘ┴└«╗■ż╬ź╣ź╚źņź╣żõ╔ĮĀCż╬Ū÷żż¤©▓Į╦ņż╩ż╔ż╬Ę┴└«ż╩ż╔żŪ100%ż─ż╩ż¼ż├żŲżżżļż╚żŽżżż©ż╩żżż½żķż└ĪŻżĮż│żŪĪóźĘźĻź│ź¾ż╬źżź¾ź┐Ī╝ź▌Ī╝źČż╦źŲź╣ź╚═Ų░ū▓Į└▀╝ŖŠ}╦Īż“ĮĖ└čżĘĪó3╝ĪĖĄIC│░ŗż½żķźŲź╣ź╚żŪżŁżļżĶż”ż╦żĘż┐ĪŻ
║ŻövżŽĪó│░ŗ├╝╗ęż“─╠żĖżŲĪóø]żżźčźļź╣żŪż│ż╬3╝ĪĖĄICż“Ņ~Ų░żĘĪó4096źėź├ź╚Ų▒╗■ż╦╩┬š`Ų░║ŅżĄż╗ż┐ĪŻżĮż╬╗■ż╬źóźżźčź┐Ī╝ź¾ż“┐▐3ż╦┐āż╣ĪŻźóźżźčź┐Ī╝ź¾ż¼żĘż├ż½żĻ│½żżżŲżżżļż│ż╚żŽ1Īż0ż╬╚Į─Ļż¼£½│╬ż╦żŪżŁżļż╚żżż”┴T╠Żż└ĪŻ─╠Š’Īó╣ŌÅ]┼┴┴„ż╬Šņ╣ńż╦═Įżß┐«ęÄ(gu©®)ż“äė─┤żĘżŲż¬ż»źūźĻź©ź¾źšźĪźĘź╣żõĪóźčźļź╣āSĘ┴ż“─┤┼Dż╣żļźżź│źķźżź║Īóż╚żżż├ż┐Č\Įčż“┼¼├ōż╣żļż¼Īó║Żövż╬╝┬┘xżŪżŽ▓┐żŌżĘżŲżżż╩żżĪóÖ┌ż╬źčźļź╣ż“Įą╬üżĘż┐żŌż╬ż└ż╚żżż”ĪŻ
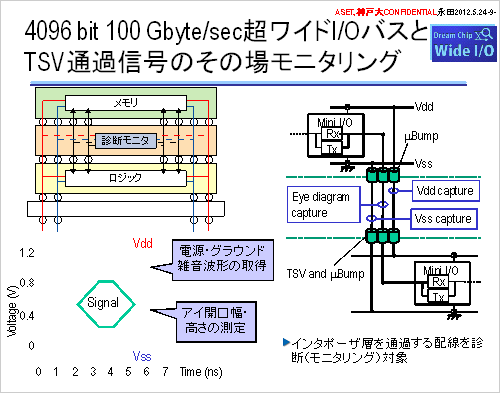
┐▐3ĪĪźčźļź╣ż╬źóźżźčź┐Ī╝ź¾żŽżĘż├ż½żĻ│½żżżŲżżżļĪĪĮąųZĪ¦┐└Ė═ĮjĪóASET
TSVżŽŪ█└■─╣ż¼ø]żżż┐żßĪó┤¾Ö┌═Ų╬╠ż¼žōżĻ╣ŌÅ]Ų░║ŅżŪżŁżļĪŻżĘż½żĘĪóTSVż╬źįź├ź┴ż“Ą═żßż┐Šņ╣ńż╦Ŗõ╩╔ż╬┤¾Ö┌═Ų╬╠ż¼╗\ż©żļż╬żŪżŽż╩żżż½ż╚Ążż╦ż╩żļż╚ż│żĒż└ż¼Īó╝┬║▌ż╦║Ņż├żŲ▒R─ĻżĘż┐ż╚ż│żĒĪó50Ī┴100fFżĘż½ż╩żżĪŻ╚ÓżķżŽĪó“£═Ķż╬źūźĻź¾ź╚┤łż╦źĒźĖź├ź»ż╚źßźŌźĻż“┼ļ║▄żĘż┐Šņ╣ńĪó20pFµć┼┘ż╬┤¾Ö┌═Ų╬╠ż¼Ö┌żĖżļż¼Īó3╝ĪĖĄż╦└č┴žżĘż┐Šņ╣ńż╦żŽ0.7pFµć┼┘ż╦žōŠ»ż╣żļż╚żżż”ĪŻ100fFżŽ0.1pFżŪżóżļż½żķĪóŖõ╩╔═Ų╬╠żŽ╠Ą£åżŪżŁżļż╚Ė└ż├żŲ║╣żĘܦż©ż╩żżż└żĒż”ĪŻ


