Š»┼┼╬«Ī”╣ŌÅ]Ī”1▓»övĮ±żŁ┤╣ż©▓─ē”ż╩┴Ļ╩č▓ĮźßźŌźĻż“LEAPż¼│½╚»
┴Ļ╩č▓ĮźßźŌźĻż¼RAMż╚żĘżŲ╗╚ż©żļ▓─ē”└Łż¼ĮążŲżŁż┐ĪŻ«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ńĪ╩LEAPĪ╦żŽĪó±TŠĮAż╚±TŠĮBż╬╔ÅöĪż└ż▒żŪ┴Ļ┼ŠöĪżŪżŁżļĖČ═²ż“ŠW(w©Żng)├ōżĘż┐źßźŌźĻż“│½╚»żĘĪó1▓»övż“«Ćż©żļĮ±żŁ┤╣ż©öv┐¶ż“įu(p©¬ng)ż┐ĪŻż│żņ░╩æųż╬Į±żŁ┤╣ż©źŲź╣ź╚żŽ╗■┤ųż¼ż½ż½żĻż╣ż«żļż┐żßĪó├µ┘VżĘż┐ż╚żżż”ĪŻ

┐▐1ĪĪ1▓»öv░╩æųż╬Į±żŁ┤╣ż©öv┐¶ż“╝┬ĖĮżĘż┐┴Ļ╩č▓ĮźßźŌźĻĪĪĮąųZĪ¦LEAP
LEAPżŽ2013ŃQžö(c©ói)ż╬VLSI SymposiumżŪż│ż╬┴Ļ╩č▓ĮźßźŌźĻż╬ĖČ═²ż“╚»╔ĮżĘżŲżżż┐ż¼Īó║ŻĮĄä▌(sh©¼)╣±żŪ│½╠¢(h©żo)żĄżņżŲżżżļIEDMĪ╩International Electron Devices MeetingĪ╦żŪżĮż╬Ų░║Ņ±T▓╠ż“╚»╔ĮżĘż┐ĪŻż│ż╬┐ĘĘ┐┴Ļ╩č▓ĮźßźŌźĻżŽĪóGe/TeŪ÷╦ņż╚Sb2Te3Ū÷╦ņż“Ė“Ė▀ż╦└čż▀─_ż═ż┐«Ć│╩╗ę╣Įļ]ż“Ę┴└«żĘżŲżżżļĪŻŲ¾ż─ż╬Ū÷╦ņ┤ųżŪGeĖČ╗ęż¼╣įżŁ═ĶżĘżŲ«Ć│╩╗ę±TŠĮAż╚«Ć│╩╗ę±TŠĮBż╚ż╬┴Ļ╩č▓Įż╦żĶż├żŲĪó°B(ni©Żo)Ń^├═ż¼1Ī┴2ĘÕ╩č▓Įż╣żļĪŻ±TŠĮAż╚±TŠĮBż╬├µż╦┘T║▀ż╣żļGeĖČ╗ęż╬╝■░Žż╦═»żŁæųż¼żļ┼┼╗ę▒└ż╬╠®┼┘ż╬░Ńżżż╦żĶż├żŲĪó┼┼╬«ż¼░Ńżż°B(ni©Żo)Ń^ż¼░Ńż├żŲż»żļĪŻ
“£═Ķż╬┴Ļ╩č▓ĮźßźŌźĻżŪżŽĪó±TŠĮż╚źóźŌźļźšźĪź╣ż╬ėX(ju©”)▌åż“╔ÅöĪżĘżŲżżż┐ż┐żßż╦Īó±TŠĮż¼═Žż▒żļż█ż╔ż╬Įj(lu©░)żŁż╩ź©ź═źļź«Ī╝ż“ØŁ═ūż╚żĘż┐ĪŻż│ż╬ż│ż╚żŽĪóĮ±żŁ┤╣ż©ż╦ØŁ═ūż╩Š├õJ┼┼╬üż¼Įj(lu©░)żŁżżż│ż╚ż“┴T╠Żż╣żļĪŻźĖźÕĪ╝źļÕXż╦żĶż├żŲ═╗┼└żŪżóżļ625ĪŅ░╩æųż╬╣Ōča(b©│)ż╦ż╩ż├żŲżżż┐ĪŻ“£═ĶżŽĪóGe(ź▓źļź▐ź╦ź”źÓ)ż╚SbĪ╩źóź¾ź┴źŌź¾Ī╦ĪóTe(źŲźļźļ)ż╬3ĖĄ╣ńČŌ±TŠĮż“ŠW(w©Żng)├ōżĘżŲż¬żĻĪó±TŠĮż╚źóźŌźļźšźĪź╣ėX(ju©”)▌åż╬░Ńżżż╦żĶż├żŲĪó╬«żņżļ┼┼╬«├═ż╣ż╩ż’ż┴°B(ni©Żo)Ń^├═ż¼░█ż╩żļż│ż╚ż“ŠW(w©Żng)├ōżĘżŲĪó1ż╚0ż“╚Į╩╠żĘżŲżżż┐ĪŻ
┐Ę│½╚»ż╬┴Ļ╩č▓ĮźßźŌźĻ┴Ū╗꿎Īó«Ć│╩╗ę±TŠĮż╦ż¬ż▒żļŲ¾ż─ż╬ėX(ju©”)▌åż╬░Ńżżż“ŠW(w©Żng)├ōżĘżŲĪó1ż╚0ż“╚Į╩╠ż╣żļĪŻż┐ż└żĘĪó«Ć│╩╗ę±TŠĮ╦ņż“║Ņ×æż╣żļŠņ╣ńż╦║ŪĮķż╬ż│żĒżŽēä䮿╬╬╔żżżŁżņżżż╩«Ć│╩╗ę╣Įļ]ż¼įu(p©¬ng)żķżņż║ĪóTEMĪ╩Ų®āį(c©©)Ę┐┼┼╗ęĖ▓╚∙¬Ü(d©▓)Ī╦ćĶ╗ĪżŪ╣ńČŌ┴Ļż¼▐kŗĖ½żķżņż┐ĪŻ║ŻövżŽĪóGeSbTe╣ńČŌ┴Ļż“Č╦╬üŪėĮ³żĘĪó╣Ōēä䮿╬«Ć│╩╗ę±TŠĮż“įu(p©¬ng)żļż│ż╚żŪĪóĮ±żŁ┤╣ż©öv┐¶ż└ż▒żŪżŽż╩ż»ĪóżĮż╬┬Šż╬ØŖ└ŁżŌ▓■║¤żĄżņż┐ĪŻĮ±żŁ╣■ż▀┼┼╬«żŽ“£═Ķż╬1/25ż╦┼÷ż┐żļ70µAż╚─Ńžō(f©┤)żĘ(┐▐2ż╬īÜ)ĪóŲ░║ŅÅ]┼┘żŽ“£═Ķż╬1/15ż╬10nsż╚╣ŌÅ]ż╦ż╩ż├ż┐(┐▐2ż╬║Ė)ĪŻ
ż»żŲ║čż▀Īó╣ŌÅ]Ų░║Ņż¼▓─ē”ĪĪĮąųZĪ¦LEAP](/archive/editorial/technology/img/TFP131212-01b.gif)
┐▐2ĪĪ┐ĘĘ┐«Ć│╩╗ężŪżŽĮ±żŁ┤╣ż©ż╦ØŁ═ūż╩źčźļź╣╗■┤ųżŽø](m©”i)ż»żŲ║čż▀Īó╣ŌÅ]Ų░║Ņż¼▓─ē”ĪĪĮąųZĪ¦LEAP
±TŠĮAż╚±TŠĮBż╚ż╬┤ųż“Geż¼╣įżŁ═Ķż╣żļ«Ć│╩╗ę╣Įļ]ż└ż╚Īó╔ÅöĪż╣żļż┐żßż╬ź©ź═źļź«Ī╝ż¼Š«żĄżżż┐żßĪóŠ├õJ┼┼╬üżŽŠ«żĄż»ĪóÅ]┼┘źĒź╣żŌŠ»ż╩żżĪóż╚żżż”Ślż└ĪŻżĄżķż╦°B(ni©Żo)Ń^├═ż╬źąźķż─żŁżŌ“£═Ķż╬╣ńČŌ±TŠĮĪóĮķ┤³ż╬«Ć│╩╗ęĪó╣Ōēä䮿╬«Ć│╩╗ęż╚±TŠĮ└Łż¼Ė■æųż╣żļż╦ż─żņĪóźąźķż─żŁż¼žō(f©┤)żļż╚żżż”źßźĻź├ź╚żŌżóżļ(┐▐3)ĪŻ×æļ]ż╦żŽĪóźŪźÕźóźļź½źĮĪ╝ź╔öĄ(sh©┤)╝░ż╬PVD(ź╣źčź├ź┐źĻź¾ź░)äóÅøż“╗╚żżĪóGeTeż╚Sb2Te3ż╬ź┐Ī╝ź▓ź├ź╚ż╦┼÷żŲżļ┼┼╗ęĮŲż╬└┌żĻü÷ż©ż╦żĶż├żŲ«Ć│╩╗ę╣Įļ]ż“║Ņż├żŲżżżļĪŻ
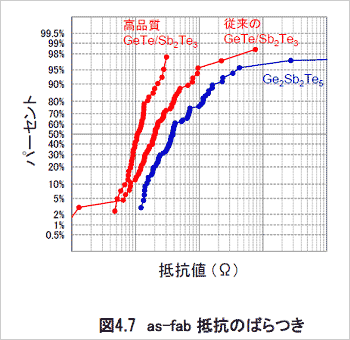
┐▐3ĪĪ«Ć│╩╗ę╦ņż“Ę┴└«żĘż┐─ŠĖÕż╬°B(ni©Żo)Ń^├═ż╬źąźķż─żŁĪĪż│ż╬ź’źżźųźļ╩¼╔█żŪżŽ°B(ni©Żo)Ń^├═ż¼╬®ż┴æųż¼ż├żŲżżżļż█ż╔źąźķż─żŁż¼Š«żĄżżż│ż╚ż“┐ā(j©®)ż╣ĪĪĮąųZĪ¦LEAP
LEAPżŽĪóĮ±żŁ┤╣ż©┼┼╬«ż¼50Ī┴70µAż╚Š«żĄż»ĪóżĘż½żŌź╝źĒ╝¦ŠņżŪMJTĪ╩╝¦Ążź╚ź¾ź═źļ└▄╣ńĪ╦°B(ni©Żo)Ń^ż╬źęź╣źŲźĻźĘź╣ż¼įu(p©¬ng)żķżņżļSTTĪ╩ź╣źįź¾ź╚źķź¾ź╣źšźĪź╚źļź»Ī╦-MRAMĪ╩╝¦Ążźķź¾ź└źÓźóź»ź╗ź╣źßźŌźĻĪ╦żŌ│½╚»żĘĪóż│ż╬IEDMżŪ╚»╔ĮżĘżŲżżżļĪŻ“£═ĶżŽĪó╔ŌŅ^╝¦Šņż╬▒ŲūxżŪĪó°B(ni©Żo)Ń^ż╬źęź╣źŲźĻźĘź╣żŽĪóżóżļĮj(lu©░)żŁżĄż╬╝¦ŠņżŪćĶ▒RżĄżņżŲżżż┐ĪŻż▐ż┐ĪóMRAMż╬2źėź├ź╚/ź╗źļ╣Įļ]żŌ╚»╔ĮżĘż┐ĪŻ


