╗╚ż©żļźšźĻź├źūź┴ź├źūČ\Įčż¼┼ąŠņĪóIoTźŪźąźżź╣ż╦║Ū┼¼
ż│żņż▐żŪžMżĘż½ż├ż┐źšźĻź├źūź┴ź├źūČ\Įčż╦żĶżļLSIźčź├ź▒Ī╝źĖż¼╝┬├ō▓ĮżŪżŁżļżĶż”ż╦ż╩żĻżĮż”ż└ĪŻ┼┼Č╦ż╦ż½ż½żļ▓┘─_ż¼“£═Ķż╬1/20ż╚ż╩żļ0.12g─_/źąź¾źūż╚Š«żĄż»ĪóżĘż½żŌ└▄╣ńča┼┘ż¼80°Cż╚“£═Ķż╬1/3żŪ▓─ē”ż╦ż╩żļż½żķż└ĪŻż│ż╬żĶż”ż╩LSIźčź├ź▒Ī╝źĖČ\Įčż“Ų³╦▄ż╬ź┘ź¾ź┴źŃĪ╝żŪżóżļź│ź═ź»źŲź├ź»źĖźŃźčź¾ż¼│½╚»Īó┐¶╝å°Pż╬░·żŁ╣ńżżż╦¬{żżżŲżżżļĪŻ

┐▐1ĪĪź│ź═ź»źŲź├ź»źĖźŃźčź¾ĪĪ┬Õ╔ĮŲD─∙╠“Ę¾CEOż╬╩┐┼─▒Mō¦Ģ■
źšźĻź├źūź┴ź├źūČ\Į迎Īó├╝╗ę┤ųźįź├ź┴ż“Č╣ż»żĘżŲ╚∙║┘ż╩źčź├ź▒Ī╝źĖż╦żŌ×┤▒■żŪżŁżļż╚żĘżŲ1960ŃQ┬Õż╦IBMż¼│½╚»żĘż┐ĪŻIBMż╬źßźżź¾źšźņĪ╝źÓź│ź¾źįźÕĪ╝ź┐ż╦┼ļ║▄żĄżņż┐ż│ż╚ż¼żóż├ż┐ĪŻż╚ż│żĒż¼żżż─ż▐żŪż┐ż├żŲżŌ╔ߥ┌żĘż╩ż½ż├ż┐ĪŻź’źżźõź▄ź¾źŪźŻź¾ź░ż“╗╚ż’ż║ż╦╩┐ż┘ż├ż┐żżźėĪ╝źÓż╚Ō}żążņżļŪ█└■źĻĪ╝ź╔ż“╗╚żż░ĄŠÆżŪ└▄¶öż╣żļż┐żßĪó╚∙║┘▓Įż¼┐╩żÓLSIż╦Ė■ż»ż└żĒż”ż╚Ė└ż’żņżŲżŁż┐ĪŻźżź¾ź└ź»ź┐ź¾ź╣ż¼Š»ż╩ż»╣ŌÅ]▓ĮżĘżõż╣żżæųż╦╩³ÕXżŌŃ~ŠWż└ż├ż┐ż½żķż└ĪŻż╚ż│żĒż¼Īó┤³┬įżĄżņż┐│õż╦żĄż├żčżĻ╝┬├ō▓Įż¼▒¾ż»╔ߥ┌żĘżŲż│ż╩ż½ż├ż┐ĪŻ
żĮż╬ĖČ░°żŽĪóÕX░ĄŠÆżŪ¤²ż▒żļ▓┘─_ż╚╣ŌčaĮĶ═²ż╦żóż├ż┐Īóż╚ź│ź═ź»źŲź├ź»źĖźŃźčź¾ż“2009ŃQż╦┴ŽČ╚żĘż┐┬Õ╔ĮŲD─∙╠“Ę¾CEOż╬╩┐┼─▒Mō¦Ģ■Ī╩┐▐1Ī╦żŽĖņżļĪŻźĘźĻź│ź¾ź┴ź├źūżŽ╚∙║┘▓Įżõ¾H┴žŪ█└■ż¼┐╩żÓż█ż╔ĪóźšźĻź├źūź┴ź├źūż½żķ▒¾żČż½ż├ż┐ĪŻż╚żżż”ż╬żŽĪó¾H┴žŪ█└■ż╬Low-K─Ń═Č┼┼╬©║Ó╬┴żŽĪó═Č┼┼╬©ż¼─Ńżżż┐żß┤¾Ö┌═Ų╬╠ż¼Š»ż╩ż»╣ŌÅ]▓Įż╦Ė■ż»ż╚Ė└ż’żņż╩ż¼żķĪó¾H╣”䮿Ūź╣ź½ź╣ź½ż╬╣Įļ]ż╦ż╩żļż┐żßĄĪ│Ż┼¬ż╩╬üż╦╝Õż»Īóż─żųżņżõż╣ż½ż├ż┐ż½żķż└Ī╩┐▐2Ī╦ĪŻ
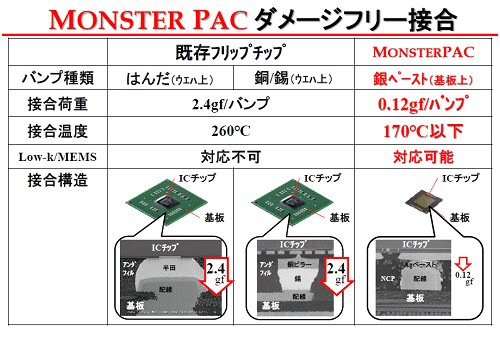
┐▐2ĪĪ┼┼Č╦ż╦ż½ż½żļ▓┘─_ż¼1/20Īó└▄╣ńča┼┘żŽ1/3ĪĪĮąųZĪ¦ź│ź═ź»źŲź├ź»źĖźŃźčź¾
└▄╣ńča┼┘ż¼║Żöv80°Cż▐żŪ▓╝ż▓żķżņżļżĶż”ż╦ż╩ż├ż┐ż¼Īó“£═Ķż╬260°Cż╚żżż”╚Š┼─ča┼┘żŪżŽź¼źķź╣┼ŠöĪ┼└░╩æųż╚ż╩żĻĪó┤łż╬ÕX╦──źż¼30ppm/°Cż╚ĮjżŁż»ż╩żĻĪó└▄╣ńźįź├ź┴ż“40µm░╩▓╝ż╦╚∙║┘▓ĮżŪżŁż╩ż½ż├ż┐ĪŻ║“ŃQż▐żŪżŽź¼źķź╣┼ŠöĪ┼└░╩▓╝ż╬130°CżŪ└▄¶öżŪżŁż┐ż┐żßĪó40µmźįź├ź┴ż¼▓─ē”ż╦ż╩ż├ż┐ĪŻ║ŻŃQżŽżĮżņż“żĄżķż╦80°Cż▐żŪ▓╝ż▓żļż│ż╚ż¼żŪżŁż┐ż╚żżż”ĪŻŠ▄║┘żŽSEMICON JapanżŪĖ½ż╗żļż╚żĘżŲżżżļĪŻ
Ų▒Ģ■żŽĪóź└źßĪ╝źĖż╬Š»ż╩żżź▄ź¾źŪźŻź¾ź░öĄ╦Īż“╣═ż©ż┐ĪŻŲ▒╝ęż¼MosterPACż╚Ō}żųż│ż╬Č\Į迎ĪóźūźĻź¾ź╚övŽ®┤łżŪżĶż»╗╚ż”ź╣ź»źĻĪ╝ź¾░§║■Č\Įčż“Ņ~╗╚ż╣żļżŌż╬żŪĪóØŖÖzż╩äóÅøżŪżŽż╩żżĪŻLSIż╬źūźĻź¾ź╚┤łæųż╦ź┴ź├źūż“ź▐ź”ź¾ź╚ż╣żļŠņ╣ńĪó┤ł┼┼Č╦źčź├ź╔æųż╦ź╣ź»źĻĪ╝ź¾░§║■żŪźąź¾źū┼┼Č╦ż“Ę┴└«ż╣żļĪŻź╣ź»źĻĪ╝ź¾░§║■ż╬ź╣źŁĪ╝źĖż╬ĘĻż╬źĄźżź║żŪ║ŪŠ«Øó╦Īż¼»éż▐żļż¼Īó║ŪŠ«Øó╦Ī40µmźįź├ź┴ż▐żŪżŽĘ┴└«▓─ē”ż└ż╚żżż”ĪŻżĮż╬æųż╦ĪóNCPĪ╩Non-Contact PasteĪ╦ż╚Ō}żųķ]ėXźņźĖź¾żŪ╚’ä┘żĘĪóżĮż╬æųż╦┼┼Č╦źčź├ź╔ż╬¤²żżż┐ź┴ź├źūż“źšź¦Ī╝ź╣ź└ź”ź¾żŪ║▄ż╗Īó┤łča┼┘ż“æųż▓żŲżżż»ĪŻŠ»żĘča┼┘ż“æųż▓żļż╚ĪóNCPż╬źņźĖź¾ūl┼┘ż¼▓╝ż¼żĻķ]ėXż╦ż╩żļż┐żßĪóź┴ź├źūż╚┤ł┤ųż╬┼┼Č╦Ų▒╗╬ż½żķźņźĖź¾ż¼▓ĪżĘĮążĄżņżŲŪėĮążĄżņĪó┼┼Č╦Ų▒╗╬ż¼└▄ŠÆżĄżņżļĪŻżĄżķż╦ča┼┘ż“æųż▓żŲ▓├ÕXż╣żļż╚╣┼▓ĮżĘżŲźņźĖź¾żŽ╔wöüż╦ż╩żļż╚żżż”Ślż└ĪŻ
╚∙║┘▓Įż╦┤žżĘżŲĪó40µmźįź├ź┴ (└■╔²/└■┤ų│ų=20µm/20µm) ░╩▓╝ż╬╚∙║┘▓ĮżŌ▓─ē”żŪĪóŲ▒╝꿎░§║■żŪżŽż╩ż»Īóźżź¾źūźĻź¾ź╚Č\Įčż“╗╚ż©żą10µmźįź├ź┴ż▐żŪ▓─ē”ż└ż╚Ė½żŲżżżļĪŻ
┼┼Č╦Ų▒╗╬ż“└▄ŠÆżĄż╗ż┐ĖÕĪó┼┼Č╦┤ųż╬Ęõ┤ųż“ļmżßżļż╚żżż”źóź¾ź└Ī╝źšźŻźļ╣®µćż¼ż│żņż▐żŪżŽØŁ═ūż└ż¼ĪóBGAż╚░Ńż├żŲMonsterPACżŪżŽźóź¾ź└Ī╝źšźŻźļżŽ═ūżķż╩żżĪŻż│ż╬źņźĖź¾ż╚ča┼┘┤╔═²ż╩ż╔ż¼źŁźŌż└ż¼Īóż│ż╬Č\Į迎╚ļ├µż╬╚ļżŪżóżĻĪóź│ź═ź»źŲź├ź»ż¼×æļ]ż“æąż▒╔ķż”ĪŻ╗╚├ōż╣żļäóÅøżŽĪóµ£żŲśO╝ę×æżŪź”ź¦Ī╝źŽ╣®µćżŪż╬ź▀ź╦ź©ź¾źąźżźóźķźßź¾ź╚ż╚Ų▒══ĪóČ╔ĮĻź»źĻĪ╝ź¾źļĪ╝źÓż“└▀ż▒żŲżżżļ(┐▐3)ĪŻżĮż╬╦{Š¶┼┘żŽź»źķź╣1ż╚Īó╦{Š¶┼┘ż¼╣Ōżżż╩ż¼żķżŌĮjæä╠Žź»źĻĪ╝ź¾źļĪ╝źÓż“ØŁ═ūż╚żĘż╩żżĪŻ

┐▐3ĪĪäóÅøżŽźŪź╣ź»ź╚ź├źūźĄźżź║ĪĪĮąųZĪ¦ź│ź═ź»źŲź├ź»źĖźŃźčź¾
źšźĻź├źūź┴ź├źū╝┬äóż¼╝┬║▌ż╦╗╚ż©żļżĶż”ż╦ż╩żļż╚Īó├▒ż╩żļLSIż└ż▒ż╦ż╚ż╔ż▐żķż╩żżĪŻż│żņż▐żŪź’źżźõź▄ź¾źŪźŻź¾ź░żĘż½╗╚ż©ż╩ż½ż├ż┐MEMSż╬źčź├ź▒Ī╝źĖź¾ź░żõĪóźšźņźŁźĘźųźļź©źņź»ź╚źĒź╦ź»ź╣żŪ╗╚ż”Į└żķż½żŪŖW▓┴ż╩źūźĻź¾ź╚┤łźšźŻźļźÓż╦żŌ╗╚ż©żļżĶż”ż╦ż╩żļĪŻź▌źĻźżź▀ź╔źšźŻźļźÓżŽ╣Ōčaż╦┬čż©żķżņżļż¼Īó▓┴│╩ż¼╣ŌżżĪŻż│ż╬ż┐żßźšźņźŁźĘźųźļ┤łżŽ╣Ō▓┴żŪĪó╔ߥ┌żŪżŁżŲżżż╩ż½ż├ż┐ĪŻ║Żövż╬Č\Įčż“╗╚ż©żąĪóMEMS┼┼Č╦æųż╦źąź¾źūż“źßź├źŁżŪĘ┴└«żĘż╩ż»żŲ║čżÓż┐żßĪóźūźĻź¾ź╚┤łŖõż╦źąź¾źūż“Čõź┌Ī╝ź╣ź╚ż╚░§║■żŪĘ┴└«żĘżŲż¬żŁĪóż│ż╬MonsterPACČ\ĮčżŪ└▄╣ńżŪżŁżļĪŻ
MEMSżŽĪó▓├Å]┼┘żõöv┼ŠźĖźŃźżźĒĪó░Ą╬üż╩ż╔ż“ĖĪĮąż╣żļż╬ż╦ż│żņż▐żŪżŽź╣ź▐Ī╝ź╚źšź®ź¾ż╦żĶż»╗╚ż’żņżŲżżż┐ĪŻż│żņż½żķż╬IoT╗■┬Õż╬ź╗ź¾źĄż╚żĘżŲżŌżĄżķż╦╗╚ż’żņżŲżżż»żŪżóżĒż”ĪŻźšźņźŁźĘźųźļź©źņź»ź╚źĒź╦ź»ź╣Č\Į迎Īóē”Ų░źŪźąźżź╣ż╦źĘźĻź│ź¾CMOSź┴ź├źūż“Ū÷ż»║’ż├żŲ╗╚ż©żą╣ŌĄĪē”ż╩źšźņźŁ┤łż¼▓─ē”ż╦ż╩żļĪŻ╗─Ū░ż╩ż¼żķŃ~ĄĪź╚źķź¾źĖź╣ź┐żŽ20ŃQż┐ż├żŲżŌ▐kĖ■ż╦└Łē”ż¼æųż¼żķż╩żżż┐żßĪóē”Ų░┴Ū╗ęż╦źĘźĻź│ź¾ż“╗╚ż”źšźņźŁźĘźųźļźŽźżźųźĻź├ź╔ź©źņź»ź╚źĒź╦ź»ź╣Ī╩FHEĪ╦ż╚żżż”╩¼╠Ņż¼īÖ└Ł▓ĮżĘ╗ŽżßżŲż¬żĻĪóż│ż╬╩¼╠ŅżŪżŌ╝┬├ō▓Įż¼┤³┬įżĄżņżļĪŻ
IoTźŪźąźżź╣żŽż│żņż▐żŪż╦ż╩żżż█ż╔ż╬Š»╬╠¾Hēä¹|ż╦ż╩żļż½żķż│żĮĪó─Ńź│ź╣ź╚żŪ║Ņżļż│ż╚ż¼ź½ź«ż“É█żļĪŻź│ź═ź»źŲź├ź»ż¼║Ņż├ż┐äóÅøżŽŠ«Ę┐Ī”Ę┌╬╠Ī”Š»ĀC└čżŪżóżļż┐żßĪóäóÅø▓┴│╩Īó▒┐├ōź│ź╣ź╚Īó└▀ÅøĀC└čż╩ż╔ż½żķżŌ─Ńź│ź╣ź╚żŪ║čż▀żĮż”ż└ĪŻ▓├ż©żŲĪó1Ė─ż½żķØ▓┐¶╦³Ė─/ĘŅż▐żŪ×┤▒■żŪżŁżļż╚żĘżŲżżżļĪŻ╩┐┼─Ģ■ż╬Ė½└čżŌżĻżŪżŽĪó“£═Ķż╬ĖÕ╣®µć╣®Šņż╚╚µż┘Īó┼Ļ½@ČŌ±YżŽ1/40ĪóĀC└迎1/5700żŪ║čżÓż╚żżż”ĪŻ
ż│ż╬Č\Įčż╦żżż┴┴ßż»ų`ż“¤²ż▒ż┐ä▌╣±╦╔┴ĒŠ╩ż¼╝ńŲ│ż╣żļ╝Ī└ż┬Õż╬ŠÅ┤▒│žFHEźūźĒźĖź¦ź»ź╚żŪżóżļĪóNEXTFLEXżžż╬╗▓▓├ż¼ż│ż╬7ĘŅż╦»éż▐ż├ż┐ĪŻBoeing╝ężõLockheed Martin╝ęż“źŲźŻźó1źĄźūźķźżźõż╚żĘĪóEastmanżõQualcommĪóDuPontĪóApplied MaterialsĪóGEż╩ż╔7╝ęż“źŲźŻźó2źĄźūźķźżźõż╚ż╣żļź│ź¾źĮĪ╝źĘźóźÓżŪĪóź│ź═ź»źŲź├ź»źĖźŃźčź¾żŽEquipment AffiliateĪ╩äóÅø┤žŽó┤ļČ╚Ī╦ż╚żĘżŲ╗▓▓├żĘżŲżżżļĪŻ


