imecĪóĪųźÓĪ╝źóż╬╦Īō¦żŽż│żņż½żķżŌ┘Vż▐żķż╩żżĪūĪóSTCOżŪA2└ż┬Õż▐żŪ¶öż»
źÓĪ╝źóż╬╦Īō¦Īóż╣ż╩ż’ż┴Š”├ōż╬╚ŠŲ│öü×æēäż╦ĮĖ└迥żņżļź╚źķź¾źĖź╣ź┐ż╬┐¶żŽ2ŃQż┤ż╚ż╦Ū▄╗\ż╣żļĪóż╚żżż”Ęą║č╦Īō¦żŽĪóé╬ż▐żļż│ż╚ż“ē¶żķż╩żżĪŻ╚∙║┘▓ĮżŽ┘Vż▐ż├żŲżżżļżŌż╬ż╬DTCOż╦żĶż├żŲ3╝ĪĖĄ▓ĮżŪĮĖ└č┼┘ż“╣ŌżßżļČ\Į迎¶öżżżŲżżżļż½żķż└ĪŻź┘źļź«Ī╝ż╬╚ŠŲ│öüĖ”ē|ĮĻimecżŽĪóĮø═Ķż╦×óż©STCOĪ╩System Technology Co-OptimizationĪ╦ż“─¾Š¦żĘĪóCMOSż╬ź╣ź▒Ī╝źĻź¾ź░ż¼żĄżķż╦¶öż»╠OČ┌ż“┐āżĘż┐ĪŻ

┐▐1ĪĪimecż╬CEOżŪżóżļLuc Van Den HoveĢ■
źšźĪź”ź¾ź╔źĻż¼5nmźūźĒź╗ź╣ź╬Ī╝ź╔ż╚żżż├żŲżŌĪóżĮż╬ź┴ź├źūæųż╬ż╔ż│ż╦żŌ5nmż╚żżż”╚∙║┘ż╩Øó╦ĪżŽ┘T║▀żĘż╩żżĪŻ└■╔²ż╬╚∙║┘▓Įż╬Å]┼┘ż¼ż░ż├ż╚═Ņż┴żŲżżżļż½żķż└ĪŻż╗żżż╝żż12Ī┴15nmØiĖÕżŪż█ż▄┘Vż▐ż├żŲżżżļĪŻżĮż│żŪĪó└■╔²/└■┤ų│ųż╬źķźżź¾ź╣ź▒Ī╝źĻź¾ź░ż½żķĪó└■╔²Ī”└■┤ų│ųż“żĮżņż█ż╔Č╣ż»ż╗ż║ż╦FinFETż╬finż╬┐¶ż“žōżķżĘż┐żĻĪó├▒░╠ĀC└č┼÷ż┐żĻż╬Ū█└■┐¶ż“žōżķżĘż┐żĻż╣żļżĶż”ż╩ĀC└čź╣ź▒Ī╝źĻź¾ź░ż╦źĘźšź╚żĘżŲżżżļĪŻTSMCżõSamsungż╩ż╔ż╬źšźĪź”ź¾ź╔źĻżõIntelż╩ż╔ż¼ż│ż╬Č\Įčż“║╬├ōż╣żļżĶż”ż╦ż╩ż├ż┐ĪŻżĮżņżķż“┘ć│╬ż╦╔ĮĖĮż╣żļż╩żķĪó7nm┴Ļ┼÷ż╬źūźĒź╗ź╣żõ5nm┴Ļ┼÷ż╬źūźĒź╗ź╣ż╚żżż”ż┘żŁżŪżóżĒż”ĪŻIntelż╬10nm┴Ļ┼÷ż╬źūźĒź╗ź╣ż╬öĄż¼TSMCżõSamsungźšźĪź”ź¾ź╔źĻż╬7nm┴Ļ┼÷źūźĒź╗ź╣żĶżĻżŌĮĖ└čżŪżŁżļź╚źķź¾źĖź╣ź┐┐¶ż¼¾HżżĪóż╚żżż”Ą£╝┬ż¼żóżļĪŻ
ź╗ź▀ź│ź¾ź▌Ī╝ź┐źļżŪżŽĪóż╣żŪż╦9ĘŅż╬▓±µ^Ė┬─ĻFreeWebinarĪųTSMCĖ”ē|Ī╩╗▓╣═½@╬┴1Ī╦ĪūżŪ£½żķż½ż╦żĘż┐żĶż”ż╦ĪóĀC└čź╣ź▒Ī╝źĻź¾ź░żóżļżżżŽ╠®┼┘ź╣ź▒Ī╝źĻź¾ź░ż╚żżż’żņżļČ\Įčż¼DTCOĪ╩Design Technology Co-OptimizationĪ╦żŪżóżļĪŻż│ż│żŪż╬DesignżŽźņźżźóź”ź╚└▀╝ŖĪóTechnologyżŽźūźĒź╗ź╣ż“┴T╠Żż╣żļĪŻż─ż▐żĻźņźżźóź”ź╚└▀╝Ŗż╚źūźĒź╗ź╣ż“Ų▒╗■ż╦║Ū┼¼▓ĮżĘżĶż”ż╚żżż”Č\ĮčżŪżóżļĪŻ
11ĘŅ7Ų³Īó┼ņ»B╣┴ČĶżŪ│½╠¢żĄżņż┐imecż╬ITFĪ╩Imec Technology ForumĪ╦ż╬┤─┤╣ų▒ķż╦ż¬żżżŲĪóimecż╬ź╚ź├źūLuc Van Den HoveĢ■Ī╩┐▐1Ī╦żŽĪóĪųMooreĪŪs Law Will Not StopĪūĪ╩źÓĪ╝źóż╬╦Īō¦żŽż│żņż½żķżŌ┘Vż▐żķż╩żżĪ╦ż╚żżż”Ė└±äż“▓┐┼┘żŌ╗╚ż├ż┐ĪŻżĮż╬ĖČŲ░╬üż╚ż╩żļČ\Į迎ĪóĖĮ║▀TSMCżõSamsungż╬źšźĪź”ź¾ź╔źĻż¼└Ķ├╝×æēäżŪ╗╚ż├żŲżżżļDTCOż“╚»·tżĄż╗ż┐STCOżŪżóżļĪŻż│żņż“╗╚ż”ż│ż╚ż╦żĶż├żŲĪó2nm┴Ļ┼÷ż╬źūźĒź╗ź╣ż½żķĪó1.4nmĪó1nmĪóżĮżĘżŲźĄźų1nm┴Ļ┼÷ż╬źūźĒź╗ź╣żžż╚┐╩·tżŪżŁżļż╚żĘż┐Ī╩┐▐2Ī╦ĪŻ
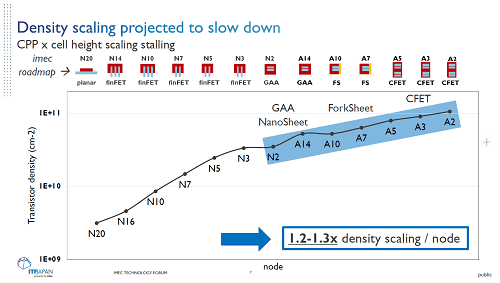
┐▐2ĪĪ0.2nmż╦┴Ļ┼÷ż╣żļA2źūźĒź╗ź╣ż▐żŪż╬źĒĪ╝ź╔ź▐ź├źūż“imecż¼┐āż╣ĪĪĮąųZĪ¦imec
2nmż“└┌żļżóż┐żĻż½żķĪóź╩ź╬źĘĪ╝ź╚ż“├ōżżżļGAAĪ╩Gate All AroundĪ╦żõnMOSż╚pMOSż“āeż╦─_ż═żļCFETż╩ż╔ż╬┐ʿʿżMOSź╚źķź¾źĖź╣ź┐╣Įļ]ż¼─¾░ŲżĄżņżŲżżżļĪŻ╬╠ŠÅżŪ╝┬ĖĮż╣żļźĻźĮź░źķźšźŻČ\Į迎żŌż┴żĒż¾EUVĪ╩Extreme Ultra VioletĪ╦żŪżóżļĪŻ
▓├ż©żŲŪ█└■Č\Įčż¼╩čż’żļĪŻ┼┼Ė╗źķźżź¾ż└ż▒ż“źĘźĻź│ź¾źąźļź»ż╦ļmżß╣■żÓ╣Įļ]ż“║╬├ōżĘż┐żĻĪó┼┼Ė╗źķźżź¾ż└ż▒ż╬ź”ź¦Ī╝źŽż“┐«ęÄ└■ż╚CMOSź╚źķź¾źĖź╣ź┐övŽ®ż╬ź”ź¦Ī╝źŽż“─źżĻ╣ńż’ż╗ż┐żĻż╣żļżĶż”ż╩╣Įļ]ż“║╬żļĪŻź╚źķź¾źĖź╣ź┐╣Įļ]ż╚Ū█└■╣Įļ]ż“┴╚ż▀╣ńż’ż╗żŲĪó2026ŃQż╬2ź¬ź¾ź░ź╣ź╚źĒĪ╝źÓĪ╩0.2nmĪ╦┴Ļ┼÷ż╬A2źūźĒź╗ź╣ź╬Ī╝ź╔ż▐żŪż╬źĒĪ╝ź╔ź▐ź├źūż“ķWżżżŲżżżļĪŻ
ر═²┼¬ż╦Øó╦ĪżŽżŌżŽżõ╚∙║┘▓ĮżŪżŁż╩żżż┐żßĪó┼÷─ś3╝ĪĖĄ▓Įż“┐╩ż¾żŪżżżļĪŻDTCOż╬╦▄䮿Ž3╝ĪĖĄ▓ĮżŪżóżļĪŻFinFETżõGAA╣Įļ]ż╬3╝ĪĖĄ▓Įż└ż▒żŪżŽż╩ż»Īó┐«ęÄżõ┼┼Ė╗Ū█└■żŌ3╝ĪĖĄ▓Įż╣żļż│ż╚żŪŪ█└■╠®┼┘ż“æųż▓żļż│ż╚ż¼żŪżŁżļĪŻż│żņż“źŌź╬źĻźĘź├ź»ż╦╣įż├żŲżżżļż╬ż¼DTCOżŪżóżļĪŻ

┐▐3ĪĪSTCOż╬▄ćŪ░ĪĪźĘź╣źŲźÓż╚źūźĒź╗ź╣Ī╩źŲź»ź╬źĒźĖĪ╝Ī╦ż╚ż╬Ų▒╗■║Ū┼¼▓ĮżŪźÓĪ╝źóż╬╦Īō¦ż“┐╩żßżļĪĪĮąųZĪ¦imec
║Żöv─¾░ŲżĘż┐STCOżŽĪóźĘź╣źŲźÓż“║Ū┼¼▓ĮżĘĪóżĮżņż╦╣ńż’ż╗żŲ»éż▐ż├ż┐źņźżźóź”ź╚└▀╝Ŗż╚źūźĒź╗ź╣żŌ║Ū┼¼▓ĮżĘżĶż”ż╚żżż”żŌż╬Ī╩┐▐3Ī╦ĪŻż│ż╬Š}╦ĪżŽźŌź╬źĻźĘź├ź»ż╦Ė┬żķż║Īó3D-ICż╬żĶż”ż╩ź┴ź├źūżõź”ź¦Ī╝źŽż╬ź╣ź┐ź├ź»ż╬Šņ╣ńż╦żŌ╗╚ż©żļĪŻżżż║żņżŌźĘź╣źŲźÓż╬źčĪ╝źŲźŻźĘźńź╦ź¾ź░Ī╩└┌żĻ╩¼ż▒║ŅČ╚Ī╦ż½żķ╗Žż▐żļĪŻżĮż╬ĖÕżŪĪó2╝ĪĖĄźņźżźóź”ź╚ż“3╝ĪĖĄźņźżźóź”ź╚ż╦╩čśŗż╣żļĪŻØŖż╦3D-ICżŪżŽĪó┐▐4ż╦┐āż╣żĶż”ż╦żĄż▐żČż▐ż╩ĄĪē”ż“ź┴ź├źūźņź├ź╚żõŠ«żĄż╩ź┴ź├źūż¼Ū█ÅøżĄżņż┐2╝ĪĖĄźūźņĪ╝ź¾ż“─_ż═╣ńż’ż╗żŲżżż»ĪŻż│ż╬żĶż”ż╦żĘżŲ├▒░╠ĀC└č┼÷ż┐żĻż╬ź╚źķź¾źĖź╣ź┐┐¶ż“╗\żõżĘĮĖ└č┼┘ż“æųż▓żļĪŻźĘź╣źŲźÓż╬źčĪ╝źŲźŻźĘźńź╦ź¾ź░żŽĪóźĘź╣źŲźÓż╦żĶż├żŲ░█ż╩żļż┐żßź½ź╣ź┐ź▐źżź║ż╣żļ║ŅČ╚ż╚ż╩żļĪŻ
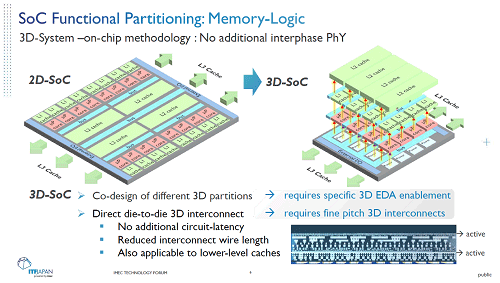
┐▐4ĪĪ2╝ĪĖĄżŪ·t│½żĘżŲżżż┐övŽ®ż“3╝ĪĖĄż╦żĘżŲĀC└čż“Į╠Š«ĪĪźĘź╣źŲźÓż╬źčĪ╝źŲźŻźĘźńź╦ź¾ź░ż¼ź½ź«ż╚ż╩żļĪĪĮąųZĪ¦imec
źŪĪ╝ź┐ź╗ź¾ź┐Ī╝żõHPCĪ╩High Performance ComputingĪ╦ż╬żĶż”ż╩╣Ō└Łē”ź│ź¾źįźÕĪ╝ź┐ż╦╗╚ż”├ō²ŗżŪżŽĪó2╝ĪĖĄż╚3╝ĪĖĄż¼║«żĖżĻ╣ńż”Ī╩┐▐5Ī╦ĪŻ3D-ICżŪżŽź┴ź├źūĪ╩ź└źżĪ╦ż╬│░ż╦ĮążŲżżżļŪ█└■źįź├ź┴ż╬╚∙║┘▓Įż¼ź½ź«ż╚ż╩żļĪŻż│żņż▐żŪż╬źŽź¾ź└ź▄Ī╝źļż└ż╚źŽź¾ź└ż╬żšż»żķż▀ż¼Ö┌żĖżļż┐żßĪó30µm╔²ż¼Ė┬┼┘ż╦ż╩żļĪŻżĮż│żŪ▓Żż╦╦─żķż▐ż╩żżCuĪ╩Ų╝Ī╦źįźķĪ╝ż╦╩čśŗż╣żļż│ż╚ż╦ż╩żļĪŻIMECżŽ║ŻövCuźįźķĪ╝ż╦żĶżļ7µmźįź├ź┴ż╬Ū█└■ż“┐āżĘż┐ĪŻ
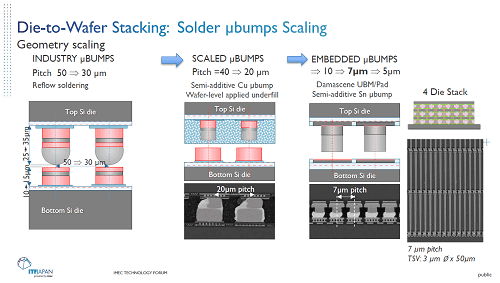
┐▐5ĪĪ└▄¶öż╣żļźŽź¾ź└ź▄Ī╝źļż╦┬Õż’żĻCuźįźķĪ╝żŪ└▄¶öżĘ╚∙║┘Ū█└■źįź├ź┴ż╦×┤▒■ĪĪĮąųZĪ¦imec
3D-ICżŪżŽ└Ō£½żĘżõż╣żżż¼ĪóźŌź╬źĻźĘź├ź»ż╦ĮĖ└čż╣żļŠņ╣ńżŪżŌŲ▒══Īó2╝ĪĖĄż½żķ3╝ĪĖĄżžż╚╩č┤╣ż╣żļż¼ĪóźĘź╣źŲźÓż╚żĘżŲ╣═ż©żļŠņ╣ńżŽż│żņż└ż▒żŪżŽż╩żżĪŻŠ├õJ┼┼╬üż“▓╝ż▓żļż┐żßż╦ØŖż╦Ų¾ż─ż╬ż│ż╚ż╦ÅRų`ż╣żļĪŻź└Ī╝ź»źĘźĻź│ź¾ż╚Īóźżź¾źšźķövŽ®żŪżóżļĪŻź└Ī╝ź»źĘźĻź│ź¾ż╚żŽĪóżóż▐żĻŲ░║ŅżĘżŲżżż╩żżźĒźĖź├ź»övŽ®ż╬ż│ż╚żŪĪóźżź¾źšźķövŽ®ż╚żŽĪóź│ź¾źįźÕĪ╝źŲźŻź¾ź░ż╦żŽ┤ž═┐żĘż╩żżövŽ®ż╬ż│ż╚żŪĪóØŁ═ū║ŪŠ«Ė┬ż╦ż╚ż╔żßżļżĶż”ż╦║Ū┼¼▓Įż╣żļĪŻ
ź┴ź├źūźņź├ź╚ż“ż─ż╩ż░ż┐żßż╬ź¬Ī╝źūź¾ż╩źóźķźżźóź¾ź╣ż¼AIBĪ╩Advanced Interface BusĪ╦żõUCIeĪ╩Universal Chiplet Interconnect ExpressĪ╦ż╣żŪż╦Įą═ĶżŲżżżļĪŻżĮżņżķżŽźżź¾ź┐Ī╝źšź¦źżź╣ż╬źąź╣╗┼══żŪżóż├ż┐żĻĪó┐«ęÄż╬źūźĒź╚ź│źļż╬║YØŹ▓ĮżŪżóż├ż┐żĻż╣żļż¼Īóimecż╚żĘżŲżŌźąź¾źūż╬╣ŌżĄżõ╔²ż╩ż╔ż╬źĄźżź║ż“żŽżĖżßż╚żĘżŲر═²┼¬ż╩źżź¾ź┐Ī╝źšź¦źżź╣ż╬║YØŹ▓Įż╦ŲDżĻ┴╚ż¾żŪżżżļĪŻŲ▒╗■ż╦ż│żņżķż╬ź│ź¾źĮĪ╝źĘźóźÓż╚żŌČ©╬üżĘżŲżżż»ĪŻ
╗▓╣═½@╬┴
1. ĪųŲ░▓ĶTSMCĖ”ē|Ī┴▓±µ^Ė┬─ĻFree WebinarĪūĪóź╗ź▀ź│ź¾ź▌Ī╝ź┐źļ (2022/10/04)


