Seleteż¼Low-k╦ņż╬ź©ź├ź┴ź¾ź░ż╦CH3Iź¼ź╣ż╬Ń~Ė·└Łż“╝┬Š┌
Selete (╚ŠŲ│öü└Ķ├╝źŲź»ź╬źĒźĖĪ╝ź║)ż╬ŗīŲ¾Ė”ē|ŗżŽĪóLow-k/CuŪ█└■Č\Įčż╬│½╚»ż“┐╩żßżŲżżżļż¼ĪóĄĪ│Ż┼¬ż╦żŌżĒżżLow-k╦ņżŽźŽĪ╝źšźįź├ź┴(hp)45nm░╩æTż╬źūźĒź╗ź╣żŪĪóź©ź├ź┴ź¾ź░Ę┴ėXĪó╣Ō┬ō┘I╚µĪóź└źßĪ╝źĖźšźĻĪ╝Īó─Ń┤─ČŁ╔ķ▓┘Īóż╚żżż├ż┐╠õ¼öż“ź»źĻźõĪ╝żĘż╩ż»żŲżŽż╩żķż╩żżĪŻż│ż╬ż█ż╔┐ʿʿżź©ź├ź┴ź¾ź░ź¼ź╣ż╚żĘżŲCF3Iż¼ż│żņżķż“╦■’BżĄż╗żļż│ż╚ż“Ų▒╝꿎Selete Symposium2008żŪ£½żķż½ż╦żĘż┐ĪŻ
CF3IżŽĪóFźķźĖź½źļż¼╚»Ö┌żĘż╦ż»ż»ĪóżĮż╬╠®┼┘żŽØÖŠ’ż╦─ŃżżĪ╩▓╝ż╬┐▐ż╬┐┐ż¾├µĪ╦ĪŻź└źßĪ╝źĖż“═┐ż©żļ╚Ø│░└■Ī╩UVĪ╦äė┼┘żŌC4F6żõCF4ż╩ż╔ż╚╚µż┘żŲżŌ─ŃżżĪ╩▓╝ż╬┐▐ż╬║ĖĪ╦ĪŻ▓├ż©żŲĪó├ŽĄÕż╬ča├╚▓Įż╦żŌżõżĄżĘżżĪŻ├ŽĄÕča├╚▓ĮĘĖ┐¶Ī╩GWP: global warm potentialĪ╦żŽŖW─Ļż╩ż¼żķča├╚▓Įź¼ź╣ż╚żĘżŲĘ∙ż’żņżŲżżżļCO2ż“1ż╚żĘżŲż│żņż▐żŪż╬ź©ź├ź┴ź¾ź░ź¼ź╣żŪżóżļCF4żŽ6500Ū▄żŌĄKżżĪŻC4F8żŽżĄżķż╦ĄKż»8700Ū▄żŌĄKżżĪŻŠ»ż╩ż»ż╚żŌCO2ż╬1żĶżĻżŽŠ«żĄżż║Ó╬┴ż“┬ōżėż┐żżĪŻSeleteż¼ĖĪŲżżĘżŲżżżļCF3Iź¼ź╣żŽ1╠ż╦■żŪżóżļż╚żżż”(▓╝ż╬┐▐ż╬īÜ)ĪŻ
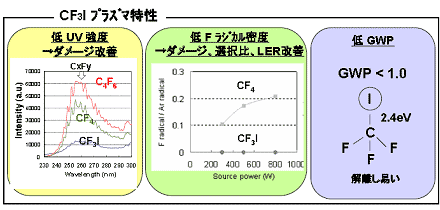
ż│ż│żŪ├ōżżżŲżżżļLow-k╦ņżŽź▌Ī╝źķź╣ż╩SiOCĪ╩k=2.6Ī╦żŪżóżĻĪóĄĪ│Ż┼¬ż╩äė┼┘ż¼╝Õż»Īóźūźķź║ź▐ż╦żĶżļĄōĀaż╦żŌ╝ÕżżĪŻżĮżņżŪĪóLow-k╦ņż╦źŁźŃź├źū┴žż“╚’ż╗żŲż½żķ45nmź╬Ī╝ź╔ż╬Ū█└■źčź┐Ī╝ź¾ż“╚µż┘żļż┐żßĪóźūźķź║ź▐ż╦żĶżļĄōĀaż“╔Įż╣źčź┐Ī╝ź¾Ŗõ╩╔ż╬╣ėżņĪ╩LER:źķźżź¾ź©ź├źĖźķźšź═ź╣Ī╦ż“─┤ż┘żŲż▀żļż╚Īó“£═Ķż╬CF4ż└ż╚Ŗõ╩╔ż╬╣ėżņżŽ6nmµć┼┘żóż├ż┐żŌż╬ż¼Īó║Żövż╬CF3IżŪżŽ2nmż╚žōŠ»żĘż┐ĪŻż╣ż╩ż’ż┴Ŗõ╩╔żŽżŁżņżżż╦▓├╣®żŪżŁżŲżżżļĪŻ
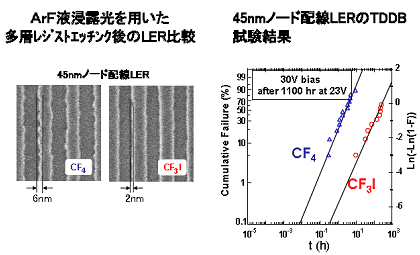
ż│ż╬ź©ź├ź┴ź¾ź░ź¼ź╣ż“╗╚ż├żŲ▓├╣®żĘż┐45nmź╬Ī╝ź╔Ū█└■ż╬TDDBĪ╩time dependent dielectric breakdownĪ╦ż╬┐«═Ļ└ŁżŌ─┤ż┘żŲż▀żļż╚Īóź’źżźųźļ╩¼╔█żŪ╩Å└čĖ╬ŠŃż“Ė½żļż╚Īó┐«═Ļ└ŁÖæ╠┐żŽ2ź▒ź┐µć┼┘╣Ōż»ż╩ż├żŲżżżļĪŻ
ż▐ż┐ĪóCF4ż╚C4F6ż╬└«╩¼╚µż“╩čż©żļż│ż╚żŪź©ź├ź┴ź¾ź░ź¼ź╣ż╬┬ō┘I╚µż╚LERż╚ż¼ź╚źņĪ╝ź╔ź¬źšż╬┤žĘĖż¼żóż├ż┐żŌż╬ż╬ĪóCF3IżŽ╣Ōżż┬ō┘I╚µż╚─Ńżżźūźķź║ź▐ĄōĀaż“╬Š╬®żŪżŁż┐ż╚żĘżŲżżżļĪŻ


