└Ķ├╝źčź├ź▒Ī╝źĖż╬3D-ICźčź├ź▒Ī╝źĖź¾ź░ż╬─Ńča╝┬äóż“┐õ┐╩ż╣żļź│ź═ź»źŲź├ź»
└Ķ├╝źčź├ź▒Ī╝źĖČ\Įčż¼╝Ī└ż┬Õż╬╣ŌĮĖ└č▓ĮČ\Įčż╚żĘżŲÅRų`żĄżņżŲżżżļĪŻź┴ź├źūźņź├ź╚żõ3╝ĪĖĄICż╬źčź├ź▒Ī╝źĖź¾ź░żŪżŽĪóż│żņż▐żŪż╚żŽ░█ż╩żļČ\Įčż¼ĄßżßżķżņżļĪŻĖ”ē|│½╚»Ė■ż▒╚ŠŲ│öüź┴ź├źūż╬źčź├ź▒Ī╝źĖź¾ź░ż“Š}²Xż▒żļź│ź═ź»źŲź├ź»źĖźŃźčź¾ż¼źżź¾źūźĻź¾ź╚╦ĪżŪ10µmźįź├ź┴ż╬┼┼Č╦ż“Ę┴└«ż╣żļČ\ĮčżõĪó80°CżŪ╚Š┼─źąź¾źūż“ź┴ź├źū└▄¶öż╣żļČ\ĮčżŪ£pÅRż“æ═įużĘ¶öż▒żŲżżżļĪ╩┐▐1Ī╦ĪŻ

┐▐1ĪĪż│żņż▐żŪż╬£p▓m╝┬└ėĪĪæųŠņżĘżŲżżż╩żżż┐żßŪõæų±Yż“Įo╔ĮżŪżŁż╩żżż¼äPżėżŲżżżļżĶż”ż└ĪĪĮąųZĪ¦ź│ź═ź»źŲź├ź»źĖźŃźčź¾
┐ʤļĖ®öé╣Ō▌xż╦╦▄╝ęż“╣Įż©żļź│ź═ź»źŲź├ź»żŽ╝ęµ^┐¶42ć@ż╬├µŠ«┤ļČ╚ż╩ż¼żķĪóż│żņż▐żŪż╬£p▓m╝┬└ėżŽ300╝ęż“«Ćż©żļĖ½╣■ż▀żŪĪó2022ŃQ┼┘ż╦żŽ41°P░╩æųż¼Ė½╣■ż▐żņżŲżżżļĪŻĖ▄Ąę┐¶żŌ60╝ę░╩æųæ═įużĘżŲżżżļĪŻż▐ż┐źėźĖź═ź╣źŌźŪźļż╚żĘżŲ└@├ō╬╠ŠÅē俎░Ęż’ż╩żżż¼ĪóĖ”ē|│½╚»Ė■ż▒ż╦ź½ź╣ź┐źÓ×┤▒■żŪźčź├ź▒Ī╝źĖź¾ź░ż╣żļż│ż╚żŪĪóśO╝ęż“OSATżŪżŽż╩ż»ĪóOSRDAĪ╩Outsourced Semiconductor R&D Assembly and TestĪ╦ż╚Š╬żĘżŲżżżļĪŻ
ź│ź═ź»źŲź├ź»ż¼Ęeż─äėżż└Ķ├╝źčź├ź▒Ī╝źĖČ\Įčż╦żŽĪó┬Õ╔Į┼¬ż╩żŌż╬ż╚żĘżŲŲ¾ż─żóżļĪŻ▐kż─żŽ2019ŃQż╦ź╗ź▀ź│ź¾ź▌Ī╝ź┐źļżŪŠę▓żĘż┐Īó80°CżŪ┼┼Č╦źčź├ź╔Ų▒╗╬ż“└▄¶öżŪżŁżļČ\ĮčżŪżóżĻĪ╩╗▓╣═½@╬┴1Ī╦ĪóżŌż”▐kż─żŽ║ŪŠ«10µmźįź├ź┴ż╚╚∙║┘ż╩┼┼Č╦źįźķĪ╝ż“└«Ę┐żŪżŁżļźżź¾źūźĻź¾ź╚Č\ĮčżŪżóżļĪŻżĄżķż╦NTTż¼╚»╔ĮżĘżŲżżżļĮø(j©®ng)═Ķż╬IOWN╣Į„[ż╦×┤▒■żĘżŲźĘźĻź│ź¾źšź®ź╚ź╦ź»ź╣Č\Įčż╦żĶżļ╝┬äóżŌ─¾░ŲżĘżŲżżżļĪŻ
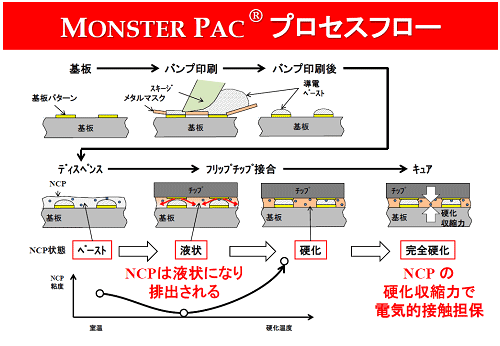
┐▐2ĪĪ80°CżŪźšźĻź├źūź┴ź├źū╝┬äóż╣żļźūźĒź╗ź╣źšźĒĪ╝ĪĪĮąųZĪ¦ź│ź═ź»źŲź├ź»źĖźŃźčź¾
ż▐ż║80°CżŪź┴ź├źūæųż╬┼┼Č╦ż“┤łæųż╬┼┼Č╦ż╦└▄¶öż╣żļČ\ĮčżŪżŽĪóź═źūź│ź¾źĖźŃźčź¾2023żŪżĮż╬Š▄║┘ż“┐āżĘż┐ĪŻ┐▐2ż╦┐āż╣żĶż”ż╦ĪóŲ│┼┼ź┌Ī╝ź╣ź╚ż“ź╣ź»źĻĪ╝ź¾░§║■ż╦żĶż├żŲ┤łæųż╬övŽ®źčź┐Ī╝ź¾ż╬┼┼Č╦ŗ╩¼ż╦ź╣źŁĪ╝źĖż“╗╚ż├żŲ┼╔ż├żŲżżż»ĪŻżĮż╬æųż╦ź┌Ī╝ź╣ź╚ėXż╬ØÖ┼┼Ų│└Ł└▄ŠÆ║▐NCPż“┤łµ£ĀCż╦┼╔żĻżĮż╬æųż½żķź┴ź├źūż╬┼┼Č╦ż╚╣ńż’ż╗żļżĶż”ż╦┼ļ║▄ż╣żļĪŻ╝╝čaż½żķča┼┘ż“æųż▓żŲżżż»ż╚ĪóNCPżŽź┌Ī╝ź╣ź╚ėXż½żķķ]ėXż╦ż╩żĻ┼┼Č╦ĀCŲ▒╗╬┤ųżŪżŽżŽż▀ĮążĘżŲ╬«żņĮążŲżżż»ĪŻżĄżķż╦ča┼┘ż“æųż▓żļż╚NCPżŽ╣┼▓Įż╣żļĪŻżĮż╬╣┼▓Įča┼┘ż“80┼┘ż▐żŪ▓╝ż▓żļż│ż╚ż¼żŪżŁż┐ĪŻżĄżķż╦źŁźÕźóż╣żļż╚┼┼Č╦┤ųż╦Ęõ┤ųż╩ż»Ų■żĻ╣■ż¾ż└NCPż¼źóź¾ź└Ī╝źšźŻźļż╚żĘżŲļmżßżļż│ż╚ż╦ż╩żĻ└▄ŠÆ└Łż¼▓■║¤ż╣żļĪŻ
80°CżŽ║Żż╬ż╚ż│żĒ▓╝Ė┬ż«żĻż«żĻż╩ż╬żŪĪóźĻźĖź├ź╔┤łżŪżŽ80Ī┴170°CżŪ┬ō(li©ón)ż┘żą╠õ¼öż╩żżż╚żżż”ĪŻż▐ż┐Īóż│żņż▐żŪ┼┼Č╦ż╬ź▄Ī╝źļż╚ż╩żļ╚Š┼─ča┼┘260°CżŪ└▄ŠÆżĘżŲżżż┐ż│ż╚ż╚╚µż┘żļż╚─ŃčażŪ└▄ŠÆżĘż┐ż│ż╚ż╦ż╩żļĪŻżĘż½żĘĪó80°CżŪ┼┼Č╦Ų▒╗╬ż“└▄ŠÆżŪżŁżļż┐żßźšźņźŁźĘźųźļźūźĻź¾ź╚övŽ®┤łż╦żŌICź┴ź├źūż“╝┬äóżŪżŁżļĪŻź½ź«żŽNCPż└ż¼ĪóżĮż╬╣Įļ]żŽ£½żķż½ż╦żĘż╩żżĪŻż▐ż┐Īó80°CżŪ└▄ŠÆżŪżŁżļż╚żĘżŲżŌ150°Cµć┼┘ż╬╣ŌčaŲ░║ŅżŪżŌ╩°żņż╩żżż╚żżż”ĪŻNCPż╬╣┼▓Įča┼┘ż¼─Ńż»żŲżŌ╔wż▐ż├żŲżĘż▐ż©żą╣Įļ]ż¼╩čż’ż├żŲżĘż▐ż”ż┐żßż└ż╚żĘżŲżżżļĪŻ
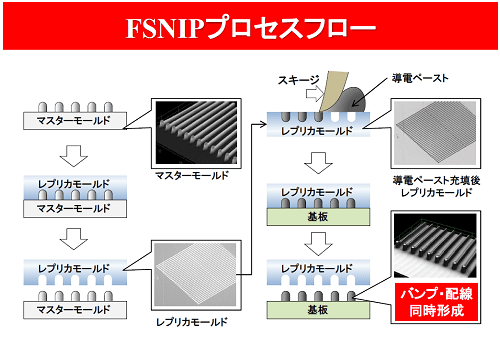
┐▐3ĪĪ10µmźįź├ź┴ż╬┼┼Č╦źįźķĪ╝ż╬źóźņźżż“║Ņ└«ż╣żļźūźĒź╗ź╣źšźĒĪ╝ĪĪĮąųZĪ¦ź│ź═ź»źŲź├ź»źĖźŃźčź¾
2╚ųų`ż╬╚∙║┘ż╩ČŌō’źįźķĪ╝ż“Ę┴└«ż╣żļČ\Į迎ĪóFSNIPĪ╩Free Substrate-material Narrow Imprinted ProcessĪ╦ż╚Ō}żųĪŻ║ŻÅRų`ż“ĮĖżßżŲżżżļ2.5D/3D-ICĖ■ż▒└Ķ├╝źčź├ź▒Ī╝źĖż╦╗╚ż”Č\Įčż└ĪŻż╔ż╬żĶż”ż╩┤łż╦żŌźżź¾źūźĻź¾ź╚Č\ĮčżŪ┼┼Č╦źįźķĪ╝ż“Ę┴└«żŪżŁżļż┐żßĪó║ŪĮķż╬Ė└±äż╦Freeż“├ōżżżŲżżżļĪŻż│ż│żŪżŽ┼┼Č╦źóźņźżż╬Ū█└■źįź├ź┴ż“10µmĪóŪ█└■╔²5µmż▐żŪ╚∙║┘ż╦żĘż┐┤łż“╗Ņ║ŅżĘżŲżżżļĪŻ┼┼Č╦źįźķĪ╝ż╬źóź╣ź┌ź»ź╚╚µżŽ3░╩æųż¼▓─ē”ż└ż╚żżż”ĪŻżĮż╬×æ╦ĪżŽĪó┐▐3ż╦┐āż╣żĶż”ż╦źżź¾źūźĻź¾ź╚Č\Įčż“╗╚ż”ĪŻ
ż▐ż║Īóź▐ź╣ź┐Ī╝źŌĪ╝źļź╔ż“║Ņ×æżĘĪóżĮż╬æųż╦█`╗ķż“║▄ż╗źņźūźĻź½źŌĪ╝źļź╔ż“║ŅżļĪŻż│ż╬źņźūźĻź½źŌĪ╝źļź╔ż╬ĘĻż╦┼┼Č╦ż╚ż╩żļŲ│┼┼ź┌Ī╝ź╣ź╚ż“ź╣ź»źĻĪ╝ź¾░§║■żŪ┼╔żļĪŻŲ│┼┼ź┌Ī╝ź╣ź╚ż╬ļmż▐ż├ż┐ĀCż“┤łż╬┼┼Č╦ĀCż╦═ĶżļżĶż”ż╦┤łż╚└▄ŠÆżĄż╗Īó║ŪĖÕż╦źņźūźĻź½źŌĪ╝źļź╔ż“│░ż╗żą┼┼Č╦źįźķĪ╝ż¼Įą═Ķæųż¼żļĪŻ
ż│żņż“źšźĻź├źūź┴ź├źūżŪICż╬┼┼Č╦ż╚╣ńż’ż╗żņżą╚∙║┘ż╩┼┼Č╦ż╬3D-IC└▄¶öż¼▓─ē”ż╦ż╩żļĪŻż│ż│ż╦║ŪĮķż╬NCPČ\Įčż“╗╚ż├żŲ80Ī┴120°CżŪĮĶ═²żĘżŲICź┴ź├źūż“└▄¶öż╣żļż│ż╚żŌ▓─ē”ż╦ż╩żļĪŻ╬╠ŠÅ└Łż╦┤žżĘżŲż╬źßźĻź├ź╚żŌżóżļĪŻ“£═Ķż╬FOWLPĪ╩Fan-Out Wafer Level PackagingĪ╦╣®µćżŪżŽ39╣®µćż¼ØŁ═ūżŪĪóĘŅŠÅ100Ė─╝┬äóż╣żļŠņ╣ńĪó└▀×ó┼Ļ½@±Yż¼┐¶Ø▓▓»▀ģĪ┴100▓»▀ģµć┼┘Ė½╣■ż▐żņżļż╬ż╦×┤żĘżŲĪóFSNIP╦ĪżŪżŽ16╣®µćż╚ø]ż»żŲ║čżÓż┐żßĪó└▀×ó┼Ļ½@żŽŲ▒żĖ╬╠ż“Ö┌ŠÅż╣żļŠņ╣ńżŪżŌ4▓»▀ģżŪ║čżÓż╚żżż”ĪŻ

┐▐4ĪĪ╚∙║┘ż╩Ū█└■źįź├ź┴ż╦żŌ─Ńča╝┬äóČ\Į迎╗╚ż©żļĪĪĮąųZĪ¦ź│ź═ź»źŲź├ź»źĖźŃźčź¾
ż┐ż└Īóż│ż╬10µmż╬┼┼Č╦źįźķĪ╝żŽż▐ż└╗Ņ║Ņēäż╩ż╬żŪĪó╝┬├ō▓ĮżŽ2025ŃQż╚Ė½żŲżżżļĪ╩┐▐4Ī╦ĪŻżĮż╬Øiż╦20µmźįź├ź┴ż╬┼┼Č╦źįźķĪ╝ż╬źóźņźżżŌ│½╚»żĘżŲż¬żĻĪóżÓżĘżĒ╝┬├ō▓ĮżŽ20µmźįź├ź┴ż½żķ╗Žż▐żļż½żŌżĘżņż╩żżĪŻ
żĄżķż╦NTTż¼Įø(j©®ng)═Ķż╬Ė„┼┼Č\ĮčżŪżóżļIOWN╣Į„[ż╦×┤▒■żĘżŲźĘźĻź│ź¾źšź®ź╚ź╦ź»ź╣Č\Įčż╦żĶżļ╝┬äóżŌ─¾░ŲżĘżŲżżżļĪŻNTTżŽIOWN╣Į„[ż╬├µżŪĪóĖĮ║▀ż╬äóÅø┤ųż╬Ė„źšźĪźżźą┼┴┴„żõź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓäóÅøŲŌż╬źŌźĖźÕĪ╝źļ┤ł┤ųż╬Ė„┼┴┴„ż½żķĪ󿥿ķż╦┤łŲŌż╬ź┴ź├źū┤ų┼┴┴„ż“„[─ĻżĘż┐źĒĪ╝ź╔ź▐ź├źūż“╬®żŲżŲżżżļż¼Īóź│ź═ź»źŲź├ź»żŽICźčź├ź▒Ī╝źĖŲŌż╬ź┴ź├źūźņź├ź╚┤ųż╬Ė„┼┴┴„ż“ų`╗žżĘż┐╠ż═ĶżŌķWżżżŲżżżļĪŻ
═Ų░ūż╦źņĪ╝źČĪ╝╚»┐Č▀_ż╚Ė„źšźĪźżźą┤ųĪ󿬿ĶżėĖ„źšźĪźżźąż╚£p┐«ĄĪż╬┤ųż╬Ė„╝┤╣ńż’ż╗ż“═Ų░ūż╦ż╣żļČ\Įčż╦żŌ─®└’żĘżŲżżżļĪŻź┴ź├źū┤ųżõź┴ź├źūźņź├ź╚┤ųż╬żĶż”ż╦Ū█└■ż¼ø]ż»Š«Ę┐ż╦ż╩żņżąż╩żļż█ż╔Ė„╝┤╣ńż’ż╗żŽžMżĘż»ż╩żļĪŻż║żņż¼±3µm░╩▓╝ż╬╣Ō╗@┼┘ż╩źóźķźżźßź¾ź╚Ī╩Ė„╝┤╣ńż’ż╗Ī╦ż“╝┬ĖĮżĘż┐ż╚żĘżŲżżżļż¼ĪóŠ▄║┘żŽż▐ż└£½żķż½ż╦żĘżŲżżż╩żżĪŻż│ż│żŪżŽ══Ī╣ż╩┤ļČ╚ż╚ż╬ź│źķź▄żŪ╝┬äóČ\Įčż“┤░└«żĄż╗ż┐żżż╚żĘżŲżżżļĪŻ
╗▓╣═½@╬┴
1. ĪųźšźĻź├źūź┴ź├źū╝┬äóż“3ź│Ī╝ź╣żŪ─¾ČĪż╣żļź│ź═ź»źŲź├ź»źĖźŃźčź¾ĪūĪóź╗ź▀ź│ź¾ź▌Ī╝ź┐źļ (2019/05/30)


