2nmż╬ź▐ź╣ź»×æ║Ņ┤³┤ųż“│╩├╩ż╚ø]Į╠ż╣żļNvidiaż╬cuLithoż╚Synopsysż╬OPC
2nmźūźĒź╗ź╣żŪżŽĪóEUVż╚żżż©ż╔żŌOPCĪ╩Ė„│ž┼¬ŖZ└▄Ė·▓╠T┘ćĪ╦ż¼ØŁ═ūż╦ż╩ż├żŲż»żļĪŻEUVż╬13.5nmż╚żżż”āS─╣żŪżŽźčź┐Ī╝ź¾ż“żĮż╬ż▐ż▐▓├╣®żŪżŁż╩ż»ż╩ż├żŲżŁż┐ż½żķż└ĪŻ2nmźūźĒź╗ź╣ż└ż╚╩Ż╗©ż╣ż«żŲ╗Ņ╣įēžĖĒ┼¬ż╩źóźūźĒĪ╝ź┴żŽżŌżŽżõ╗╚ż©ż╩żżĪŻ╝ŖōQĄĪŠW(w©Żng)├ōż╬źĻźĮź░źķźšźŻż╬Įą╚ųż╚ż╩żļĪŻNvidiaż╚TSMCĪóSynopsysĪóASMLżŽĪó║“ŃQź©ź│źĘź╣źŲźÓż“╣Į├█żĘż┐ż¼Ī╩╗▓╣═½@╬┴1Ī╦ĪóTSMCż╬╬╠ŠÅźķźżź¾ż╦╝ŖōQĄĪźĻźĮż“Ų│Ų■żĘżŲżżżļż│ż╚ż¼£½żķż½ż╦ż╩ż├ż┐ĪŻ
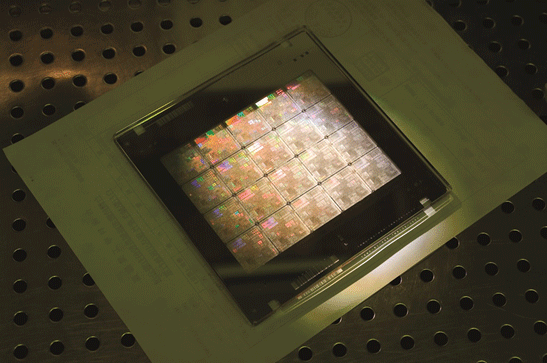
┐▐1ĪĪcuLitho├ōż╬źŲź╣ź╚źčź┐Ī╝ź¾ź┴ź├źūĪĪĮąųZĪ¦Nvidia
2nmźūźĒź╗ź╣żŽĪó├▒ż╩żļGAAź╚źķź¾źĖź╣ź┐ż╬Ų│Ų■ż└ż▒żŪżŽż╩ż»ĮĖ└č┼┘ż¼│╩├╩ż╚æųż¼żļż│ż╚ż╦żĶż├żŲČ╦żßżŲ╩Ż╗©ż╩└▀╝Ŗż╦ż╩żļż╚Ų▒╗■ż╦Īó║ŪŠ«ż╬╝┬Øó╦ĪżŽ11~12nmż╚EUVż╬āS─╣żĶżĻżŌø]ż»ż╩żļż┐żßĪó90nm╗■┬Õż½żķŲ│Ų■żĄżņż┐OPC▌ö┘ćż¼ź▐ź╣ź»ż┤ż╚ż╦’L(f©źng)ż½ż╗ż╩ż»ż╩żļĪŻĘQź▐ź╣ź»ż╦║Ū┼¼ż╩źčź┐Ī╝ź¾ż“╝ŖōQż╣żļż┐żßż╦ĪóNvidiaż╬GPUż╚╝ŖōQĄĪź┘Ī╝ź╣ż╬źĻźĮź░źķźšźŻĪ╩Computational LithographyĪ╦Ė■ż▒ż╬źķźżźųźķźĻżŪżóżļcuLithoż“ŠW(w©Żng)├ōż╣żļż│ż╚ż╦ż╩żļĪŻ║“ŃQżŽż│ż╬ż┐żßż╦Nvidiaż╚TSMCĪóSynopsysĪóASMLż¼╝ŖōQĄĪźĻźĮż╬ź©ź│źĘź╣źŲźÓż“╣Į├█żĘż┐ĪŻ
TSMCż╬CEOżŪżóżļC.C.WeiĢ■(hu©¼)żŽĪóĪųTSMCż╬źūźĒź╗ź╣╣®µćż╦GPUź┘Ī╝ź╣ż╬╝ŖōQźĘź╣źŲźÓż“┴╚ż▀Ų■żņżļż┐żßż╦Nvidiaż╚Č©╬üżĘżŲżŁż┐ż¼ĪóżĮż╬└Łē”ż¼╣Ōż»ź╣źļĪ╝źūź├ź╚ż¼Įj(lu©░)żŁż»Ė■æųżĘĪóź▐ź╣ź»│½╚»┤³┤ųż¼ø]Į╠ĪóŠ├õJ┼┼╬üżŌĮj(lu©░)╔²ż╦║’žō(f©┤)żĘż┐Īūż╚Ėņż├żŲżżżļĪ╩╗▓╣═½@╬┴2)ĪŻĪųNvidiaż╬cuLithoż“TSMCż╬Ö┌ŠÅźķźżź¾ż╦┴╚ż▀╣■ż▀Īó╚ŠŲ│öüż╬╚∙║┘▓Įż╦─_═ūż╩ź▐ź╣ź»└▀╝Ŗż╦īÖ├ōż╣żļĪūż╚Ė└ż”ĪŻż▐ż┐OPCżŪżŽĪóĖ„Ė╗ż╬Ę┴ż╦żŌ░═┘Tż╣żļż┐żßĪóASMLż╬EUVźĻźĮź░źķźšźŻäóÅøż╬Ė„Ė╗ż╬äė(d©░ng)żĄżõ░╠┴Ļż╩ż╔ż╬źčź┐Ī╝ź¾żŌ─┤┼Dż╣żļż│ż╚ż╦ż╩żļĪŻ
Nvidiaż╬cuLithoż“TSMCż╬źķźżź¾ż╦Ų│Ų■żĘĪóż▐ż║źŲź╣ź╚żĘż┐±T▓╠ĪóČ╩└■┼¬ż╩źčź┐Ī╝ź¾ż“įu(p©¬ng)żļÅ]┼┘ż¼45Ū▄Å]ż»ż╩żĻĪóāeż╚▓Żż╬─Š└■┼¬ż╩źčź┐Ī╝ź¾ż╬Īųź▐ź¾źŽź├ź┐ź¾Īūź▐ź╣ź»żŪżŽ60Ū▄żŌÅ]ż»ż╩ż├ż┐ż╚żżż”ĪŻ
żĄżķż╦ź▐ź╣ź»×æ║Ņ┤³┤ųż“▓├Å]żĄż╗żļż┐żßĪóNvidiaż╬cuLithoż╦╝┬└ėż╬żóżļSynopsysż╬Proteusż╚Ō}żųOPCźĮźšź╚ż“┼²╣ńż╣żļż┐żßĪóSynopsysż╚żŌ┴╚ż¾ż└ĪŻ║Ū┼¼źčź┐Ī╝ź¾ż╬╝ŖōQ╗■┤ųż“ĘÕ░Ńżżż╦ø]Į╠żĄż╗żļż│ż╚ż“┴└ż├żŲżżżļĪŻProteusżŽĪó20ŃQ┤ų╝┬└ėż╬żóżļOPC▌ö┘ćźĮźšź╚żŪżóżļż¼ĪócuLithoż╦┴╚ż▀╣■żÓż│ż╚żŪGPUź┘Ī╝ź╣ż╬╝ŖōQĄĪźĻźĮż╦ż╩żĻĪó╗@┼┘żõĖ·╬©Īóź▐ź╣ź»▌ö┘ćÅ]┼┘żŽĮj(lu©░)╔²ż╦Ė■æųż╣żļż└ż▒żŪżŽż╩ż»Īó▌ö┘ć├ōż╬źŌźŪźļ╣Į├█żŌ┐╩ż▀Īó▌ö┘ćżĘż┐ICźčź┐Ī╝ź¾ż╚▌ö┘ćØiż╬źčź┐Ī╝ź¾żŪż╬Ė·▓╠ż“╩¼└Žż╣żļż│ż╚żŌżŪżŁżļżĶż”ż╦ż╩żĻĪóź┴ź├źū×æļ]źūźĒź╗ź╣ż“▐k┐Ęż╣żļż╚żżż”ĪŻ
NvidiażŽż│ż╬1ŃQżŪĪóÖ┌└«AIż“┼¼├ōżĘżŲcuLithoż╬▓┴├═ż“╣Ōżßżļż┐żßż╦źóźļź┤źĻź║źÓżŌ│½╚»żĘżŲżŁż┐ĪŻż│ż╬±T▓╠ĪóÖ┌└«AIż╦żĶż├żŲ╝ŖōQÅ]┼┘żŽŪ▄╗\żĘż┐ĪŻÖ┌└«AI[ż“┼¼├ōżĘżŲĖ„ż╬öv└▐ż“╣═╬Ėż╣żļż│ż╚żŪ╚┐┼Šź▐ź╣ź»żõ╚┐┼ŠźĮźĻźÕĪ╝źĘźńź¾żŌż█ż▄┤░ż┌żŁż╦żŪżŁżļżĶż”ż╦ż╩żļż╚żĘżŲżżżļĪŻż│ż│ż╦żĄżķż╦Proteusż╬OPC▌ö┘ćż“▓├ż©żļż│ż╚żŪ║ŪĮ¬┼¬ż╦ź▐ź╣ź»║Ņ└«╗■┤ųżŽ2ĘÕÅ]ż»ż╩żļż╚żżż”ĪŻ
ż▐ż┐Īóż│żņż▐żŪż╬GPU╝ŖōQżŪżŽH100×æēäż“╗╚ż├żŲżŁż┐ż¼ĪóĮø(j©®ng)═ĶżŽNvidiaż╬Blackwell GPUĪ╩╗▓╣═½@╬┴3Ī╦ż“╗╚ż”żĶż”ż└ĪŻźĻźĮźūźĒź╗ź╣żŪ║ŻĖÕżŌ▓┐ż½ź▄ź╚źļź═ź├ź»ż¼ĮążŲżŁż┐ż╚żŁż╦Ö┌└«AIż╚cuLithoĪóProteusżŪ║Ū┼¼ż╩ź▐ź╣ź»║Ņ└«ż¼▓─ē”ż╦ż╩żļż┐żßĪó2nm░╩æTż╬źūźĒź╗ź╣│½╚»ż╦Ń~╬üż╩╝Ø▀_(d©ó)ż╦ż╩żĻżĮż”ż└ĪŻ
╗▓╣═½@╬┴
1. "TSMC and Synopsys Bring Breakthrough NVIDIA Computational Lithography Platform to Production", Nvidia
2. ĪųNvidiaż¼ASMLĪóTSMCĪóSynopsysż╚┴╚ż▀Īó╝ŖōQĄĪźĻźĮżŪ2nmź╬Ī╝ź╔ż“Ų═Ū╦żžĪūĪóź╗ź▀ź│ź¾ź▌Ī╝ź┐źļ (2024/03/24)
3. ĪųNvidiaĪó1├¹źčźķźßĪ╝ź┐ż╬Ö┌└«AIĖ■ż▒┐ĘGPUż╚AIź│ź¾źįźÕĪ╝ź┐ż“╚»╔ĮĪūĪóź╗ź▀ź│ź¾ź▌Ī╝ź┐źļ (2024/03/22)


